越来越重要的DFM
发布时间:2017/5/25 21:43:13 访问次数:882
随着技术节点向90nm、65nm、45nm发展,电路设计越来越复杂,对良率的影响也越来越大(如图109所示), S3C2410A-20换句话讲,通过对电路设计的改进将可以大大提升良率,这就是为什么DFM(Dc“glfor Manufacttlhllg)被人们越来越重视的原因。
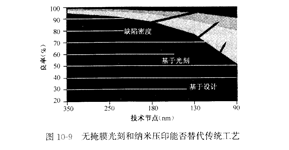
图109 无掩膜光刻和纳米压印能否替代传统工艺
在向45nn1技术节点发展过程中.良率下降的原因多种多样,一般情况可以分为以下6种:随机微粒造成的缺陷;光刻过程中造成的误差;Cu凹陷和腐蚀造成的缺陷;参数变化造成的缺陷;通孔的可靠性和信号;功率完整性造成的缺陷等。前两个因素与硅片的作△艺环境和设各的关系较为紧密,而后4个因素却是和集成电路的设计方法密切相关的.是完全可以通过对集成电路设计方法的改进而加以改善的。尽管微粒污染是随机产生的,无法通过DFM将其消除,但可以通过DFM将其影响减小。在硅片制造过程中微粒往往造成电路短路或者开路,从而使良率降低。运用勒∞psys的α讼(ChtIcd舟ca~Klldy“ω工具对设计版图进行分析,找出线条密度高的区域,并将其展开。囚为线条密度高的区域微粒污染容易造成短路,而密度的减小可以降低这种情况的发生。但是随着线条密度的减丬、芯片的尺寸可能会有所增加,使得每片硅片上芯片的数量减少。所以如何既减小线条的密度,又尽量不增加芯片的尺寸。对于版图设计工程师来讲是一个很大的挑战,同时也是DFM的魅力所在。
随着技术节点向90nm、65nm、45nm发展,电路设计越来越复杂,对良率的影响也越来越大(如图109所示), S3C2410A-20换句话讲,通过对电路设计的改进将可以大大提升良率,这就是为什么DFM(Dc“glfor Manufacttlhllg)被人们越来越重视的原因。
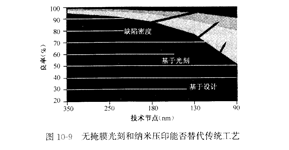
图109 无掩膜光刻和纳米压印能否替代传统工艺
在向45nn1技术节点发展过程中.良率下降的原因多种多样,一般情况可以分为以下6种:随机微粒造成的缺陷;光刻过程中造成的误差;Cu凹陷和腐蚀造成的缺陷;参数变化造成的缺陷;通孔的可靠性和信号;功率完整性造成的缺陷等。前两个因素与硅片的作△艺环境和设各的关系较为紧密,而后4个因素却是和集成电路的设计方法密切相关的.是完全可以通过对集成电路设计方法的改进而加以改善的。尽管微粒污染是随机产生的,无法通过DFM将其消除,但可以通过DFM将其影响减小。在硅片制造过程中微粒往往造成电路短路或者开路,从而使良率降低。运用勒∞psys的α讼(ChtIcd舟ca~Klldy“ω工具对设计版图进行分析,找出线条密度高的区域,并将其展开。囚为线条密度高的区域微粒污染容易造成短路,而密度的减小可以降低这种情况的发生。但是随着线条密度的减丬、芯片的尺寸可能会有所增加,使得每片硅片上芯片的数量减少。所以如何既减小线条的密度,又尽量不增加芯片的尺寸。对于版图设计工程师来讲是一个很大的挑战,同时也是DFM的魅力所在。
上一篇:掩模板检测技术的发展趋势



 公网安备44030402000607
公网安备44030402000607





