自对准金属栅结构
发布时间:2017/5/17 21:36:14 访问次数:845
在采用普通扩散方法制造MOS晶体管的工艺中,都是先形成源区和漏区,再制作栅电极。如图634所示是自对准金属栅结构示意图。 RFD14N05LSM在这种工艺中,为了避免光刻所引起的栅与源、栅与漏衔接不上的问题,提高成品率,在光刻版图的设计上就有目的地使栅源、栅漏之间交叠(据光刻技术可达到的对准精度而定),如图634(a)所示。由于交叠而引起栅漏之间存在很大的寄生电容,从而使M(B晶体管的高频特性变坏。
与扩散法制造MOSFET工艺过程相反,离子注入自对准MOSFET是先做成栅电极,并使之成为离子注入的掩膜,从而形成离子注人掺杂的源、漏区,如图634(b)所示。采用这种方法,上述的栅源、栅漏重叠就可以小到无足轻重的程度。栅极和源、漏区的相对位置就可以不靠掩膜人为对准,而是在离子注人时自动对准。因为垂直人射的离子在掩膜边缘的横向扩展是很小的,所以在掩膜的设计上没有必要留过大的余地,因此漏面积可以缩小,同时也就减小了漏漂移电容,改善了高频特性。通过栅和源、漏的自对准,也可提高成品率和芯片的集成度。
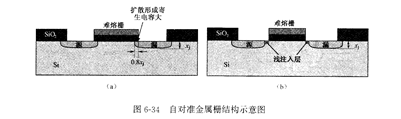
通过离子注入所形成的源区和漏区一般接触电阻很高。为了解决这个问题,可采用扩散与离子注人相结合的方法,分两步形成源区和漏区。在这种T艺中,首先采用扩散方法形成一部分源区和漏区,这部分源区和漏区之间的距离大于栅电极的尺寸,主要解决接触电阻问题。再在这部分的源和漏之间制作尺寸小于它们之间距离的栅电极,在这个栅电极的掩蔽下进行离子注人,把源区和漏区扩展到金属栅电极的边缘。这样的工艺不但解决了栅漏交叠问题.而且也降低了接触电阻。为了消除因离子注人所产生的晶格损伤,需要进行热退火处理。如果栅电极是由铝制成的,则热退火温度不能太高,退火可能就会不充分。故常用硅栅,这样退火可以在很高温度下进行,能得到令人满意的结果。有时也称这种工艺为硅栅自对准I艺。
在采用普通扩散方法制造MOS晶体管的工艺中,都是先形成源区和漏区,再制作栅电极。如图634所示是自对准金属栅结构示意图。 RFD14N05LSM在这种工艺中,为了避免光刻所引起的栅与源、栅与漏衔接不上的问题,提高成品率,在光刻版图的设计上就有目的地使栅源、栅漏之间交叠(据光刻技术可达到的对准精度而定),如图634(a)所示。由于交叠而引起栅漏之间存在很大的寄生电容,从而使M(B晶体管的高频特性变坏。
与扩散法制造MOSFET工艺过程相反,离子注入自对准MOSFET是先做成栅电极,并使之成为离子注入的掩膜,从而形成离子注人掺杂的源、漏区,如图634(b)所示。采用这种方法,上述的栅源、栅漏重叠就可以小到无足轻重的程度。栅极和源、漏区的相对位置就可以不靠掩膜人为对准,而是在离子注人时自动对准。因为垂直人射的离子在掩膜边缘的横向扩展是很小的,所以在掩膜的设计上没有必要留过大的余地,因此漏面积可以缩小,同时也就减小了漏漂移电容,改善了高频特性。通过栅和源、漏的自对准,也可提高成品率和芯片的集成度。
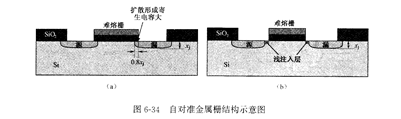
通过离子注入所形成的源区和漏区一般接触电阻很高。为了解决这个问题,可采用扩散与离子注人相结合的方法,分两步形成源区和漏区。在这种T艺中,首先采用扩散方法形成一部分源区和漏区,这部分源区和漏区之间的距离大于栅电极的尺寸,主要解决接触电阻问题。再在这部分的源和漏之间制作尺寸小于它们之间距离的栅电极,在这个栅电极的掩蔽下进行离子注人,把源区和漏区扩展到金属栅电极的边缘。这样的工艺不但解决了栅漏交叠问题.而且也降低了接触电阻。为了消除因离子注人所产生的晶格损伤,需要进行热退火处理。如果栅电极是由铝制成的,则热退火温度不能太高,退火可能就会不充分。故常用硅栅,这样退火可以在很高温度下进行,能得到令人满意的结果。有时也称这种工艺为硅栅自对准I艺。
上一篇:离子注人在SoI结构中的应用



 公网安备44030402000607
公网安备44030402000607





