切割封装与测试(Assembland Testing)
发布时间:2017/11/24 21:27:01 访问次数:597
在晶圆制造厂完成所有制程工艺后,通过电学测试的晶圆可以进行单个芯片的切割、AAT3171IWP-T1装配与封装,即将每个芯片组装到用于保护和黏附到更高级别装配的管壳中。传统的装配与封装主要步骤是:晶圆测试和拣选→分片→贴片→引线键合→塑料封装→最终封装与测试。对于所有的集成电路,芯片封装有以下四个重要功能。
(1)保护芯片以免囚环境和传递引起损坏。
(2)为芯片的信号输入和输出提供互连。
(3)芯片的物理支撑。
(4)散热。
在晶圆制造厂完成所有制程工艺后,通过电学测试的晶圆可以进行单个芯片的切割、AAT3171IWP-T1装配与封装,即将每个芯片组装到用于保护和黏附到更高级别装配的管壳中。传统的装配与封装主要步骤是:晶圆测试和拣选→分片→贴片→引线键合→塑料封装→最终封装与测试。对于所有的集成电路,芯片封装有以下四个重要功能。
(1)保护芯片以免囚环境和传递引起损坏。
(2)为芯片的信号输入和输出提供互连。
(3)芯片的物理支撑。
(4)散热。
上一篇:集束型晶圆制造装备的高度复杂性


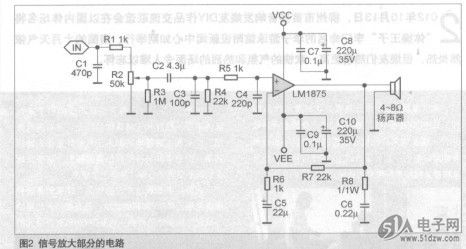
 公网安备44030402000607
公网安备44030402000607





