初始氧化阶段及薄氧化层制备
发布时间:2017/5/12 21:31:29 访问次数:1370
随着MOS器件沟道长度的不断减小,为了抑制短沟道效应,减小亚阈值斜率,同时也为了增大驱动电流、OMAPL138BZWT3提高电路工作速度,必须使MOS晶体管的栅氧化层厚度和沟道长度一起按比例缩小。目前在ULSI工艺中,栅氧化层厚度通常都小于30nm,而⒍G模型对于厚度小于30nm的超薄热干氧氧化规律描述是不准确的。平坦没有图案的轻掺杂衬底上,在单一o或H20气氛下,Sio2厚度大于~90nm时,DG模型能很好地描述氧化过程;实验表明在20nm之内的热氧化生长速率和厚度比亠G模型大得多。
在700℃的温度下进行干氧氧化时,氧化层厚度=鼠、与莎之间的实验结果如图⒋22所示。由图可见,开始是一个快速氧化阶段,之后才是线性生长区。由线性部分外推到莎=0时所对应的氧化层厚度为230±30A,而且这个值对于氧化温度在700~1200℃的范围内是不随温度的变化而变化的。因而对干氧氧化,必须对式(4-17)假设一个tt=230A的初始条件,才能使模型计算的结果与实验一致。相应的r值也可以估算出来:利用Jr与莎之间的关系曲线,由线性部分外推,通过岁。=230A处到r<o的轴上,所对应的截距就等于r值。利用这种外推法估算的r值,在氧化温度较低时是准确的。目前对于初始氧化阶段的理论还没有定论。
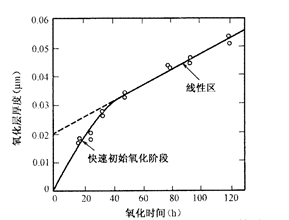
随着MOS器件沟道长度的不断减小,为了抑制短沟道效应,减小亚阈值斜率,同时也为了增大驱动电流、OMAPL138BZWT3提高电路工作速度,必须使MOS晶体管的栅氧化层厚度和沟道长度一起按比例缩小。目前在ULSI工艺中,栅氧化层厚度通常都小于30nm,而⒍G模型对于厚度小于30nm的超薄热干氧氧化规律描述是不准确的。平坦没有图案的轻掺杂衬底上,在单一o或H20气氛下,Sio2厚度大于~90nm时,DG模型能很好地描述氧化过程;实验表明在20nm之内的热氧化生长速率和厚度比亠G模型大得多。
在700℃的温度下进行干氧氧化时,氧化层厚度=鼠、与莎之间的实验结果如图⒋22所示。由图可见,开始是一个快速氧化阶段,之后才是线性生长区。由线性部分外推到莎=0时所对应的氧化层厚度为230±30A,而且这个值对于氧化温度在700~1200℃的范围内是不随温度的变化而变化的。因而对干氧氧化,必须对式(4-17)假设一个tt=230A的初始条件,才能使模型计算的结果与实验一致。相应的r值也可以估算出来:利用Jr与莎之间的关系曲线,由线性部分外推,通过岁。=230A处到r<o的轴上,所对应的截距就等于r值。利用这种外推法估算的r值,在氧化温度较低时是准确的。目前对于初始氧化阶段的理论还没有定论。
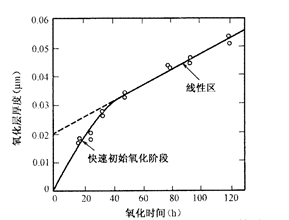



 公网安备44030402000607
公网安备44030402000607





