连接通孔的开尔文结构
发布时间:2016/6/30 21:32:44 访问次数:1727
当一块芯片上同时有几个测试结构在做应力测试而产生明显的焦耳热时,在估M0280SC250算测试结构的温度时,必须考虑相互之间的热效应。如果失效模式规定为电阻值的增加,而当测试结构失效时流过的电流值不会变化,则在以后的测试中在芯片上会产生明显的功耗,在这种情况下必须对各个测量值进行校正。如果失效判据用电阻值增加的百分比来表示,当测试结构的失效被检测到以后,流过该结构电流被减少到一个可以忽略不计的值,在这种情况下各个测试结构的测量值不必进行校正。另一种测试结构是“十字型”开尔文电阻结构,如图8.40所示。当对不同金属间连接通孔的电迁移进行评价时,设计的开尔文电阻包括两个“L”型电阻。这两个电阻均由金属层构成,位于所要测量的连接通孔处,使注入电流通过连接通孔从 另一层金属端流出,通过另外两个引出端测量电压,以测量连接通孔的电阻值。测试时改变电流方向并取平均电压可以减少热失调现象。
(a)连接通孔的单孔结构 (b)连接通孔的多fL结构
图840 连接通孔的开尔文结构
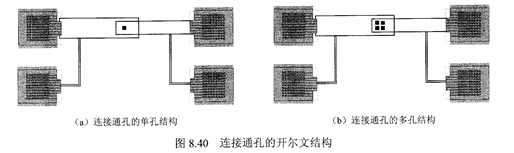
当一块芯片上同时有几个测试结构在做应力测试而产生明显的焦耳热时,在估M0280SC250算测试结构的温度时,必须考虑相互之间的热效应。如果失效模式规定为电阻值的增加,而当测试结构失效时流过的电流值不会变化,则在以后的测试中在芯片上会产生明显的功耗,在这种情况下必须对各个测量值进行校正。如果失效判据用电阻值增加的百分比来表示,当测试结构的失效被检测到以后,流过该结构电流被减少到一个可以忽略不计的值,在这种情况下各个测试结构的测量值不必进行校正。另一种测试结构是“十字型”开尔文电阻结构,如图8.40所示。当对不同金属间连接通孔的电迁移进行评价时,设计的开尔文电阻包括两个“L”型电阻。这两个电阻均由金属层构成,位于所要测量的连接通孔处,使注入电流通过连接通孔从 另一层金属端流出,通过另外两个引出端测量电压,以测量连接通孔的电阻值。测试时改变电流方向并取平均电压可以减少热失调现象。
(a)连接通孔的单孔结构 (b)连接通孔的多fL结构
图840 连接通孔的开尔文结构
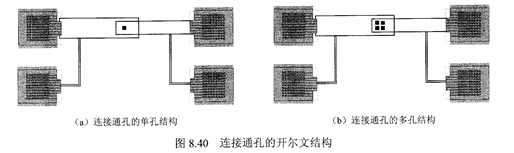
上一篇:金属化可靠性测试结构设计
上一篇:测量接触电阻与温度的关系
 热门点击
热门点击



 公网安备44030402000607
公网安备44030402000607





