无铝焊接中SMB焊盘的涂镀层
发布时间:2012/10/3 22:36:33 访问次数:1301
SMB焊盘涂镀层的DAP202U
种类比较多,工艺成熟,其中有的已经实现无铅化,PCB焊盘的涂镀层通常有下列几种。
1.热风整平工艺(HASL)
热风整平工艺俗称为喷锡,它是将印制板浸入熔融的焊料中,再通过热风将印制板的表面及金属化孔内的多余的焊料吹掉,从而得到一个平滑、均匀又光亮的焊料涂覆层,热风整平工艺可分为垂直式和水平式两种,在无铅化后,PCB热风整平所用的焊料为无铅焊料,如SnAg等。
在垂直式热风整平过程中,板子提升时由于焊料本身的重力作用及表面张力作用,使连接焊盘的焊料涂覆层出现上薄下厚的锡垂现象,垂直式热风整平后的焊盘不太平整;而水平式热风整平时,PCB水平通过上下对流的焊料波峰,然后受到上下两个风刀的水平吹扫,使板面及孔内的焊料得到整平,涂覆层厚度可到3~8ym,水平式热风整平工艺明显优于垂直式热风整平。
无铅热风整平工艺的特点:
●工艺成熟;
.成本低;
・可焊性好;
.连接强度好;
・能经受多次加热循环,适合双面板、返修等工艺;
・PCB焊盘的表面处理温度高,PCB共面性差,容易造成装配缺陷,不适合复杂设计
的PCB表面涂层。
2.涂覆NUAu工艺
SMB表面涂覆Ni/Au的方法主要有两种,一种是化学镀镍/浸金(Electroless Nickelsurfacefrom the Immersion Gold,ENIG).ENIG由于耐氧化、可焊性好、镀层表面平,现已广泛用于SMB焊盘保护层,ENIG法金层通常为0.075~0.125ym,镀金层较薄;另一种是电镀镍/金(Electrolytic Ni/Au),又称为还原法镀层,它的镀层要厚一些(大于等于0.15ym),其防氧化及耐磨效果好,故常用于插头、金手指、引线键常涂覆Au层。
由于ENIG耐氧化、可焊性好、镀层表面平,故广泛用于SMT板,ENIG法中Ni层厚度3~5ym,金层仅为0.075~O.lOLun,金层仅起到防止镍层氧化的作用,薄的镀金层在焊接时迅速熔于焊料中,仅是焊料中的锡与镍层形成锡镍共价化合物,使焊点牢固。
化学镀镍/浸金( ENIG)的优点:
・焊盘表面平坦、厚度均匀,适合细间距元器件的PCB表面涂层;
●焊盘有良好的可焊性;
・SMB存储时间长达1年。
3.浸Ag工艺
浸Ag是目前采用的新工艺。由于铜的标准电极电位(0.51V)低于银(0.799V),所以铜可以置换溶液中的银离子,在铜表面生成沉积银层。铜表面完全被覆盖后化学反应也停止,所以镀层也很薄,只有0.025~0.05 ym。银的可焊性较好、接触电阻低,耐氧化性比铜、镍好,但镀层溥,长时间在高温下底层的铜会迁移至表面,被氧化后可焊性下降,此外在污染的大气中银易变色,严重时也会影响焊接。因此,生产中尽量保证银层的厚度,采取防变色措施是保证浸银质量的关键。
SMB焊盘涂镀层的DAP202U
种类比较多,工艺成熟,其中有的已经实现无铅化,PCB焊盘的涂镀层通常有下列几种。
1.热风整平工艺(HASL)
热风整平工艺俗称为喷锡,它是将印制板浸入熔融的焊料中,再通过热风将印制板的表面及金属化孔内的多余的焊料吹掉,从而得到一个平滑、均匀又光亮的焊料涂覆层,热风整平工艺可分为垂直式和水平式两种,在无铅化后,PCB热风整平所用的焊料为无铅焊料,如SnAg等。
在垂直式热风整平过程中,板子提升时由于焊料本身的重力作用及表面张力作用,使连接焊盘的焊料涂覆层出现上薄下厚的锡垂现象,垂直式热风整平后的焊盘不太平整;而水平式热风整平时,PCB水平通过上下对流的焊料波峰,然后受到上下两个风刀的水平吹扫,使板面及孔内的焊料得到整平,涂覆层厚度可到3~8ym,水平式热风整平工艺明显优于垂直式热风整平。
无铅热风整平工艺的特点:
●工艺成熟;
.成本低;
・可焊性好;
.连接强度好;
・能经受多次加热循环,适合双面板、返修等工艺;
・PCB焊盘的表面处理温度高,PCB共面性差,容易造成装配缺陷,不适合复杂设计
的PCB表面涂层。
2.涂覆NUAu工艺
SMB表面涂覆Ni/Au的方法主要有两种,一种是化学镀镍/浸金(Electroless Nickelsurfacefrom the Immersion Gold,ENIG).ENIG由于耐氧化、可焊性好、镀层表面平,现已广泛用于SMB焊盘保护层,ENIG法金层通常为0.075~0.125ym,镀金层较薄;另一种是电镀镍/金(Electrolytic Ni/Au),又称为还原法镀层,它的镀层要厚一些(大于等于0.15ym),其防氧化及耐磨效果好,故常用于插头、金手指、引线键常涂覆Au层。
由于ENIG耐氧化、可焊性好、镀层表面平,故广泛用于SMT板,ENIG法中Ni层厚度3~5ym,金层仅为0.075~O.lOLun,金层仅起到防止镍层氧化的作用,薄的镀金层在焊接时迅速熔于焊料中,仅是焊料中的锡与镍层形成锡镍共价化合物,使焊点牢固。
化学镀镍/浸金( ENIG)的优点:
・焊盘表面平坦、厚度均匀,适合细间距元器件的PCB表面涂层;
●焊盘有良好的可焊性;
・SMB存储时间长达1年。
3.浸Ag工艺
浸Ag是目前采用的新工艺。由于铜的标准电极电位(0.51V)低于银(0.799V),所以铜可以置换溶液中的银离子,在铜表面生成沉积银层。铜表面完全被覆盖后化学反应也停止,所以镀层也很薄,只有0.025~0.05 ym。银的可焊性较好、接触电阻低,耐氧化性比铜、镍好,但镀层溥,长时间在高温下底层的铜会迁移至表面,被氧化后可焊性下降,此外在污染的大气中银易变色,严重时也会影响焊接。因此,生产中尽量保证银层的厚度,采取防变色措施是保证浸银质量的关键。


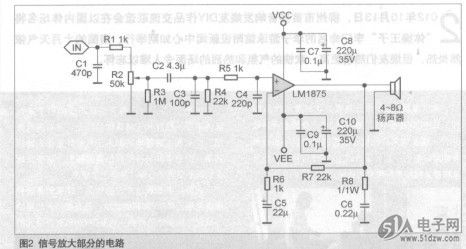
 公网安备44030402000607
公网安备44030402000607





