接近式曝光的分辨率理论极限是
发布时间:2017/10/24 20:37:26 访问次数:1879
接近式曝光的分辨率理论极限是其中,乃代表光刻胶的参数,通常在1~2之间;CD代表最小尺寸,即cⅡtical dimeI△⒍on,通常对应最小能够分辨的空间周期的线宽;λ指曝光的波长;g代表掩膜版到光刻胶表空
隙的距离(g=0对应接触式曝光)。 XC1765EJC由于g通常大于10um(由掩膜版和硅片表面平整度所限制),分辨率受到很大限制,如对450nm照明波长,分辨率在3um。而接触式曝光可以达到0,7um。
为了突破缺陷和分辨率的双重困难,投影曝光方案被提了出来,其中掩膜版和硅片被分开好几厘米以上。光学透镜被用来将掩膜版上的图案透镜成像到硅片上。随着市场需求更大的芯片尺寸以及更严格的线宽均匀性控制,投影曝光也从当初的全硅片曝光逐步发展到全硅片扫描曝光(见图7.2(a))、步进分块重复曝光(step an汪repeat×见图7.2(b)),到最终的步进分块扫描曝光(step an山scan×见图7。2(c))。
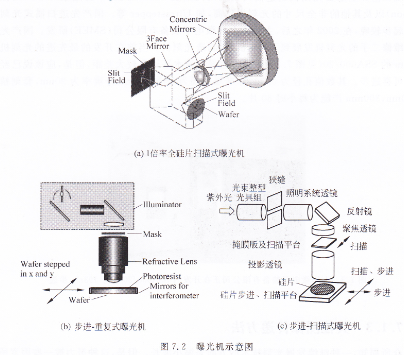
接近式曝光的分辨率理论极限是其中,乃代表光刻胶的参数,通常在1~2之间;CD代表最小尺寸,即cⅡtical dimeI△⒍on,通常对应最小能够分辨的空间周期的线宽;λ指曝光的波长;g代表掩膜版到光刻胶表空
隙的距离(g=0对应接触式曝光)。 XC1765EJC由于g通常大于10um(由掩膜版和硅片表面平整度所限制),分辨率受到很大限制,如对450nm照明波长,分辨率在3um。而接触式曝光可以达到0,7um。
为了突破缺陷和分辨率的双重困难,投影曝光方案被提了出来,其中掩膜版和硅片被分开好几厘米以上。光学透镜被用来将掩膜版上的图案透镜成像到硅片上。随着市场需求更大的芯片尺寸以及更严格的线宽均匀性控制,投影曝光也从当初的全硅片曝光逐步发展到全硅片扫描曝光(见图7.2(a))、步进分块重复曝光(step an汪repeat×见图7.2(b)),到最终的步进分块扫描曝光(step an山scan×见图7。2(c))。
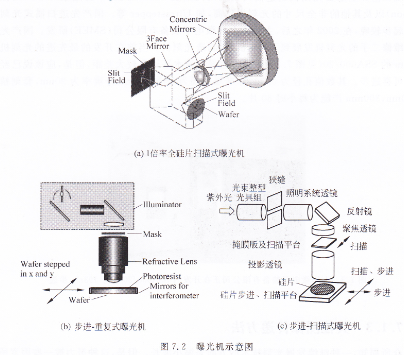
上一篇:光刻的基本方法
上一篇:全硅片1:1曝光方式结构简单
 热门点击
热门点击
- 源漏工程
- DRAM和eDRAM
- 接近式曝光的分辨率理论极限是
- 纳米集成电路制造工艺
- 线性方程组用矩阵形式
- 无结场效应晶体管
- EUT的搭接
- 圆柱体全包围栅量子阱HEMT场效应晶体管器件
- 化学气相沉积法使用的氧源
- 轮廓修正(多步沉积刻蚀)的HDP-CⅤD工艺
 推荐技术资料
推荐技术资料
- Seeed Studio
- Seeed Studio绐我们的印象总是和绘画脱离不了... [详细]


 公网安备44030402000607
公网安备44030402000607





