��ֵ�¶ȵ�ά��
����ʱ��:2016/6/1 20:12:07 ���ʴ���:462
���뿼�Ǽ���������������ʹ���ʱ��,���BGA��CSP�ȸ�Ϊ��Ҫ���ڻ���������,BGA��CsP��װ���PCB���ȼ���,Ȼ���ȴ��������̺�BGA��CSP�ĺ�����,���γɺ��㡣EP1C3T100I7����,���230����ȿ��������ڷ�װ����,������BGA��CSP���������ȶ������������ȡ����,Ϊ�˷�ֹ�¶ȳ��,�ں�����BGA��CSP���������γɺ��ӵ�ʱ,��װ��Ԫ����һ��Ҫ�����ڻ��������ȡ�
����¯����ϵͳ
��������Ļ������ȷ�����:�ȷ������������(IR)���ȷ�������Կ�����Ϊ����������ý��,�Լ�����Щ��PCB�����ϡ�������Ԫ����,��������С���,�DZȽ�����ġ������ڸù�����,�����ڶ���������PCB֮���γɵġ�����㡱 ��Ӱ��,ʹ���ȴ���������ʱЧ�ʲ���,��ͼ89��ʾ��
��IR����,���������ͨ����Ų���������,��������ʵ�,�������ȵؼ���Ԫ����;���û�п���,���ܻᷢ��PCB��Ԫ�������ȡ�IR������,��ƹܺͼ��Ȱ�,ֻ�����ڱ�������,������ȴ���������PCB��ֱ���·�,�������ȸ��ǡ��ɴ�,IR���������������Ҫ���ȵ�PCBA,�Ա�֤������ȴ��������㹻���������ֹPCBA��ȴ����3���ȴ���������:����������Ͷ���,ֻ�к����߿�ͨ������¯���ơ�
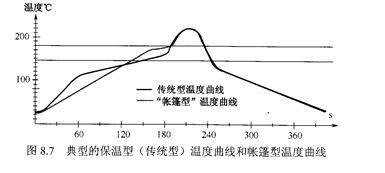
���뿼�Ǽ���������������ʹ���ʱ��,���BGA��CSP�ȸ�Ϊ��Ҫ���ڻ���������,BGA��CsP��װ���PCB���ȼ���,Ȼ���ȴ��������̺�BGA��CSP�ĺ�����,���γɺ��㡣EP1C3T100I7����,���230����ȿ��������ڷ�װ����,������BGA��CSP���������ȶ������������ȡ����,Ϊ�˷�ֹ�¶ȳ��,�ں�����BGA��CSP���������γɺ��ӵ�ʱ,��װ��Ԫ����һ��Ҫ�����ڻ��������ȡ�
����¯����ϵͳ
��������Ļ������ȷ�����:�ȷ������������(IR)���ȷ�������Կ�����Ϊ����������ý��,�Լ�����Щ��PCB�����ϡ�������Ԫ����,��������С���,�DZȽ�����ġ������ڸù�����,�����ڶ���������PCB֮���γɵġ�����㡱 ��Ӱ��,ʹ���ȴ���������ʱЧ�ʲ���,��ͼ89��ʾ��
��IR����,���������ͨ����Ų���������,��������ʵ�,�������ȵؼ���Ԫ����;���û�п���,���ܻᷢ��PCB��Ԫ�������ȡ�IR������,��ƹܺͼ��Ȱ�,ֻ�����ڱ�������,������ȴ���������PCB��ֱ���·�,�������ȸ��ǡ��ɴ�,IR���������������Ҫ���ȵ�PCBA,�Ա�֤������ȴ��������㹻���������ֹPCBA��ȴ����3���ȴ���������:����������Ͷ���,ֻ�к����߿�ͨ������¯���ơ�
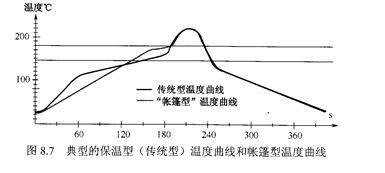
��һƪ����Ǧ�������ӵĹ���Ҫ��
��һƪ���������
 �������
�������
- ���Ӳ�Ʒ����Ϊ����3������
- ���PCB�ð�̻�Ƭ(Prepreg)���
- �������ķ���
- set Layer Pairs(���ò��)
- ����
- MSD�ķ��༰SMT��װ�ķּ�
- BGA����̨���༰��ȱ��
- ������Ŀʱ����VsM studio
- ��ۼ�鹤��
- ������ɿ��Ե�����
 �Ƽ���������
�Ƽ���������
- ��Ƭ���������������
- N��Ƶ: http://v.youku.comN_sh... [��ϸ]
- 24λ���ཻ��/ֱ�����ʼ��IC
- ���ɵ���������IC���¶ȴ�����
- ������������PTC����������
- PIC32CM5164JH01048 ����
- 512 KB�����64 KB��̬�����ȡ�洢
- PIC32CM JHϵ������
- ��ý��Э������SM501��Ƕ��ʽϵͳ�е�Ӧ��
- ����IEEE802.11b��EPA�¶ȱ�����
- QUICCEngine�������ƶ�IP�������
- SoC���������IJ�ҵ����
- MPC8xxϵ�д�������Ƕ��ʽϵͳ��Դ���
- dsPIC�����ڽ�����Ƶ�����е�Ӧ���о�


 ��������44030402000607
��������44030402000607





