测试技术的发展趋势
发布时间:2019/7/10 21:58:00 访问次数:918
测试技术的发展趋势
外壳的发展围绕着两个方面进行。一是封装形式和封装密度,随着小型化、多引脚、 H5PS5162FFR-S5C高密高可靠、耐恶劣环境、长寿命的需求提高,外壳从最初的单列葺插发展到如今的面阵列形如图13-8所示。板上芯片、带上芯片和KGD一段时间是封装的热点,受元器件芯片本身防护工艺水平的限制,这些封装工艺目前处于发展瓶颈期;二是外壳材料的发展。随着外壳应用环境恶劣性以及对轻型质量的需求,要求外壳所用材料的性能提升和创新,从而使得新材料或纳米材料等应用到了外壳领域。典型的HTCC(高温共烧陶瓷)、LTCc(低温共烧陶瓷)、微晶玻璃、氮化铝陶瓷的技术参数不断提升,钨铜材料和制备工艺的提升解决了大热导率问题,高硅铝材料解决了航天航空对轻型管壳的需求,还有在抗辐照方面的管壳材料等。
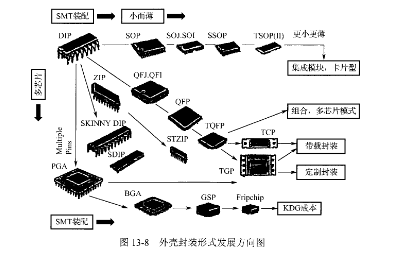
图13⒙ 外壳封装形式发展方向图
目前外壳测试技术面临的主要技术难点是大阵列管壳引线电阻的测试方法和一致性要求,这需要开发飞针测试系统,引线选择、测试算法和校准都能够自动完成。外壳封装体积和封装密度的提高对管壳共面性、平面度、形位公差等尺寸提出了更高的要求,这些参数需要规范测试标准,并形成带自动扫描测量的影像测试系统才能够实现,优化测试标准和算法是提高测试效率行之有效的方法。高密度封装导致内部焊点和焊盘的尺寸越来越小,焊盘镀层的评价技术遇到了瓶颈,原来的X射线荧光测试设备已经很难再把光斑缩小,需要开发新的测试方法和测试手段。小腔体内部气体保证技术是提升元器件可靠性的关键因素,但小腔体内部残存气体的测试技术是个棘手的问题,原有的四极质谱能保证测试0,01cc腔体气体的精度,更小腔体内的气体测试则需发展类似TOP质谱分析系统。新型材料和大体积封装凸显出热应力的作用,发展热翘曲形变测量技术是对该类型管壳参数评价的核心。
测试技术的发展趋势
外壳的发展围绕着两个方面进行。一是封装形式和封装密度,随着小型化、多引脚、 H5PS5162FFR-S5C高密高可靠、耐恶劣环境、长寿命的需求提高,外壳从最初的单列葺插发展到如今的面阵列形如图13-8所示。板上芯片、带上芯片和KGD一段时间是封装的热点,受元器件芯片本身防护工艺水平的限制,这些封装工艺目前处于发展瓶颈期;二是外壳材料的发展。随着外壳应用环境恶劣性以及对轻型质量的需求,要求外壳所用材料的性能提升和创新,从而使得新材料或纳米材料等应用到了外壳领域。典型的HTCC(高温共烧陶瓷)、LTCc(低温共烧陶瓷)、微晶玻璃、氮化铝陶瓷的技术参数不断提升,钨铜材料和制备工艺的提升解决了大热导率问题,高硅铝材料解决了航天航空对轻型管壳的需求,还有在抗辐照方面的管壳材料等。
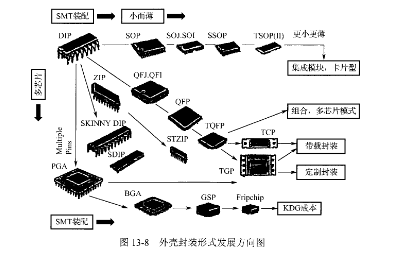
图13⒙ 外壳封装形式发展方向图
目前外壳测试技术面临的主要技术难点是大阵列管壳引线电阻的测试方法和一致性要求,这需要开发飞针测试系统,引线选择、测试算法和校准都能够自动完成。外壳封装体积和封装密度的提高对管壳共面性、平面度、形位公差等尺寸提出了更高的要求,这些参数需要规范测试标准,并形成带自动扫描测量的影像测试系统才能够实现,优化测试标准和算法是提高测试效率行之有效的方法。高密度封装导致内部焊点和焊盘的尺寸越来越小,焊盘镀层的评价技术遇到了瓶颈,原来的X射线荧光测试设备已经很难再把光斑缩小,需要开发新的测试方法和测试手段。小腔体内部气体保证技术是提升元器件可靠性的关键因素,但小腔体内部残存气体的测试技术是个棘手的问题,原有的四极质谱能保证测试0,01cc腔体气体的精度,更小腔体内的气体测试则需发展类似TOP质谱分析系统。新型材料和大体积封装凸显出热应力的作用,发展热翘曲形变测量技术是对该类型管壳参数评价的核心。
上一篇:衰减最快的电流称为电容电流
上一篇:电子功能材料
 热门点击
热门点击
- 射频连接器的检验依据主要有以下标准:
- 绝缘电阻
- 脉冲上升时间与下降时间测试方法
- 频谱仪法测试步骤。
- RS-422接口
- 混合集成电路封装外壳
- PN结反向具有一定的耐压能力
- 定义全局数据包(GD)
- 激光是指通过受激辐射而产生、放大的光
- PLC的选型
 推荐技术资料
推荐技术资料
- 业余条件下PCM2702
- PGM2702采用SSOP28封装,引脚小而密,EP3... [详细]


 公网安备44030402000607
公网安备44030402000607





