要制造出浅而且浓的结需要许多制程的相互配合
发布时间:2017/11/12 16:42:10 访问次数:494
要制造出浅而且浓的结需要许多制程的相互配合.首先需要低能童高浓度的杂质掺入技术。R05E05通过低能量离子置入(low cnergy implan0和较重掺杂元素(species)的选用把掺杂物送到离晶面较浅的位置;冉加上高速的退火技术让掺杂物尽快被激活(activated),没能进行长程的扩散行为。近来制程的演进对退火速度的要求很高,从炉管退火到RTA(rapidthermal anneal)soak anneal。冉到spikC anneal,现在在10nm已用到快闪退火(flashameal)或雷射退火(laser anncal)。越是快速短暂的高温退火,越能造出浅而低阻值的超浅结。
运用这些超浅结技术时,还必须照顾到漏电流(junction kakage)和电容(junctioncapacitance)。高的漏电流对芯片功耗有负面的影响,而高的电容将减缓芯片操作的速度。
要制造出浅而且浓的结需要许多制程的相互配合.首先需要低能童高浓度的杂质掺入技术。R05E05通过低能量离子置入(low cnergy implan0和较重掺杂元素(species)的选用把掺杂物送到离晶面较浅的位置;冉加上高速的退火技术让掺杂物尽快被激活(activated),没能进行长程的扩散行为。近来制程的演进对退火速度的要求很高,从炉管退火到RTA(rapidthermal anneal)soak anneal。冉到spikC anneal,现在在10nm已用到快闪退火(flashameal)或雷射退火(laser anncal)。越是快速短暂的高温退火,越能造出浅而低阻值的超浅结。
运用这些超浅结技术时,还必须照顾到漏电流(junction kakage)和电容(junctioncapacitance)。高的漏电流对芯片功耗有负面的影响,而高的电容将减缓芯片操作的速度。
上一篇:超浅结对MOS电性参数的影响
上一篇:金属硅化物对MOS电性参数的影响
 热门点击
热门点击
- 互连层RC延迟的降低
- Cu CMP产生的缺陷
- 俄歇电子
- 热点检测失效定位
- 先进工艺对Cu cMP的挑战
- 相位衬度
- 应力记忆技术的刻蚀
- 具有高MEEF的图形会减少全芯片的工艺窗口
- 失效模式:白动测试(ATE)连续性/开路
- HCI的机理
 推荐技术资料
推荐技术资料
- 自制经典的1875功放
- 平时我也经常逛一些音响DIY论坛,发现有很多人喜欢LM... [详细]


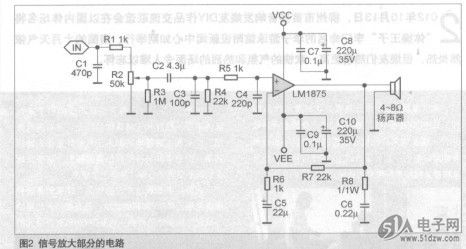
 公网安备44030402000607
公网安备44030402000607





