金属互连
发布时间:2017/10/23 20:50:52 访问次数:748
在半导体制造业中,铝及其合金在很长的时期里被广泛采用,实现由大量晶体管及其他器件所组成的集成电路互连。但是,随着晶体管尺寸的不断缩小,OPA2277UA原本应用了几十年的铝互连工艺,已经不能满足集成电路集成度、速度和可靠性持续提高的需求。与传统的铝及其合金相比,铜的导电率只有铝铜合金的一半左右(含0.5%铜的合金电阻率约为3.2uΩ・cm,而铜为1.678uΩ・cm)。较低的电阻率可以减少金属互连的RC延时,也可以降低器件的功耗。随着器件尺寸的缩小,本征延时不断下降,器件速度不断提高。Cu搭配低乃值电介质的连线工艺的器件,延时最短,速度最快,见图6.21[l]。铜的电迁移特性远好于铝[2]。并且,镶嵌方式的铜互连工艺流程简化,成本降低。因此,铜已经逐渐取代铝成为金属互连的主要材料。
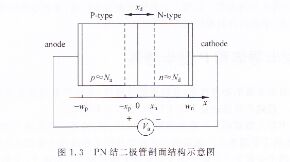
在半导体制造业中,铝及其合金在很长的时期里被广泛采用,实现由大量晶体管及其他器件所组成的集成电路互连。但是,随着晶体管尺寸的不断缩小,OPA2277UA原本应用了几十年的铝互连工艺,已经不能满足集成电路集成度、速度和可靠性持续提高的需求。与传统的铝及其合金相比,铜的导电率只有铝铜合金的一半左右(含0.5%铜的合金电阻率约为3.2uΩ・cm,而铜为1.678uΩ・cm)。较低的电阻率可以减少金属互连的RC延时,也可以降低器件的功耗。随着器件尺寸的缩小,本征延时不断下降,器件速度不断提高。Cu搭配低乃值电介质的连线工艺的器件,延时最短,速度最快,见图6.21[l]。铜的电迁移特性远好于铝[2]。并且,镶嵌方式的铜互连工艺流程简化,成本降低。因此,铜已经逐渐取代铝成为金属互连的主要材料。
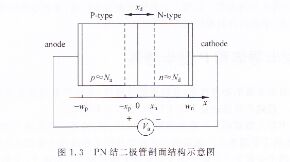
 热门点击
热门点击
- 曝光能量宽裕度,归一化图像对数斜率(NILs
- CVD是用来制备二氧化硅介质薄膜的主要工艺方
- 退火过程中晶粒的变化
- 电子产品装配过程中常用的图纸有哪些?
- 载流子迁移率提高技术
- 光刻技术发展历史
- W plugR制程
- 薄层金属沉积需要良好的台阶覆盖性
- 显影后烘焙,坚膜烘焙
- 天线距离地平面的高度应在规定的范围内变化
 推荐技术资料
推荐技术资料
- 业余条件下PCM2702
- PGM2702采用SSOP28封装,引脚小而密,EP3... [详细]


 公网安备44030402000607
公网安备44030402000607





