�߱Ƚ��ʵij�������
����ʱ��:2017/10/18 20:58:02 ���ʴ���:614
Hf02��ĸ��˽�����Ҫͨ��ԭ�Ӳ����(ALD)������л��ﻯѧ�������(MOCVD)�ȷ���������NCP1654BD65R2G��դ������·����Ҫ����ALD��������դ������Hf02,��Ϊ�������¶Ƚϵ�(300~400��),����HfO2�Ľᾧ�¶ȡ��������õ�ǰ������H��h,��H2O��Ӧ����HfO2��
HfCl��+H20~��H��2+HCl
ǰդ��I��·����Ҫ����MOCVD����HsiO,Ȼ��ͨ���Ȼ�����ӵ�������HsiON�������¶Ƚϸ�(600~700��),��Ϊ�ϸߵij����¶���Ϻ������µĵ����͵������ȴ���(1000��),������ȥ����Ĥ�е�C����,��֪C���ʻ���HfO2���γ�ʩ���ܼ�,����Ĥ��©����(��ͼ4.10)��
�������õ�Hfǰ������TDEAH��HTB,��ǰ������TDMAS��TEOS,��02��Ӧ����H��iO��
TDEAH(HfEN(GH5)2]1)+TDMAS(��EN(CH3)2��4+(�ŨD�D��HsiOx+C(��+H20+NOx HTB(Hf[O~C(CH3)3]��+TEOS(��Eo~C(CH3)3��4+02һHf��Ox+C��2+H20
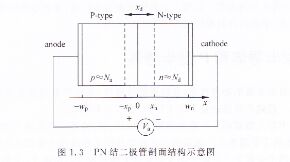
Hf02��ĸ��˽�����Ҫͨ��ԭ�Ӳ����(ALD)������л��ﻯѧ�������(MOCVD)�ȷ���������NCP1654BD65R2G��դ������·����Ҫ����ALD��������դ������Hf02,��Ϊ�������¶Ƚϵ�(300~400��),����HfO2�Ľᾧ�¶ȡ��������õ�ǰ������H��h,��H2O��Ӧ����HfO2��
HfCl��+H20~��H��2+HCl
ǰդ��I��·����Ҫ����MOCVD����HsiO,Ȼ��ͨ���Ȼ�����ӵ�������HsiON�������¶Ƚϸ�(600~700��),��Ϊ�ϸߵij����¶���Ϻ������µĵ����͵������ȴ���(1000��),������ȥ����Ĥ�е�C����,��֪C���ʻ���HfO2���γ�ʩ���ܼ�,����Ĥ��©����(��ͼ4.10)��
�������õ�Hfǰ������TDEAH��HTB,��ǰ������TDMAS��TEOS,��02��Ӧ����H��iO��
TDEAH(HfEN(GH5)2]1)+TDMAS(��EN(CH3)2��4+(�ŨD�D��HsiOx+C(��+H20+NOx HTB(Hf[O~C(CH3)3]��+TEOS(��Eo~C(CH3)3��4+02һHf��Ox+C��2+H20
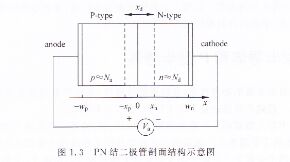
��һƪ����ͬ�ṹ�µĵ���Ǩ����
��һƪ�������
 �������
�������
- ���ƹ����ļ���ԭ����Ҫ��
- ��ͨ��բ�������IJ�뵼�������ɵ�
- HDP-CVD������Ҫ����-������ʴ��
- ����Բ�ijߴ�
- ����Բ�������ѡ��Tube
- ���������ڵ�Ƶģ���źŵ�·��PCB��ʹ�ô���
- ��ʱ��̵���������ʱ�պϴ�������
- ��λ��������ɵ�Ԫ���������϶�
- ����-1���γ�(����Ƕ)
- ���������ǽ���ʮ���ɹ����������չ���Զ�����
 �Ƽ���������
�Ƽ���������
- Ӳ��ʽMP3�������ռ���
- һ��żȻ�Ļ����ҽ�ʶ��NE0 2511,����һ��Զ����... [��ϸ]


 ��������44030402000607
��������44030402000607





