SEM展示从Cu到Ta刻蚀轮廓
发布时间:2017/11/7 21:36:43 访问次数:746
后段制程中,铜金属W-117S1P-18内连线引人,用于替代铝。为避免与非铜区域机台交叉污染和阻止器件性能的降低,必须强制执行晶背去污染清洗。晶片背面氮化硅的出现会限制铜的扩散。C,Richard等人评估各种化学品对晶背铜的清洗,并报道DHF和DHF/H2o2是最理想的、较少氮化硅保护膜损失的化学品,如图9.13所示。
晶片边缘污染去除失败,会导致严重的交叉污染,像后续CMP制程会把污染从品片边缘带到其他区域。I'ysaght等人披露,在单片旋喷清洗机上使用混合酸(HsPΘ|:H202:HCl:H2()),可以精确控制去除铜0,5mm到3,0mm,并得到一个在Cu与Ta之问的理想斜坡(见图9.14)。单片旋转喷清洗机被广泛应用于晶片边缘污染控制,同时没有化学品伤及晶片正面。
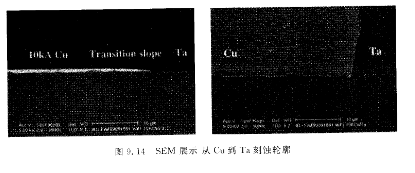
后段制程中,铜金属W-117S1P-18内连线引人,用于替代铝。为避免与非铜区域机台交叉污染和阻止器件性能的降低,必须强制执行晶背去污染清洗。晶片背面氮化硅的出现会限制铜的扩散。C,Richard等人评估各种化学品对晶背铜的清洗,并报道DHF和DHF/H2o2是最理想的、较少氮化硅保护膜损失的化学品,如图9.13所示。
晶片边缘污染去除失败,会导致严重的交叉污染,像后续CMP制程会把污染从品片边缘带到其他区域。I'ysaght等人披露,在单片旋喷清洗机上使用混合酸(HsPΘ|:H202:HCl:H2()),可以精确控制去除铜0,5mm到3,0mm,并得到一个在Cu与Ta之问的理想斜坡(见图9.14)。单片旋转喷清洗机被广泛应用于晶片边缘污染控制,同时没有化学品伤及晶片正面。
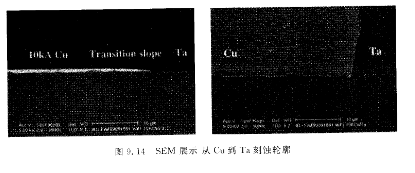
 热门点击
热门点击
- 电烙铁的功率与烙铁头温度对应关系
- 整流滤波后的电压值还会受到电网电压波动和负载
- 金属钛湿法刻蚀
- 铆接的要求
- 套刻精度一般由光刻机上移动平台的步进
- 直拉法制各的单晶硅,称为CZ硅
- 片湿法刻蚀过程原理
- 熟悉两级放大电路的设计方法
- 溢流冲洗
- 集成电路插座的安装
 推荐技术资料
推荐技术资料
- 单片机版光立方的制作
- N视频: http://v.youku.comN_sh... [详细]


 公网安备44030402000607
公网安备44030402000607





