pn结的形成
发布时间:2016/10/31 20:17:48 访问次数:1354
在一块半导体材料中,如果一部分是n型区,另一部分是p型区,在两者的交界面处就形成pn结,如图3-21所示。制备pn结一般有扩散、离子注入和外延生长等方法。 AD8609ARUZ在传统的Si半导体工艺中,通常是在n型(或p型)Si晶体表面以扩散或离子注入的方法掺入p型(或n型)杂质原子,使原⒐晶体不同区域由单―导电类型变为n型和p型导电两种类型,在n型和p型导电区的界面处形成si晶体的pn结。
扩散法制备pn结是利用扩散炉。源有固态也有气态,如si半导体材料中的n型杂质来源:As203、AsH3和PH3等;p型杂质来源:Bα3和B2H6等。扩散工艺中晶片置于加热的高温炉管中,杂质气体处于流动状态,掺杂原子的浓度及分布通过温度、时间、气体流量控制。热扩散的杂质浓度分布从表面到体内单调下降。
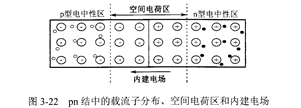
离子注入法制备pn结是利用离子注入机。离子注入I艺中首先需要将掺杂杂质,如磷、砷或硼等的气态物质导入电弧室放电离化,带电离子经电场加速注入到半导体材料表面,离子注入的杂质浓度分布一般呈现为高斯分布,并且浓度最高处不是在表面,而是在表面
以内的一定深度处,杂质浓度的分布主要取决于离子质量和注入能量。离子注入的杂质不经过处理一般处于电惰性状态,且离子注入过程会造成对原晶体材料的晶格损伤,所以要 再经过高温热处理,活化掺杂杂质和修复晶格损伤。
扩散和离子注入工艺比较成熟,且成本较低,目前在si工艺上仍大量应用。但以上两种工艺方法存在载流子浓度均匀性和界面陡峭度控制比较差,工艺过程引入晶格缺陷等局限性。外延生长是指在某种单晶衬底材料上生长与其具有相同或 接近的结晶学取向的薄膜单晶的半导体工艺。主要有液相外延、气相外延、金属有机化学气相沉积、分子束外延等。外延生长可以方便地形成不同导电类型的高质量单晶薄膜,且掺杂浓度和厚度可精确控制,界面陡峭变化。这种方法可实现各种复杂设计要求的pll结。
在一块半导体材料中,如果一部分是n型区,另一部分是p型区,在两者的交界面处就形成pn结,如图3-21所示。制备pn结一般有扩散、离子注入和外延生长等方法。 AD8609ARUZ在传统的Si半导体工艺中,通常是在n型(或p型)Si晶体表面以扩散或离子注入的方法掺入p型(或n型)杂质原子,使原⒐晶体不同区域由单―导电类型变为n型和p型导电两种类型,在n型和p型导电区的界面处形成si晶体的pn结。
扩散法制备pn结是利用扩散炉。源有固态也有气态,如si半导体材料中的n型杂质来源:As203、AsH3和PH3等;p型杂质来源:Bα3和B2H6等。扩散工艺中晶片置于加热的高温炉管中,杂质气体处于流动状态,掺杂原子的浓度及分布通过温度、时间、气体流量控制。热扩散的杂质浓度分布从表面到体内单调下降。
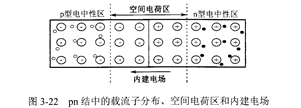
离子注入法制备pn结是利用离子注入机。离子注入I艺中首先需要将掺杂杂质,如磷、砷或硼等的气态物质导入电弧室放电离化,带电离子经电场加速注入到半导体材料表面,离子注入的杂质浓度分布一般呈现为高斯分布,并且浓度最高处不是在表面,而是在表面
以内的一定深度处,杂质浓度的分布主要取决于离子质量和注入能量。离子注入的杂质不经过处理一般处于电惰性状态,且离子注入过程会造成对原晶体材料的晶格损伤,所以要 再经过高温热处理,活化掺杂杂质和修复晶格损伤。
扩散和离子注入工艺比较成熟,且成本较低,目前在si工艺上仍大量应用。但以上两种工艺方法存在载流子浓度均匀性和界面陡峭度控制比较差,工艺过程引入晶格缺陷等局限性。外延生长是指在某种单晶衬底材料上生长与其具有相同或 接近的结晶学取向的薄膜单晶的半导体工艺。主要有液相外延、气相外延、金属有机化学气相沉积、分子束外延等。外延生长可以方便地形成不同导电类型的高质量单晶薄膜,且掺杂浓度和厚度可精确控制,界面陡峭变化。这种方法可实现各种复杂设计要求的pll结。



 公网安备44030402000607
公网安备44030402000607





