DDB效应的可靠性评价实验是在温度和电场作用下,得出氧化层的本征可靠
发布时间:2016/7/3 17:48:27 访问次数:675
DDB效应的可靠性评价实验是在温度和电场作用下,得出氧化层的本征可靠性数据,失效时间与电场、 NT405F温度和氧化层面积有关。栅介质的击穿有3种失效机制,即碰撞电离、高电场下的阳极空穴注入、工作电压条件下产生的陷阱。测量过 程中电流的变化表明,缺陷密度的增加可能与电压和时间有关。栅氧化层击穿的统计分布特性可用威布尔分布来描述,其特征寿命定义为七3。当氧化层越来越薄时,除了一般观察到的硬击穿(Hard Brcakdown,HBD),还有应力导致的漏电流(strcss-InducedLcakagc CuⅡent, sILC)、 软击穿 (softBreakdOwn,SBD)。对于超薄栅氧化层的TDDB特性,在统计分布中应使用第一次击穿作为击穿时间。
硬击穿会使漏电流呈几个数量级的增长,而软击穿只会使漏电流增加几到十几倍。TDDB的测量除了要考虑氧化层厚度和电场以外,还应注意隧穿效应、多晶耗尽、漏电流和串联电阻的影响。通过恒定电压和温度条件下的加速测试,提取模型参数,计算TDDB效应的寿命时间。试验流程如图11.7所示。
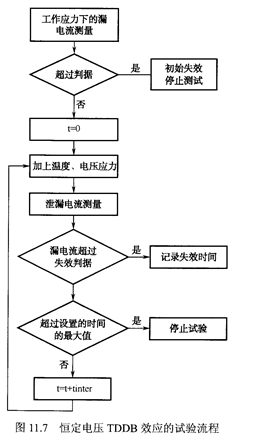
DDB效应的可靠性评价实验是在温度和电场作用下,得出氧化层的本征可靠性数据,失效时间与电场、 NT405F温度和氧化层面积有关。栅介质的击穿有3种失效机制,即碰撞电离、高电场下的阳极空穴注入、工作电压条件下产生的陷阱。测量过 程中电流的变化表明,缺陷密度的增加可能与电压和时间有关。栅氧化层击穿的统计分布特性可用威布尔分布来描述,其特征寿命定义为七3。当氧化层越来越薄时,除了一般观察到的硬击穿(Hard Brcakdown,HBD),还有应力导致的漏电流(strcss-InducedLcakagc CuⅡent, sILC)、 软击穿 (softBreakdOwn,SBD)。对于超薄栅氧化层的TDDB特性,在统计分布中应使用第一次击穿作为击穿时间。
硬击穿会使漏电流呈几个数量级的增长,而软击穿只会使漏电流增加几到十几倍。TDDB的测量除了要考虑氧化层厚度和电场以外,还应注意隧穿效应、多晶耗尽、漏电流和串联电阻的影响。通过恒定电压和温度条件下的加速测试,提取模型参数,计算TDDB效应的寿命时间。试验流程如图11.7所示。
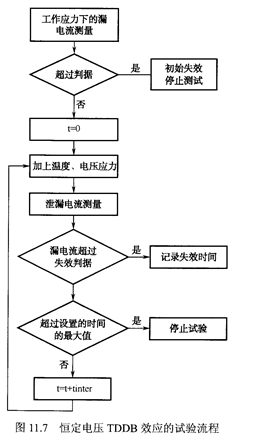
上一篇:与时间有关的栅介质击穿
上一篇:在工作电压下测量样品的泄漏电流




 公网安备44030402000607
公网安备44030402000607





