化学镀镍/金
发布时间:2014/4/29 20:12:50 访问次数:1186
化学镀镍/金(Electroless Nickel-Immersion Gold,ENIG)
ENIG即化学镀镍、闪镀金,俗称水金板。ENIG是指,在PCB焊盘上化学镀Ni(厚度≥3ym)LF10WBP-12S(03)后再镀上一层0.05~0.15 ym的薄金,用于焊接;或在镀Ni层表面再镀一层0.3~0.5 tim的厚金,
用于绑定( Wire Bonding)工艺。ENIG耐氧化、可焊性好、可多次焊接。
化学镀层均匀、表面平整、共面性好,适用于高密度SMT板的双面再流焊工艺。薄金层在焊接时迅速熔于焊料中,露出新鲜的Ni,与焊料中的Sn生成Ni3Sn4,使焊点更牢固。少量Au熔于锡中不会引起焊点变脆,Au层只起保护Ni层不被氧化的作用。但是Au不能太厚,Au能与焊料中的Sn形成金锡间共价化合物(AuSn4),在焊点中Au的含量超过3%会使焊点变脆,因为太多的Au溶解到焊点里(无论Sn-Pb还是Sn-Ag-Cu)都将引起“金脆”,所以一定要限定Au层的厚度。另外印制板加工时,如果ENIG (Ni/Au)的工艺参数控制不好,Ni被酸腐蚀或氧化,会造成“黑焊盘”现象。
化学镀镍/钯/金(Electroless Nickel Electroless Palladium and Immersion Gold,ENEPIG)
ENEPIG即化学镀镍、化学镀钯、浸镀金。ENEPIG是指先在PCB焊盘上化学镀Ni(厚度3~6um),然后再化学镀Pa(厚度0.1~0.5 ym),最后再浸镀一层0.02~O.lUm的薄金。
ENEPIG与ENIG相比,化学镀钯与化学镀镍的工艺相近似。在镍和金之间多了一层钯,相当于在镍和金之间形成了阻挡层,钯层可以防止出现置换反应导致镍的腐蚀现象,避免黑盘(或称黑镍)现象;钯层还可以使金层镀得更薄一些,避免“金脆”现蒙;另外,浸金时金能够紧密覆盖在钯层表面,提供良好的焊接面;焊接时,在合金界面不会出现富磷层,钯层会完全溶解在焊料中,露出新鲜的镍与锡生成良好的锡镍合金(Ni3S114)。因此,ENEPIG的可焊性和可靠性比ENIG好,适合军工和高可靠产品。
目前ENEPIG的主要问题是工艺还不够普遍和成熟,而且工艺控制与ENIG -样非常严格。另外钯是稀有金属,价格很贵。
化学镀镍/金(Electroless Nickel-Immersion Gold,ENIG)
ENIG即化学镀镍、闪镀金,俗称水金板。ENIG是指,在PCB焊盘上化学镀Ni(厚度≥3ym)LF10WBP-12S(03)后再镀上一层0.05~0.15 ym的薄金,用于焊接;或在镀Ni层表面再镀一层0.3~0.5 tim的厚金,
用于绑定( Wire Bonding)工艺。ENIG耐氧化、可焊性好、可多次焊接。
化学镀层均匀、表面平整、共面性好,适用于高密度SMT板的双面再流焊工艺。薄金层在焊接时迅速熔于焊料中,露出新鲜的Ni,与焊料中的Sn生成Ni3Sn4,使焊点更牢固。少量Au熔于锡中不会引起焊点变脆,Au层只起保护Ni层不被氧化的作用。但是Au不能太厚,Au能与焊料中的Sn形成金锡间共价化合物(AuSn4),在焊点中Au的含量超过3%会使焊点变脆,因为太多的Au溶解到焊点里(无论Sn-Pb还是Sn-Ag-Cu)都将引起“金脆”,所以一定要限定Au层的厚度。另外印制板加工时,如果ENIG (Ni/Au)的工艺参数控制不好,Ni被酸腐蚀或氧化,会造成“黑焊盘”现象。
化学镀镍/钯/金(Electroless Nickel Electroless Palladium and Immersion Gold,ENEPIG)
ENEPIG即化学镀镍、化学镀钯、浸镀金。ENEPIG是指先在PCB焊盘上化学镀Ni(厚度3~6um),然后再化学镀Pa(厚度0.1~0.5 ym),最后再浸镀一层0.02~O.lUm的薄金。
ENEPIG与ENIG相比,化学镀钯与化学镀镍的工艺相近似。在镍和金之间多了一层钯,相当于在镍和金之间形成了阻挡层,钯层可以防止出现置换反应导致镍的腐蚀现象,避免黑盘(或称黑镍)现象;钯层还可以使金层镀得更薄一些,避免“金脆”现蒙;另外,浸金时金能够紧密覆盖在钯层表面,提供良好的焊接面;焊接时,在合金界面不会出现富磷层,钯层会完全溶解在焊料中,露出新鲜的镍与锡生成良好的锡镍合金(Ni3S114)。因此,ENEPIG的可焊性和可靠性比ENIG好,适合军工和高可靠产品。
目前ENEPIG的主要问题是工艺还不够普遍和成熟,而且工艺控制与ENIG -样非常严格。另外钯是稀有金属,价格很贵。
 热门点击
热门点击

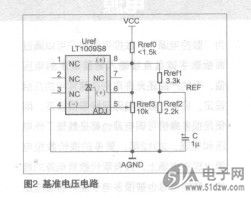
 公网安备44030402000607
公网安备44030402000607





