封装/组装技术的融合
发布时间:2011/8/25 9:48:38 访问次数:1093
1.封装向组装的渗透与延续 UAA3535
近年在封装行业多芯片模块(MCM)技术和系统级封装(SiP)技术发展很快,特别是芯片堆叠(3D封装)技术的兴起使半导体技术的发展出现新的增长点,3D IC成为目前延续摩尔定律的关键。无论是MCM、SiP,还是3D IC,其技术范畴已经超出传统封装技术,开始向组装技术渗透与延续。一方面采用硅通孔和多层印制电路板实现多芯片之间互连,另一方面采用SMT技术把不容易集成的无源元件组装到封装基板上,在一个封装模块内集成不同工艺和材料的半导体芯片以及无源元件,形成一个功能强大的功能模块或系统级电路模块,如图5.4.3所示。
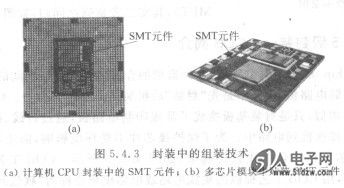
从另一个角度看,模块化封装就是精细化的组装技术。
2.组装向封装的扩展
现代电子产品朝着短、小、轻、薄和高可靠、高速度、高性能和低成本的方向发展。特别是移动和便携式电子产品,以及航天、医疗等领域对产品体积、重量要求越来越苛刻。随着超大规模集成电路和微型化片式元器件的迅速发展和广泛应用,电子整机进一步实现高性能和微心型化的主要矛盾已经不仅是元器件本身,而是元器件组装和互连形式和方法。为了适应这一发展趋势,在表面组装技术(SMT)的基础上,组装技术正在向模块化、微小型化和三维立体组装技术方向发展,使电子整机在有限空间内组装功能更多、性
能更优、集成化程度更高的电子信息系统。
实际上,自从片式元件进入0402(英制01005)、0315 (0.3mm×0.15mm)尺寸,集成电路封装节距小到0.4或0.3mm以来,特别是倒装芯片的应用,使组装定位和对准的精确度已经跨入微尺寸的范围,例如倒装芯片贴装,要求可重复精度小于4μm,已经属于封装的尺寸精度范围。
由此可见,组装技术向精细化高级阶段发展,必然是向封装技术的扩展。
3.封装/组装技术的交汇
现在有些产品的制造既可以先封装后组装,也可以直接组装。例如系统级封装(SiP),既可以由半导体封装厂完成SiP系统封装(可能是BGA,CSP,WLCSP),然后通过SMT将SiP元器件装配到电路板上;也可以在SMT车间进行芯片和其他元器件的2D或3D装配,将SiP系统嵌入到终端产品中。这种技术的集成浓缩和交汇将是未来微小型化、多功能化产品制造的发展趋势。
传统的观念认为封装技术属于半导体制造,其尺寸精确度和技术难度高于组装技术,属于高技术范畴,而组装技术则属于工艺范畴。但是在电子产品微小型化和多功能化市场需求的强力推动下,特别是近年兴起的多芯片、模块化的堆叠封装/组装(PiP/PoP,又称3D封装/组装)技术,实质上是封装技术和组装技术的综合应用,从而使“封装”和“组装”的界限日益模糊,二者正在向着交汇的方向发展。这种技术的融合,在封装领域称为模块化多芯片3D封装,而在组装领域称为微组装( micro-packaging technology,MPT),其实二者是殊途同归,如图5.4.4所示。

1.封装向组装的渗透与延续 UAA3535
近年在封装行业多芯片模块(MCM)技术和系统级封装(SiP)技术发展很快,特别是芯片堆叠(3D封装)技术的兴起使半导体技术的发展出现新的增长点,3D IC成为目前延续摩尔定律的关键。无论是MCM、SiP,还是3D IC,其技术范畴已经超出传统封装技术,开始向组装技术渗透与延续。一方面采用硅通孔和多层印制电路板实现多芯片之间互连,另一方面采用SMT技术把不容易集成的无源元件组装到封装基板上,在一个封装模块内集成不同工艺和材料的半导体芯片以及无源元件,形成一个功能强大的功能模块或系统级电路模块,如图5.4.3所示。
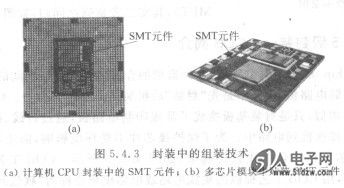
从另一个角度看,模块化封装就是精细化的组装技术。
2.组装向封装的扩展
现代电子产品朝着短、小、轻、薄和高可靠、高速度、高性能和低成本的方向发展。特别是移动和便携式电子产品,以及航天、医疗等领域对产品体积、重量要求越来越苛刻。随着超大规模集成电路和微型化片式元器件的迅速发展和广泛应用,电子整机进一步实现高性能和微心型化的主要矛盾已经不仅是元器件本身,而是元器件组装和互连形式和方法。为了适应这一发展趋势,在表面组装技术(SMT)的基础上,组装技术正在向模块化、微小型化和三维立体组装技术方向发展,使电子整机在有限空间内组装功能更多、性
能更优、集成化程度更高的电子信息系统。
实际上,自从片式元件进入0402(英制01005)、0315 (0.3mm×0.15mm)尺寸,集成电路封装节距小到0.4或0.3mm以来,特别是倒装芯片的应用,使组装定位和对准的精确度已经跨入微尺寸的范围,例如倒装芯片贴装,要求可重复精度小于4μm,已经属于封装的尺寸精度范围。
由此可见,组装技术向精细化高级阶段发展,必然是向封装技术的扩展。
3.封装/组装技术的交汇
现在有些产品的制造既可以先封装后组装,也可以直接组装。例如系统级封装(SiP),既可以由半导体封装厂完成SiP系统封装(可能是BGA,CSP,WLCSP),然后通过SMT将SiP元器件装配到电路板上;也可以在SMT车间进行芯片和其他元器件的2D或3D装配,将SiP系统嵌入到终端产品中。这种技术的集成浓缩和交汇将是未来微小型化、多功能化产品制造的发展趋势。
传统的观念认为封装技术属于半导体制造,其尺寸精确度和技术难度高于组装技术,属于高技术范畴,而组装技术则属于工艺范畴。但是在电子产品微小型化和多功能化市场需求的强力推动下,特别是近年兴起的多芯片、模块化的堆叠封装/组装(PiP/PoP,又称3D封装/组装)技术,实质上是封装技术和组装技术的综合应用,从而使“封装”和“组装”的界限日益模糊,二者正在向着交汇的方向发展。这种技术的融合,在封装领域称为模块化多芯片3D封装,而在组装领域称为微组装( micro-packaging technology,MPT),其实二者是殊途同归,如图5.4.4所示。

上一篇:封装/组装技术对比
上一篇:级封装――COB简介



 公网安备44030402000607
公网安备44030402000607





