线条热点边沿的MEEF测章
发布时间:2017/11/12 16:59:55 访问次数:730
如图13.6所示,在建立R10934EC了问题图形的图形库之后,一个输人的设计能被图形搜索方法迅速地进行筛查,而不是全芯片模拟,这个工作甚至可以在OPC前开始做。图13.7给出这个迅速筛查的方法的工作流程。这个流程的优势在于:能够OPC前探查OPC不相容边沿图形,避免了冗长而且耗时的OPC和OPC验证。采用这种流程的条件是图形库中存有问题图形的模板。
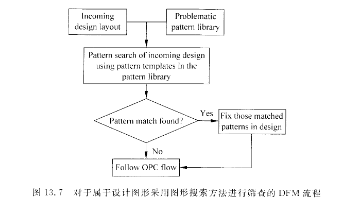
大体说来,OPC改善了设计图形从设计到晶圆片上的转移工艺(光 刻)的MEEF/NILS,也就是它的印Wll适性。然而,在最近的后OPC热点图形的MEEF分析中,我们发现图13.7 对于属于设计图形采用图形搜索方法进行筛杳的DFM流程并不总是这种情况。下面我们用两个来白于不同层的例子来解释这种例外。
对一个65nm△艺节点的逻辑器件(M1层和多晶硅层)进行后OIDC验证得到的高MEEF的热点图形被用于进行热点结构设计,而且为了验证MEEF的变化,不同CD下类似的OPC不相容边沿结构也被产生出来。为了确保用于生产的OPC自勺质量,生产配方被用在经过OPC处理过的那些测试图形上。
如图13.6所示,在建立R10934EC了问题图形的图形库之后,一个输人的设计能被图形搜索方法迅速地进行筛查,而不是全芯片模拟,这个工作甚至可以在OPC前开始做。图13.7给出这个迅速筛查的方法的工作流程。这个流程的优势在于:能够OPC前探查OPC不相容边沿图形,避免了冗长而且耗时的OPC和OPC验证。采用这种流程的条件是图形库中存有问题图形的模板。
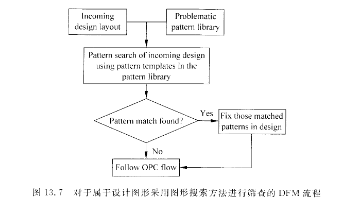
大体说来,OPC改善了设计图形从设计到晶圆片上的转移工艺(光 刻)的MEEF/NILS,也就是它的印Wll适性。然而,在最近的后OPC热点图形的MEEF分析中,我们发现图13.7 对于属于设计图形采用图形搜索方法进行筛杳的DFM流程并不总是这种情况。下面我们用两个来白于不同层的例子来解释这种例外。
对一个65nm△艺节点的逻辑器件(M1层和多晶硅层)进行后OIDC验证得到的高MEEF的热点图形被用于进行热点结构设计,而且为了验证MEEF的变化,不同CD下类似的OPC不相容边沿结构也被产生出来。为了确保用于生产的OPC自勺质量,生产配方被用在经过OPC处理过的那些测试图形上。
上一篇:Metal-1图形的例子



 公网安备44030402000607
公网安备44030402000607





