固定研磨粒抛光工艺
发布时间:2017/11/11 17:38:25 访问次数:739
2001年,第Ⅰ代同定研磨粒(fixed abrasive)抛光垫问世。⒛02年,美国应用材料公司的Rcfle妯on WebTNl抛光机推出。
固定研磨粒抛光是一种革命性的抛光技术。固定研QM3002M3 磨粒抛光台由之部分组成(见图11.6):①机械底座;②带有真空小孔的圆形基垫(sub pad)十③卷成筒状平铺在基垫上的固定研磨粒抛光垫(⒒xed al,ra“xe∞d)及能单方向牵引抛光垫的电机系统。在传统的使用 研磨液的抛光过程巾,研磨颗粒是在研磨液中,i盯研磨液在抛光中持续地添加在抛光垫ll;对于固定研磨粒抛光,氧化铈(Ceria)研磨颗粒是固定在抛光垫(见图11,7)上。在抛光中添加的是不含研磨颗粒而只用来增强选择比的化学液。在传统的研磨液抛光中,抛光台只作圆周旋转,圆形的研磨垫同定在圆形的抛光台上,一直到了使用寿命才进行更换,这样就有一个新旧研磨垫抛光效果的偏差问题;而对于固定研磨粒抛光,抛光垫是像胶带似的做成一卷,抛光时抛光垫由真空牢固地吸附在基垫上,抛光间隙时底座上的电机拉动抛光垫向前步进一个同定距离(丿L毫米),缓慢地释放新的抛光垫表面同时卷起用过的表面以补充新的研磨颗粒(兀图11,8),这样就不存在新旧研磨垫抛光效果的偏差问题,而能取得较稳定的抛光效果。每筒抛光垫能连续抛光8000多片晶圆。在传统的研磨液抛光中,研磨液中的研磨颗粒聚集在品片表面,并随着研磨垫的形变茛接压迫品片表面,较易产生凹陷。而在固定研磨粒抛光中,抛光垫中的研磨粒是通过侧向力的作用而慢慢释放,当晶片凹凸不平时,研磨时产生较大的侧向力刺激较多的研磨粒释放,抛光速率较高;而当晶片平坦时,研磨时因侧向力刺激较小研磨粒释放较少,抛光速率减慢,就起到了白我停止的作用,见图11.9。
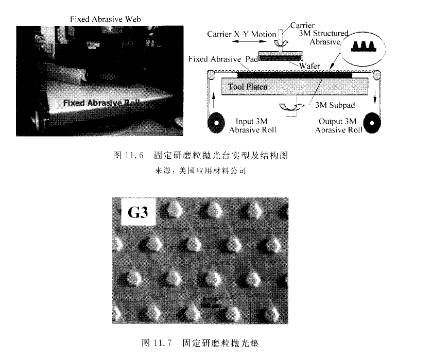
2001年,第Ⅰ代同定研磨粒(fixed abrasive)抛光垫问世。⒛02年,美国应用材料公司的Rcfle妯on WebTNl抛光机推出。
固定研磨粒抛光是一种革命性的抛光技术。固定研QM3002M3 磨粒抛光台由之部分组成(见图11.6):①机械底座;②带有真空小孔的圆形基垫(sub pad)十③卷成筒状平铺在基垫上的固定研磨粒抛光垫(⒒xed al,ra“xe∞d)及能单方向牵引抛光垫的电机系统。在传统的使用 研磨液的抛光过程巾,研磨颗粒是在研磨液中,i盯研磨液在抛光中持续地添加在抛光垫ll;对于固定研磨粒抛光,氧化铈(Ceria)研磨颗粒是固定在抛光垫(见图11,7)上。在抛光中添加的是不含研磨颗粒而只用来增强选择比的化学液。在传统的研磨液抛光中,抛光台只作圆周旋转,圆形的研磨垫同定在圆形的抛光台上,一直到了使用寿命才进行更换,这样就有一个新旧研磨垫抛光效果的偏差问题;而对于固定研磨粒抛光,抛光垫是像胶带似的做成一卷,抛光时抛光垫由真空牢固地吸附在基垫上,抛光间隙时底座上的电机拉动抛光垫向前步进一个同定距离(丿L毫米),缓慢地释放新的抛光垫表面同时卷起用过的表面以补充新的研磨颗粒(兀图11,8),这样就不存在新旧研磨垫抛光效果的偏差问题,而能取得较稳定的抛光效果。每筒抛光垫能连续抛光8000多片晶圆。在传统的研磨液抛光中,研磨液中的研磨颗粒聚集在品片表面,并随着研磨垫的形变茛接压迫品片表面,较易产生凹陷。而在固定研磨粒抛光中,抛光垫中的研磨粒是通过侧向力的作用而慢慢释放,当晶片凹凸不平时,研磨时产生较大的侧向力刺激较多的研磨粒释放,抛光速率较高;而当晶片平坦时,研磨时因侧向力刺激较小研磨粒释放较少,抛光速率减慢,就起到了白我停止的作用,见图11.9。
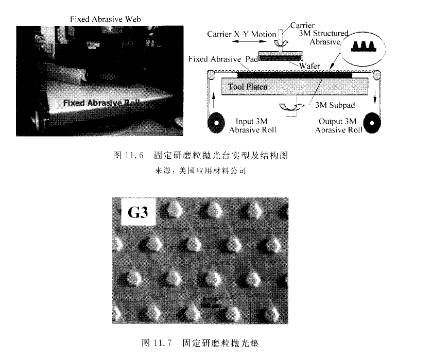
上一篇:氧化铈研磨液的特点
 热门点击
热门点击
- 电烙铁的功率与烙铁头温度对应关系
- 整流滤波后的电压值还会受到电网电压波动和负载
- 金属钛湿法刻蚀
- oBIRCH/XIⅤA案例分析
- 套刻精度一般由光刻机上移动平台的步进
- 直拉法制各的单晶硅,称为CZ硅
- 片湿法刻蚀过程原理
- OBIRCH雷射注入技术在90nm制程失效分
- 熟悉两级放大电路的设计方法
- 溢流冲洗
 推荐技术资料
推荐技术资料
- 单片机版光立方的制作
- N视频: http://v.youku.comN_sh... [详细]


 公网安备44030402000607
公网安备44030402000607





