典型的刻蚀机
发布时间:2017/11/1 19:51:44 访问次数:589
在特征尺寸从5um急剧地缩小至45nm的过程中,需要使用更低气压的各向异性等离子刻蚀, OADM101B58TLB01 以确保更小尺寸图形转移的精确度。因此,干法刻蚀机从早期的圆筒形/平行板型(各向同性/高气压)转变为~9O世纪90年代早期的RIE/CCP和HDP。另外,当晶圆尺寸从4in逐渐地增加到12in时,也就提出了在整个晶圆上控制等离子均匀性的挑战。而且节约成本的指标之―――产能,强烈地需要更高的刻蚀速率,这就高度依赖于产生高密度等离子。一些高密度等离子源,如电感等离子和顶部耦合等离子,正是在这些需求下产生并应用到IC制造业中的。在最新型反应器发展中,主要的努力包括利用可调圈数/间隙、多lx静电卡盘、额外功率频率[Ⅱ和腔壁条件控制等。所有这些都是用来改进非对称的刻蚀性能,或者是密集/稀疏图形刻蚀差异。
从⒛世纪7O年代初至今的典型刻蚀机示意图列于图8.3。圆筒形反应器是用于替换湿法刻蚀的第一种干法刻蚀机,它在去除正性光刻胶方面效率极高。早期的圆筒形刻蚀机是电感耦合的,后来换成了电容耦合以满足高的压力(0.5~1Torr)要求,这样可以达到高的刻蚀速率。然而,由于高能离子在圆筒形反应器中的无序碰撞,使得它的刻蚀更偏向于各向同性。
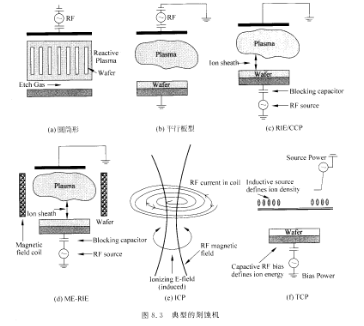
在特征尺寸从5um急剧地缩小至45nm的过程中,需要使用更低气压的各向异性等离子刻蚀, OADM101B58TLB01 以确保更小尺寸图形转移的精确度。因此,干法刻蚀机从早期的圆筒形/平行板型(各向同性/高气压)转变为~9O世纪90年代早期的RIE/CCP和HDP。另外,当晶圆尺寸从4in逐渐地增加到12in时,也就提出了在整个晶圆上控制等离子均匀性的挑战。而且节约成本的指标之―――产能,强烈地需要更高的刻蚀速率,这就高度依赖于产生高密度等离子。一些高密度等离子源,如电感等离子和顶部耦合等离子,正是在这些需求下产生并应用到IC制造业中的。在最新型反应器发展中,主要的努力包括利用可调圈数/间隙、多lx静电卡盘、额外功率频率[Ⅱ和腔壁条件控制等。所有这些都是用来改进非对称的刻蚀性能,或者是密集/稀疏图形刻蚀差异。
从⒛世纪7O年代初至今的典型刻蚀机示意图列于图8.3。圆筒形反应器是用于替换湿法刻蚀的第一种干法刻蚀机,它在去除正性光刻胶方面效率极高。早期的圆筒形刻蚀机是电感耦合的,后来换成了电容耦合以满足高的压力(0.5~1Torr)要求,这样可以达到高的刻蚀速率。然而,由于高能离子在圆筒形反应器中的无序碰撞,使得它的刻蚀更偏向于各向同性。
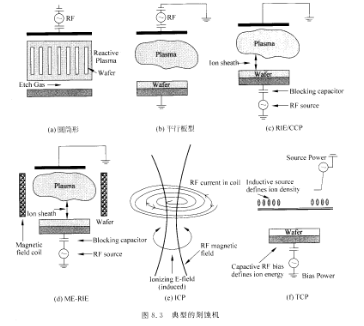
上一篇:干法刻蚀机的发展
 热门点击
热门点击
- 电烙铁的功率与烙铁头温度对应关系
- 铆接的要求
- 平嘴钳和圆嘴钳
- 偏口钳
- 套刻精度一般由光刻机上移动平台的步进
- 直拉法制各的单晶硅,称为CZ硅
- 片湿法刻蚀过程原理
- 集成电路插座的安装
- 波长、数值孔径、像空间介质折射率
- 感应线圈的检测方法
 推荐技术资料
推荐技术资料
- 单片机版光立方的制作
- N视频: http://v.youku.comN_sh... [详细]



 公网安备44030402000607
公网安备44030402000607





