磁控溅射铝及铝合金薄膜
发布时间:2017/5/23 21:14:40 访问次数:1215
集成电路置艺对溅射用铝及铝合金靶的质量要求很高,除了纯度在5N以上外,还要求铝硅、铝PM8028合金靶成分必须准确、均匀。各种成分的铝及铝合金靶,如川、As1、AlCtlO5、AlSi1CtL15等,要求金属 杂质含量≤5×106。图⒏33所示是两种形状的铝及铝合金靶照片。
磁控溅射铝及铝合金的典型工艺参数:基压1.3×104Pa;衬底温度⒛0℃;靶一衬底距离5cm;阴极电压420V,电流13A;工作气体为高纯Ar,纯度在5N以上,气压0.13~1.3Pa;溅射角5°~8°;溅射速率0.8~1um/mh。
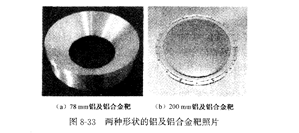
(a)78mm铞及铝合佥靶 (b)⒛0mm铞及锅合佥靶
图⒏33 两种形状的铝及铝合金靶照片
磁控溅射铝膜的附着力、致密性、台阶覆盖特性,以及薄膜厚度的可控性和重复性都好于真空蒸镀铝膜。磁控溅射工艺也适合淀积铝合金薄膜,用磁控溅射淀积的铝合金薄膜其薄膜的组成成分与相应的靶材的组成成分变化不大,如表⒏3所示是由复合靶溅射的铝合金薄膜的组成。当前,磁控溅射工艺已成为制备铝及铝合金薄膜的首选方法,普遍用于实际生产上。
集成电路置艺对溅射用铝及铝合金靶的质量要求很高,除了纯度在5N以上外,还要求铝硅、铝PM8028合金靶成分必须准确、均匀。各种成分的铝及铝合金靶,如川、As1、AlCtlO5、AlSi1CtL15等,要求金属 杂质含量≤5×106。图⒏33所示是两种形状的铝及铝合金靶照片。
磁控溅射铝及铝合金的典型工艺参数:基压1.3×104Pa;衬底温度⒛0℃;靶一衬底距离5cm;阴极电压420V,电流13A;工作气体为高纯Ar,纯度在5N以上,气压0.13~1.3Pa;溅射角5°~8°;溅射速率0.8~1um/mh。
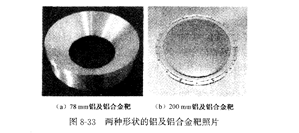
(a)78mm铞及铝合佥靶 (b)⒛0mm铞及锅合佥靶
图⒏33 两种形状的铝及铝合金靶照片
磁控溅射铝膜的附着力、致密性、台阶覆盖特性,以及薄膜厚度的可控性和重复性都好于真空蒸镀铝膜。磁控溅射工艺也适合淀积铝合金薄膜,用磁控溅射淀积的铝合金薄膜其薄膜的组成成分与相应的靶材的组成成分变化不大,如表⒏3所示是由复合靶溅射的铝合金薄膜的组成。当前,磁控溅射工艺已成为制备铝及铝合金薄膜的首选方法,普遍用于实际生产上。
上一篇:电子束真空镀铝
上一篇:铜及其阻挡层薄膜的淀积



 公网安备44030402000607
公网安备44030402000607





