隐形切割的优势如下
发布时间:2016/8/7 17:39:16 访问次数:1307
隐形切割可以解决上述问题。这个方法与其他激光切割的方法不同,EN80C196KB16激光聚焦在晶片内部是最大的一个不同点。sD方法不需要清洁晶片和其他产生的泥浆,因为不会在晶片上产生残留污染物。激光束被设计聚焦在晶片的内部,聚焦激光产生SD层,作为裂片时的分离点。隐形切割的优势如下:
①对超薄的晶片具有高速作业;
②不产生碎屑等残留污染物;
③整个过程都是在干燥的情况下进行。
隐形切割可以发展用来解决切割裂片过程中固有的残余碎屑和不必要的热损伤问题。在隐形切割中,利用片子的吸收系数随温度而变的关系,使得具有可穿透波长的激光束功率仅仅被聚焦点局部吸收。吸收功率后的片子形成一层改良层,良层是作为裂片时的分离区域。其原理如下:如图5-5所示,激光器透过材料表面,并聚焦于内部[如图5-5(a)所示],当内部激光功率密度超过临界值时,可在任意深度上形成带状SD层(多晶层/高位错密度层和微裂纹/孑L洞)然后通过扩晶得到晶粒[如图5-5(b)所示]。
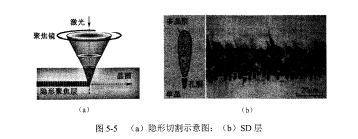
・
隐形切割可以解决上述问题。这个方法与其他激光切割的方法不同,EN80C196KB16激光聚焦在晶片内部是最大的一个不同点。sD方法不需要清洁晶片和其他产生的泥浆,因为不会在晶片上产生残留污染物。激光束被设计聚焦在晶片的内部,聚焦激光产生SD层,作为裂片时的分离点。隐形切割的优势如下:
①对超薄的晶片具有高速作业;
②不产生碎屑等残留污染物;
③整个过程都是在干燥的情况下进行。
隐形切割可以发展用来解决切割裂片过程中固有的残余碎屑和不必要的热损伤问题。在隐形切割中,利用片子的吸收系数随温度而变的关系,使得具有可穿透波长的激光束功率仅仅被聚焦点局部吸收。吸收功率后的片子形成一层改良层,良层是作为裂片时的分离区域。其原理如下:如图5-5所示,激光器透过材料表面,并聚焦于内部[如图5-5(a)所示],当内部激光功率密度超过临界值时,可在任意深度上形成带状SD层(多晶层/高位错密度层和微裂纹/孑L洞)然后通过扩晶得到晶粒[如图5-5(b)所示]。
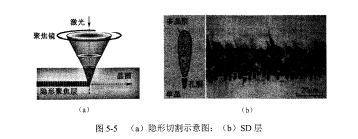
・



 公网安备44030402000607
公网安备44030402000607





