对可靠性的影响
发布时间:2015/6/23 19:02:10 访问次数:639
氧化层中存在上述4种电荷,当这些电荷位置或密度变化时,调制了硅表面势,因此,AD815ARB凡是与表面势有关的各种电参数均受到影响。如对双极性器件,导敢电流增益和PN结反向漏电电流变化,击穿电压蠕变等。对MOS器件引起阈值电压及跨导漂移,甚至一漏击穿;对电荷耦合器件则引起转移效率降低等。在这4种电荷中,以可动离子电荷最不稳定,对器件可靠性的影响最大。
氧化层电荷对可靠性的影响有下述几方面。
增加PN结反向漏电电流,降低结的击穿电压
当氧化层中Na+全部迁移至Si0。表面时,Qm等于“零”;当Na+全部集中在Si-S102界面时,Qm为最大。在PNP晶体管中,它可使P区表面反型,形成沟道漏电电流,从而引起击穿,如图4.5所示。在NPN晶体管中引起基区表面反型,产生沟道,导致TTL电
路多发射极晶体管交叉漏电增加,输出管高电平幅度降低,甚至失效。
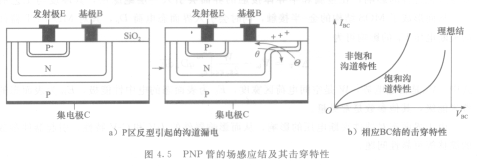
氧化层中存在上述4种电荷,当这些电荷位置或密度变化时,调制了硅表面势,因此,AD815ARB凡是与表面势有关的各种电参数均受到影响。如对双极性器件,导敢电流增益和PN结反向漏电电流变化,击穿电压蠕变等。对MOS器件引起阈值电压及跨导漂移,甚至一漏击穿;对电荷耦合器件则引起转移效率降低等。在这4种电荷中,以可动离子电荷最不稳定,对器件可靠性的影响最大。
氧化层电荷对可靠性的影响有下述几方面。
增加PN结反向漏电电流,降低结的击穿电压
当氧化层中Na+全部迁移至Si0。表面时,Qm等于“零”;当Na+全部集中在Si-S102界面时,Qm为最大。在PNP晶体管中,它可使P区表面反型,形成沟道漏电电流,从而引起击穿,如图4.5所示。在NPN晶体管中引起基区表面反型,产生沟道,导致TTL电
路多发射极晶体管交叉漏电增加,输出管高电平幅度降低,甚至失效。
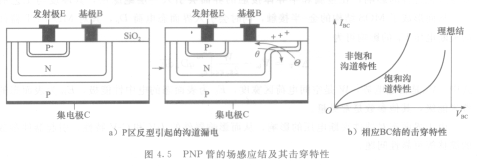
 热门点击
热门点击


 公网安备44030402000607
公网安备44030402000607





