物理控制程序
发布时间:2015/6/23 18:59:34 访问次数:535
20世纪60年代初期,MOS晶体管开始批量生产,发现与硅热氧化结构有关的电荷严重影响着成品率、AD8139ACPZ工作的稳定性和可靠性,于是展开了关于氧化层电荷的研究。这里用面密度Q(Clcmz)表示,面密度Q是指Si-S102界面处单位面积上的净有效电荷量,距界面有一定距离时要折合到界面处,所以用“有效”强调了这一点。用N表示相应电荷数N=I Q/q f,q为电子电荷。现已公认:在Si-S102界面的S102 -侧存在4种氧化层电荷,如图4.4所示。
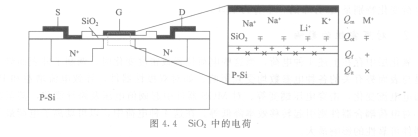
图4.4 Si02中的电荷
固定氧化层电荷(Fixed Oxide Charge) Qf
Qf足指分布在Si02 -侧距Si-S102界面小于2.5nm的氧化层内的正电荷。Qf起源于硅材料在热氧化过程中引入的缺陷,如生成离子化的硅或氧空位,它们都带正电而形成正电荷。这种电荷的特点是,它不随外加偏压和硅表面势变化,与硅衬底杂质类型及其浓度和Si02层厚度基本无关。
20世纪60年代初期,MOS晶体管开始批量生产,发现与硅热氧化结构有关的电荷严重影响着成品率、AD8139ACPZ工作的稳定性和可靠性,于是展开了关于氧化层电荷的研究。这里用面密度Q(Clcmz)表示,面密度Q是指Si-S102界面处单位面积上的净有效电荷量,距界面有一定距离时要折合到界面处,所以用“有效”强调了这一点。用N表示相应电荷数N=I Q/q f,q为电子电荷。现已公认:在Si-S102界面的S102 -侧存在4种氧化层电荷,如图4.4所示。
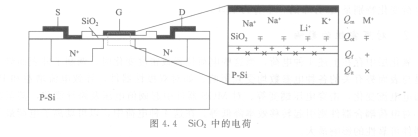
图4.4 Si02中的电荷
固定氧化层电荷(Fixed Oxide Charge) Qf
Qf足指分布在Si02 -侧距Si-S102界面小于2.5nm的氧化层内的正电荷。Qf起源于硅材料在热氧化过程中引入的缺陷,如生成离子化的硅或氧空位,它们都带正电而形成正电荷。这种电荷的特点是,它不随外加偏压和硅表面势变化,与硅衬底杂质类型及其浓度和Si02层厚度基本无关。




 公网安备44030402000607
公网安备44030402000607





