ΒΙΉΑ–ΨΤ§
ΖΔ≤Φ ±Φδ:2014/5/29 20:08:53 ΖΟΈ ¥Έ ΐ:1056
ΒΙΉΑ–ΨΤ§FC (Flip Chip)”κΨß‘≤ΦΕCSP (WL-CSP)WLP (Wafer Level Processing)ΒΡΉιΉΑΦΦ θ
ΒΙΉΑ–ΨΤ§FCΓΔΨß‘≤ΦΕCSPΓΔS500-2.5-RΨß‘≤ΦΕΖβΉΑWLP÷ς“Σ”Π”Ο‘Ύ–¬“Μ¥ζ ÷ΜζΓΔDVDΓΔPDAΓΔΡΘΩιΒ»ΓΘ
ΒΙΉΑ–ΨΤ§FC
ΒΙΉΑ–ΨΤ§Ε®“εΈΣΩ…Ρή≤ΜΫχ––‘ΌΖ÷≤ΦΒΡΨß‘≤ΓΘΆ®≥ΘΘ§Έΐ«ρ–Γ”Ύ150ymΘ§«ρΦδΨύ–Γ”Ύ350ymΓΘ
ΒΙΉΑ–ΨΤ§ΒΡΧΊΒψ
ΆΦ21-19(a)Ήψ¥ΪΆ≥’ΐΉΑΤςΦΰΘ§–ΨΤ§ΒγΤχΟφ≥·…œΘΜΆΦ21-19 (b) «ΒΙΉΑ–ΨΤ§Θ§ΒγΤχΟφ≥·œ¬ΓΘ
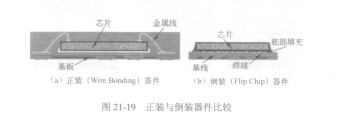
ΝμΆβΘ§FC‘Ύ‘≤Τ§…œ÷≤«ρΘ§ΧυΤ§ ±–η“ΣΫΪΤδΖ≠ΉΣΘ§Εχ±Μ≥ΤΈΣΒΙΉΑ–ΨΤ§ΓΘFCΨΏ”–“‘œ¬ΧΊΒψΓΘ
ΔΌΜυ≤Ρ «ΙηΘ§ΒγΤχΟφΦΑΚΗΆΙ‘ΎΤςΦΰœ¬±μΟφΓΘ
ΔΎΉν–ΓΒΡΧεΜΐΓΘFCΒΡ«ρΦδΨύ“ΜΑψΈΣ4ΓΪ14milΓΔ«ρΨΕ2.5ΓΪ8milΘ§ ΙΉιΉΑΒΡΧεΜΐΉν–ΓΓΘ
ΔέΉνΒΆΒΡΗΏΕ»ΓΘFCΉιΉΑΫΪ–ΨΤ§”Ο‘ΌΝςΜρ»»―ΙΖΫ Ϋ÷±Ϋ”ΉιΉΑ‘ΎΜυΑεΜρ”Γ÷ΤΒγ¬ΖΑε…œΓΘ
ΔήΗϋΗΏΒΡΉιΉΑΟήΕ»ΓΘFCΦΦ θΩ…“‘ΫΪ–ΨΤ§ΉιΉΑ‘ΎPCBΒΡΝΫΗωΟφ…œΘ§¥σ¥σΧαΗΏΉιΉΑΟήΕ»ΓΘ
ΔίΗϋΒΆΒΡΉιΉΑ‘κ…υΓΘ”…”ΎFCΉιΉΑΫΪ–ΨΤ§÷±Ϋ”ΉιΉΑ‘ΎΜυΑε…œΘ§‘κ…υΒΆ”ΎBGAΚΆSMDΓΘ
Δό≤ΜΩ…ΖΒ–ό–‘ΓΘFCΉιΉΑΚσ–η“ΣΉωΒΉ≤ΩΧν≥δΓΘFCΒΡΚΗΆΙ≤ΡΝœ”κΜυΑεΒΡΝ§Ϋ”ΖΫ ΫΦϊ±μ21-5ΓΘ
±μ21-5ΒΙΉΑ–ΨΤ§ΒΡΚΗΆΙ≤ΡΝœ”κΜυΑεΒΡΝ§Ϋ”ΖΫ Ϋ

ΒΙΉΑ–ΨΤ§FC (Flip Chip)”κΨß‘≤ΦΕCSP (WL-CSP)WLP (Wafer Level Processing)ΒΡΉιΉΑΦΦ θ
ΒΙΉΑ–ΨΤ§FCΓΔΨß‘≤ΦΕCSPΓΔS500-2.5-RΨß‘≤ΦΕΖβΉΑWLP÷ς“Σ”Π”Ο‘Ύ–¬“Μ¥ζ ÷ΜζΓΔDVDΓΔPDAΓΔΡΘΩιΒ»ΓΘ
ΒΙΉΑ–ΨΤ§FC
ΒΙΉΑ–ΨΤ§Ε®“εΈΣΩ…Ρή≤ΜΫχ––‘ΌΖ÷≤ΦΒΡΨß‘≤ΓΘΆ®≥ΘΘ§Έΐ«ρ–Γ”Ύ150ymΘ§«ρΦδΨύ–Γ”Ύ350ymΓΘ
ΒΙΉΑ–ΨΤ§ΒΡΧΊΒψ
ΆΦ21-19(a)Ήψ¥ΪΆ≥’ΐΉΑΤςΦΰΘ§–ΨΤ§ΒγΤχΟφ≥·…œΘΜΆΦ21-19 (b) «ΒΙΉΑ–ΨΤ§Θ§ΒγΤχΟφ≥·œ¬ΓΘ
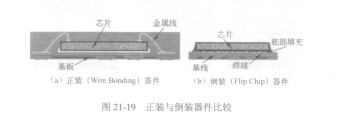
ΝμΆβΘ§FC‘Ύ‘≤Τ§…œ÷≤«ρΘ§ΧυΤ§ ±–η“ΣΫΪΤδΖ≠ΉΣΘ§Εχ±Μ≥ΤΈΣΒΙΉΑ–ΨΤ§ΓΘFCΨΏ”–“‘œ¬ΧΊΒψΓΘ
ΔΌΜυ≤Ρ «ΙηΘ§ΒγΤχΟφΦΑΚΗΆΙ‘ΎΤςΦΰœ¬±μΟφΓΘ
ΔΎΉν–ΓΒΡΧεΜΐΓΘFCΒΡ«ρΦδΨύ“ΜΑψΈΣ4ΓΪ14milΓΔ«ρΨΕ2.5ΓΪ8milΘ§ ΙΉιΉΑΒΡΧεΜΐΉν–ΓΓΘ
ΔέΉνΒΆΒΡΗΏΕ»ΓΘFCΉιΉΑΫΪ–ΨΤ§”Ο‘ΌΝςΜρ»»―ΙΖΫ Ϋ÷±Ϋ”ΉιΉΑ‘ΎΜυΑεΜρ”Γ÷ΤΒγ¬ΖΑε…œΓΘ
ΔήΗϋΗΏΒΡΉιΉΑΟήΕ»ΓΘFCΦΦ θΩ…“‘ΫΪ–ΨΤ§ΉιΉΑ‘ΎPCBΒΡΝΫΗωΟφ…œΘ§¥σ¥σΧαΗΏΉιΉΑΟήΕ»ΓΘ
ΔίΗϋΒΆΒΡΉιΉΑ‘κ…υΓΘ”…”ΎFCΉιΉΑΫΪ–ΨΤ§÷±Ϋ”ΉιΉΑ‘ΎΜυΑε…œΘ§‘κ…υΒΆ”ΎBGAΚΆSMDΓΘ
Δό≤ΜΩ…ΖΒ–ό–‘ΓΘFCΉιΉΑΚσ–η“ΣΉωΒΉ≤ΩΧν≥δΓΘFCΒΡΚΗΆΙ≤ΡΝœ”κΜυΑεΒΡΝ§Ϋ”ΖΫ ΫΦϊ±μ21-5ΓΘ
±μ21-5ΒΙΉΑ–ΨΤ§ΒΡΚΗΆΙ≤ΡΝœ”κΜυΑεΒΡΝ§Ϋ”ΖΫ Ϋ

…œ“ΜΤΣΘΚCOBΙΛ“’ΤάΙά
…œ“ΜΤΣΘΚΒΙΉΑ–ΨΤ§ΒΡΉιΉΑΙΛ“’Νς≥Χ
 »»Ο≈ΒψΜς
»»Ο≈ΒψΜς
- ROMΒΡΜυ±ΨΫαΙΙ
- PROM‘≠άμ
- PCBΚΗ≈Χ±μΟφΆΩΘ®ΕΤΘ©≤ψΦΑΈό«ΠPCBΚΗ≈ΧΆΩΕΤ
- »»ΥΚΝ―Μρ ’ΥθΩΉ
- Ψ≤Βγ ΆΖ≈(ESD)Θ·ΒγΤχΙΐ‘Ί(EOS)‘ΎΒγΉ”
- Ϋπ τΦδΜ·ΚœΈοΒΡ¥ύ–‘
- Flip ChipΘ®ΒΙΉΑ–ΨΤ§Θ©ΦΦ θ
- Β ±Έ¬Ε»«ζœΏΒΡ≤β ‘ΖΫΖ®ΚΆ≤Ϋ÷η
- Τχœύ‘ΌΝςΚΗ(VPS)¬·ΒΡ–¬ΖΔ’Ι
- …ηΦΤ”Γ÷ΤΒγ¬ΖΑε“ΜΑψΖ÷ΈΣ“‘œ¬7Ηω≤Ϋ÷η
 ΆΤΦωΦΦ θΉ Νœ
ΆΤΦωΦΦ θΉ Νœ
- ΒγΕ·ΈϋΈΐά”Χζ
- ”Ο12V/2AΒΡΒγ‘¥ΈΣΒγ¥≈ΖßΚΆ±ΟΙ©ΒγΘ§FQPF9N50... [œξœΗ]
- MPS ΤτΕ·ΤςΩΣΖΔΑε/ΤάΙάΧΉΦΰΘ®EVKT/P
- 12VΓΔ6A ΥΡ¬ΖΫΒ―ΙΒγ‘¥Ιήάμ IC
- ΐΉ÷ΚψΕ®ΒΦΆ® ±ΦδΩΊ÷ΤΡΘ ΫΘ®COTΘ©
- Ά§≤ΫΫΒ―ΙPWM DC-DCœΏ–‘
- ADC ΦΦ θ≤Έ ΐ”κ”Π”Ο–η«σ÷°
- Ζ¥ΦΛ±δΜΜΤς¥ΪΒΦΚΆΖχ…δΒγ¥≈Η…»≈Ζ÷
- ΕύΟΫΧε–≠¥ΠάμΤςSM501‘Ύ«Ε»κ ΫœΒΆ≥÷–ΒΡ”Π”Ο
- Μυ”ΎIEEE802.11bΒΡEPAΈ¬Ε»±δΥΆΤς
- QUICCEngine–¬“ΐ«φΆΤΕ·IPΆχ¬γΗο–¬
- SoCΟφ άΑΥΡξΚσΒΡ≤ζ“ΒΜζ”ω
- MPC8xxœΒΝ–¥ΠάμΤςΒΡ«Ε»κ ΫœΒΆ≥Βγ‘¥…ηΦΤ
- dsPICΦΑΤδ‘ΎΫΜΝς±δΤΒΒςΥΌ÷–ΒΡ”Π”Ο―–ΨΩ


 ΙΪΆχΑ≤±Η44030402000607
ΙΪΆχΑ≤±Η44030402000607





