温度或超过温度在氧化层中导致明显“非反应性”可动氢陷阱
发布时间:2023/10/11 22:38:25 访问次数:88
随着芯片制造中器件数量和复杂度的增加,这个重要性也不断增加。精确的确定快漂移动器件与慢漂移器件在统计分布偏移中意味着成功的产品。
如果考虑到与应力时间r的关系,更多的数据表明界面态和固定电荷与应力作用时间有着相同的关系r⒍25。
尽管可能会观察到一些偏差,但这个时间的依赖关系一般在0,2~0.3之间。
由于NBTI激活能和控制NBTI退化机制的反应动力学的变化,有必要使用可靠性统计模型预测IC性能、成品率和可靠性。

工艺温度应该被限制小于1100℃,尽管不同的高温工艺温度对氮化栅氧的影响仍然没有报道,但是很明显这些温度或超过这些温度可以在氧化层中导致明显的“非反应性”的可动氢陷阱。
这些结果和N20生长的二氧化硅明显减少了高温下生长时的击穿电荷是一致的。
和纯氧相比,随着氧化层生长温度达到近似1Os0℃,击穿电荷量也增加。另一个影响NBTI的问题是后金属退火温度和形成气体的退火温度。
金属后退火温度和组成气氛退火温度应该低于370℃,以改善在窄沟道器件中的NBTI效应和TDDB效应。

当前,对栅氧击穿主要是由负电荷的电子或正电荷的空穴起主要作用的问题,说明是正电荷空穴积累得多,但也不能否定电子的作用,所以可能两者都起作用,只是何种(可能是空穴)为主的问题。
其他的退火诸如硅化物后退火温度可以影响NBTI性能。因此,必须小心优化所有的关键退火温度和工艺中退火的气氛。
硬击穿是大电流释放的能量引起栅氧化层的破裂,器件失效;软击穿表现为电流、电压的突然增加,或者电流噪声的增加,器件一般还可以正常工作一段时间。
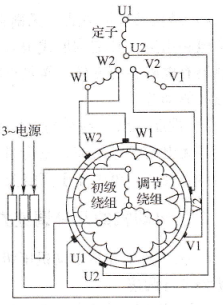
深圳市慈安科技有限公司http://cakj.51dzw.com
随着芯片制造中器件数量和复杂度的增加,这个重要性也不断增加。精确的确定快漂移动器件与慢漂移器件在统计分布偏移中意味着成功的产品。
如果考虑到与应力时间r的关系,更多的数据表明界面态和固定电荷与应力作用时间有着相同的关系r⒍25。
尽管可能会观察到一些偏差,但这个时间的依赖关系一般在0,2~0.3之间。
由于NBTI激活能和控制NBTI退化机制的反应动力学的变化,有必要使用可靠性统计模型预测IC性能、成品率和可靠性。

工艺温度应该被限制小于1100℃,尽管不同的高温工艺温度对氮化栅氧的影响仍然没有报道,但是很明显这些温度或超过这些温度可以在氧化层中导致明显的“非反应性”的可动氢陷阱。
这些结果和N20生长的二氧化硅明显减少了高温下生长时的击穿电荷是一致的。
和纯氧相比,随着氧化层生长温度达到近似1Os0℃,击穿电荷量也增加。另一个影响NBTI的问题是后金属退火温度和形成气体的退火温度。
金属后退火温度和组成气氛退火温度应该低于370℃,以改善在窄沟道器件中的NBTI效应和TDDB效应。

当前,对栅氧击穿主要是由负电荷的电子或正电荷的空穴起主要作用的问题,说明是正电荷空穴积累得多,但也不能否定电子的作用,所以可能两者都起作用,只是何种(可能是空穴)为主的问题。
其他的退火诸如硅化物后退火温度可以影响NBTI性能。因此,必须小心优化所有的关键退火温度和工艺中退火的气氛。
硬击穿是大电流释放的能量引起栅氧化层的破裂,器件失效;软击穿表现为电流、电压的突然增加,或者电流噪声的增加,器件一般还可以正常工作一段时间。
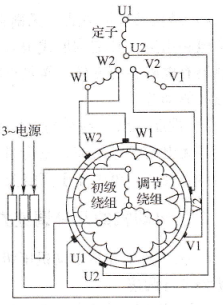
深圳市慈安科技有限公司http://cakj.51dzw.com



 公网安备44030402000607
公网安备44030402000607





