LED封装的键合热阻分析
发布时间:2016/8/13 23:27:55 访问次数:795
封装结构的传导热量的能力一般用热阻来衡量,其单位为刀W,1刀W表示当器件热耗散功率为1W时, AK5353VT器件上的温降是1°C。大多数LED封装产品都采用正面出光的形式,如图⒎33所示。另一种是倒装焊芯片结构,如图⒎34所示。这两种结构的LED器件的主要热传导瓶颈分成几个主要的部分,即材料的热阻和3个界面的影响,材料的热阻主要包括芯片的热阻,各类热沉的热阻,界面主要包括:芯片到热沉金属片,热沉金属片到PCB板,以及PCB到外部散热体。
在上述结构中,各层的热阻各不相同,大多都有器件的材料特性和结构尺寸所决定,如芯片、衬底的热阻,封装工艺中最大的变量是个个连接界面的热阻,它包括倒装焊芯片与硅衬底的键合界面和芯片与热沉的连接界面。在此我们讨论芯片与热沉的结合面。通常为给芯片提供良好的机械连接及散热通道,芯片通过导热性较好的材料键合到一金属或陶瓷底座上,(这一键合的过程通常也称为固晶或芯片粘接),键合材料的选择及工艺水平决定了芯片衬底到底座的热阻,这部分热阻称为键合热阻。
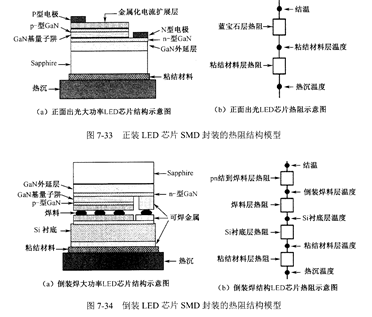
封装结构的传导热量的能力一般用热阻来衡量,其单位为刀W,1刀W表示当器件热耗散功率为1W时, AK5353VT器件上的温降是1°C。大多数LED封装产品都采用正面出光的形式,如图⒎33所示。另一种是倒装焊芯片结构,如图⒎34所示。这两种结构的LED器件的主要热传导瓶颈分成几个主要的部分,即材料的热阻和3个界面的影响,材料的热阻主要包括芯片的热阻,各类热沉的热阻,界面主要包括:芯片到热沉金属片,热沉金属片到PCB板,以及PCB到外部散热体。
在上述结构中,各层的热阻各不相同,大多都有器件的材料特性和结构尺寸所决定,如芯片、衬底的热阻,封装工艺中最大的变量是个个连接界面的热阻,它包括倒装焊芯片与硅衬底的键合界面和芯片与热沉的连接界面。在此我们讨论芯片与热沉的结合面。通常为给芯片提供良好的机械连接及散热通道,芯片通过导热性较好的材料键合到一金属或陶瓷底座上,(这一键合的过程通常也称为固晶或芯片粘接),键合材料的选择及工艺水平决定了芯片衬底到底座的热阻,这部分热阻称为键合热阻。
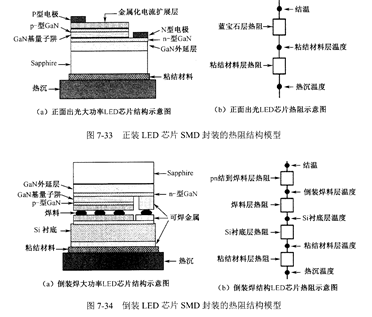
上一篇:热对流



 公网安备44030402000607
公网安备44030402000607





