刻蚀速率是指目标材料的去除率
发布时间:2019/1/30 19:17:41 访问次数:5244
槽刻蚀被用来演示刻蚀I艺评价中常用的度量方法。所有的千法刻蚀T艺通常是由四个基本状态构成:刻蚀前,部分刻蚀,刻蚀到位和过刻蚀。HA1-5190-2它们的主要特性有刻蚀速率、选择性、深宽比、终点探测、关键尺寸(CI))、均匀性和微负载。
刻蚀速率是指目标材料的去除率。选择比被定义为薄膜的刻蚀速率勹衬底或者掩膜的刻蚀速率的比值。薄膜B是刻蚀停止层,被用来减少在整个晶圆内所有结构上要承担的过刻蚀负载,通常较高的选择性作为此步骤的首选c过刻蚀是由于刻蚀的不均匀性和/或生Κ
的薄膜不平所造成的。不是所有的日标材料都可以在同一时问内从晶圆上去除,l,xl此过刻蚀是必要的。这时刻蚀在未完成的区域继续去除目标材料,而在已经完成的区域几乎停止。深宽比被定义为刻蚀深度与刻蚀图形CD的比值,高的深宽比容易使刻蚀停止。在刻蚀机中,终点探测是一个关键的控制方法,用来确保以最小的或者是所希望的目标材料以下的过刻蚀量将所有的目标材料从晶圆表面刻蚀掉。这种技术在等离子刻蚀过程中监测特定的光发射强度的变化,刻蚀机可以在某一特定的强度变化时被触发停止刻蚀,以此标志刻蚀的完成。AEI(刻蚀后检测)CD是IC制造中的一个重要指标,通常与刻蚀的特征图形的尺寸相关联.包括有浅槽隔离的间隙、品体管的沟道长度、金属互联线的宽度等。更小的CI)是改进IC技术的着震点c均匀性是IC制造屮不可缺少的另一个质量的童度量,不仅要做到晶圆与晶圆间、批次与批次间的均匀.还要做到晶圆内、芯片内的均匀,为使芯片功能正确,需要对均匀性加以严格的控制,使其在不同的规模中表现出相似的刻蚀特性。刻蚀中的微负载效应是指在整个晶圆上,由于稠密的图形与孤讠的图形同时存在所表现出的不同刻蚀行为。稠密的图形(扃)显示比孤立图形(左)具有更垂直的侧墙形状。这种现象可以看成由丁在孤讠图形这个区域有更多的聚合物产生机制存在。
在It)制造中的干法刻蚀町以归结于线、沟槽和孔应用的组合.图8.5总结F各种刻蚀形状,包括规则的和不规则的。在多晶硅栅制作中,所需要的刻蚀形状是矩形的。即使干法刻蚀已经被广泛地认为能够提供垂直的刻蚀速率,但无论是考虑衬底与界面的相互作用或是在刻蚀与钝化问仔细地寻求平衡,都无法实现如图8.5左上部分显示的完全矩形的形状。通常的情况是,轻微过度的侧墙钝化导致形成F锥形的形状。而倒锥形形状来源于在刻蚀过程屮钝化作用的逐渐减小,这种形状在高速电路应用中是受欢迎的,这时需要小一些的栅底部CD。另外,宽的栅顶部为后续的硅化物I艺提供了足够的表面。缩颈的原因主要是多品硅栅的掺杂浓度造成的刻蚀速率差,严重地缩颈通常都与多晶硅栅重掺杂有关。多晶硅栅的底部存在脚和缺口都不是理想的形状,它们都趋向于非对称的源、漏,因而造成器件的失配。更具体地说,缺口容易引起栅I'r)T)(轻掺杂漏)重叠减少,这将导致更高的源侧R’、电阻和更高的漏侧衬底电流Ⅰ出b。不对称的脚有时源于糟糕的光刻胶线宽粗糙度。尽管如此,至关重要的是制作出可良好控制、对称并可重复的形状。
槽刻蚀被用来演示刻蚀I艺评价中常用的度量方法。所有的千法刻蚀T艺通常是由四个基本状态构成:刻蚀前,部分刻蚀,刻蚀到位和过刻蚀。HA1-5190-2它们的主要特性有刻蚀速率、选择性、深宽比、终点探测、关键尺寸(CI))、均匀性和微负载。
刻蚀速率是指目标材料的去除率。选择比被定义为薄膜的刻蚀速率勹衬底或者掩膜的刻蚀速率的比值。薄膜B是刻蚀停止层,被用来减少在整个晶圆内所有结构上要承担的过刻蚀负载,通常较高的选择性作为此步骤的首选c过刻蚀是由于刻蚀的不均匀性和/或生Κ
的薄膜不平所造成的。不是所有的日标材料都可以在同一时问内从晶圆上去除,l,xl此过刻蚀是必要的。这时刻蚀在未完成的区域继续去除目标材料,而在已经完成的区域几乎停止。深宽比被定义为刻蚀深度与刻蚀图形CD的比值,高的深宽比容易使刻蚀停止。在刻蚀机中,终点探测是一个关键的控制方法,用来确保以最小的或者是所希望的目标材料以下的过刻蚀量将所有的目标材料从晶圆表面刻蚀掉。这种技术在等离子刻蚀过程中监测特定的光发射强度的变化,刻蚀机可以在某一特定的强度变化时被触发停止刻蚀,以此标志刻蚀的完成。AEI(刻蚀后检测)CD是IC制造中的一个重要指标,通常与刻蚀的特征图形的尺寸相关联.包括有浅槽隔离的间隙、品体管的沟道长度、金属互联线的宽度等。更小的CI)是改进IC技术的着震点c均匀性是IC制造屮不可缺少的另一个质量的童度量,不仅要做到晶圆与晶圆间、批次与批次间的均匀.还要做到晶圆内、芯片内的均匀,为使芯片功能正确,需要对均匀性加以严格的控制,使其在不同的规模中表现出相似的刻蚀特性。刻蚀中的微负载效应是指在整个晶圆上,由于稠密的图形与孤讠的图形同时存在所表现出的不同刻蚀行为。稠密的图形(扃)显示比孤立图形(左)具有更垂直的侧墙形状。这种现象可以看成由丁在孤讠图形这个区域有更多的聚合物产生机制存在。
在It)制造中的干法刻蚀町以归结于线、沟槽和孔应用的组合.图8.5总结F各种刻蚀形状,包括规则的和不规则的。在多晶硅栅制作中,所需要的刻蚀形状是矩形的。即使干法刻蚀已经被广泛地认为能够提供垂直的刻蚀速率,但无论是考虑衬底与界面的相互作用或是在刻蚀与钝化问仔细地寻求平衡,都无法实现如图8.5左上部分显示的完全矩形的形状。通常的情况是,轻微过度的侧墙钝化导致形成F锥形的形状。而倒锥形形状来源于在刻蚀过程屮钝化作用的逐渐减小,这种形状在高速电路应用中是受欢迎的,这时需要小一些的栅底部CD。另外,宽的栅顶部为后续的硅化物I艺提供了足够的表面。缩颈的原因主要是多品硅栅的掺杂浓度造成的刻蚀速率差,严重地缩颈通常都与多晶硅栅重掺杂有关。多晶硅栅的底部存在脚和缺口都不是理想的形状,它们都趋向于非对称的源、漏,因而造成器件的失配。更具体地说,缺口容易引起栅I'r)T)(轻掺杂漏)重叠减少,这将导致更高的源侧R’、电阻和更高的漏侧衬底电流Ⅰ出b。不对称的脚有时源于糟糕的光刻胶线宽粗糙度。尽管如此,至关重要的是制作出可良好控制、对称并可重复的形状。
 热门点击
热门点击

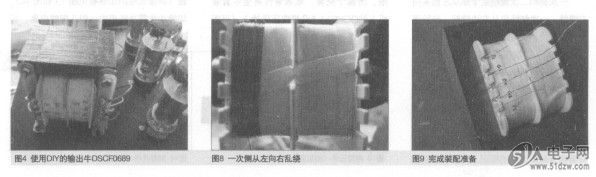
 公网安备44030402000607
公网安备44030402000607





