新结构的积层印制电路板
发布时间:2008/9/4 0:00:00 访问次数:520
近年来随着电子设备的小型轻量化和高性能化,高密度封装的半导体器件等正在飞速地发展成多针化和窄间距化(见图1),为此,要求小型轻量化和高密度细线化的印制电路板与此要相适应,方能满足半导体器件高精度封装技术要求。于是在90年代初期,松下电子部品(株)研制和开发出新型的积层式多层板,并实现 产量化。并与96年实现全层积层构造(全层ivh构造)的树脂多层印制电 板,称之谓alivh(any layer ivhstructurc multi-layer printed wir-ing board),并实现了量产化。此后又于98年开发了csp或mcm等小型封装裸芯片封装用的载体即ailvh-b(alivh for bare-chip mounting)实现产量化。同时,日本维克托公司在94年采用液态树脂绝缘层制作积层用的基板即vil(victor company of japan interconnected layers pwb)并达到量产化开始提供、扩大销售。
积层板的构造是由「芯板+积层」和「全层积层」之区分,前者是以slc(surface laminar circuit)/日本ibm、app10/イビデン、vih/日本的维克托为代表的;芯板是来之常规工艺制造的印制电路板,并在其表面覆盖上绝缘层和布线层的。后者是以b2it(buried bump intercotion technology)/东芝、alivh为代表的,在制造工艺方面有差别,其积层的形成是由绝缘层构成的。所以采用芯板加积层的构造,是由于常规工艺制造高密度的、细线化的多层板无论从印制电路板的设计、制造工艺受到了很大的制约,同时孔金属化也形成了一定的难度。于是在98年实现孔内用「电镀柱充填的类型」。特别在jpca2001年展览展示这种工艺方法,满足世纪封装技术发展的要求。
以下就是叙述alivh和 vih制造概况和alivh+vih研制与开发过程。
一.alivh结构
1.与常规多层板结构的比较
从图2所示常规工艺制造的多层板,为达到层间的电气互连,必须进行数钻孔和贯通孔的孔化与电镀,这种孔势必减少基板的有效面积,为了与器件安装盘的连接,就必须在焊盘和别的位置设置贯通孔,因此极大的浪费了有效的面积。所有这些都成为印制电路板的小型化、设计合理化或者适应高速电路的大课题。如图2、图3所示的alivh构造的所有层间都设有ivh构造,在器件的正下方进行层间连接,无需电镀通孔,无论哪层都可以任意连接。
传统多层板电气连接采用金属化孔构造
2.构成材料
从图3构成材料与技术所示,原来传统生产印制电路板所采用的基板材料为玻璃布/环氧树脂为代表,它基本上满足电子材料、防弹衣和消防服等强性和耐热性要求,而使用芳胺无纺布和含浸有高耐热性环氧树脂的半固化材料取代传统的高密度安装用印制电路板的玻璃布/环氧树脂绝缘材料。因为芳胺无纺布的无纺纤维具有高的性能特征如低热膨胀率、低的介电常数、高耐热性、高刚性和轻量化等,是一种优良的基板绝缘材料。此外,传统的印制电路板的通孔加工多数采用钻头的机械加工技术,而alivh构造则是采用脉冲振荡的co2激光蚀孔进行导通孔加工,无纺布采用的小径化,实现了多数导通孔加工,而导通孔采用导电胶充填技术,取代了孔化和电镀铜,实现层间的电气互连的目的。不采用电镀铜的方法,导体由铜箔构成,导体厚度均一性高对细导线的形成非常有利。见金相图1
表1所示,表示了alivh的基本规格和特性。如四层板的板厚度为045mm、六层板板厚度为0.70mm。导体所使用的铜箔厚度,内层标准铜箔厚度18(最小12)μm,外层铜箔厚度使用35μm。孔径为200(最小150)μm、焊盘直径为400(最小300)μm或更小些,设计的导体标准宽度为100(最小60)μm、导体标准间距为100(最小70μm.从表2所示,它与fr-4(用玻璃布/环氧树脂制造多层板)从电气性能、机械性能等特性的比较,alivh 的介质常数、密度、热膨胀系数小和玻璃转化温度高。从可靠性试验结果分析(见表3)表示了alivh层间电气互连的可靠性,在高湿氛围放置试验和各种类型的热冲击试验中,alivh的可靠性优良,电阻变化率都在 20%范围以内。
3.设计规格特征:
alivh产品的设计规格的主要特征如下:
① 全层ivh构造,导通孔的设置层没有限制。
② 全层均一规格无异种导通孔或者异种格子配线。
③ 导通孔上焊盘,部品安装盘可以与导通孔共用。
④ 导通孔上导通孔与相邻接层导通孔位置没有限制(对于叠加型)。
4.展开
alivh于96年10月应用于携带电话,使其急速地进入超细微化。随着材料研制开发和制造工艺等的改善和整合,正拓展到携带电话以外的领域,开发了作为细线化的半导体裸芯片安装用的载体即alivh-b并已量产化。alivh-b沿用导通孔上导通孔、导通孔上焊盘构造等的母板用的优点,为安装裸芯片的封装和组件用提供载体即积层板。图5所示是部品搭载状态。表4是两种类型构造的积层板布线工艺特性的比较。而制造工艺方面相同的,特别是开发制作细线图形,导体宽度/导
近年来随着电子设备的小型轻量化和高性能化,高密度封装的半导体器件等正在飞速地发展成多针化和窄间距化(见图1),为此,要求小型轻量化和高密度细线化的印制电路板与此要相适应,方能满足半导体器件高精度封装技术要求。于是在90年代初期,松下电子部品(株)研制和开发出新型的积层式多层板,并实现 产量化。并与96年实现全层积层构造(全层ivh构造)的树脂多层印制电 板,称之谓alivh(any layer ivhstructurc multi-layer printed wir-ing board),并实现了量产化。此后又于98年开发了csp或mcm等小型封装裸芯片封装用的载体即ailvh-b(alivh for bare-chip mounting)实现产量化。同时,日本维克托公司在94年采用液态树脂绝缘层制作积层用的基板即vil(victor company of japan interconnected layers pwb)并达到量产化开始提供、扩大销售。
积层板的构造是由「芯板+积层」和「全层积层」之区分,前者是以slc(surface laminar circuit)/日本ibm、app10/イビデン、vih/日本的维克托为代表的;芯板是来之常规工艺制造的印制电路板,并在其表面覆盖上绝缘层和布线层的。后者是以b2it(buried bump intercotion technology)/东芝、alivh为代表的,在制造工艺方面有差别,其积层的形成是由绝缘层构成的。所以采用芯板加积层的构造,是由于常规工艺制造高密度的、细线化的多层板无论从印制电路板的设计、制造工艺受到了很大的制约,同时孔金属化也形成了一定的难度。于是在98年实现孔内用「电镀柱充填的类型」。特别在jpca2001年展览展示这种工艺方法,满足世纪封装技术发展的要求。
以下就是叙述alivh和 vih制造概况和alivh+vih研制与开发过程。
一.alivh结构
1.与常规多层板结构的比较
从图2所示常规工艺制造的多层板,为达到层间的电气互连,必须进行数钻孔和贯通孔的孔化与电镀,这种孔势必减少基板的有效面积,为了与器件安装盘的连接,就必须在焊盘和别的位置设置贯通孔,因此极大的浪费了有效的面积。所有这些都成为印制电路板的小型化、设计合理化或者适应高速电路的大课题。如图2、图3所示的alivh构造的所有层间都设有ivh构造,在器件的正下方进行层间连接,无需电镀通孔,无论哪层都可以任意连接。
传统多层板电气连接采用金属化孔构造
2.构成材料
从图3构成材料与技术所示,原来传统生产印制电路板所采用的基板材料为玻璃布/环氧树脂为代表,它基本上满足电子材料、防弹衣和消防服等强性和耐热性要求,而使用芳胺无纺布和含浸有高耐热性环氧树脂的半固化材料取代传统的高密度安装用印制电路板的玻璃布/环氧树脂绝缘材料。因为芳胺无纺布的无纺纤维具有高的性能特征如低热膨胀率、低的介电常数、高耐热性、高刚性和轻量化等,是一种优良的基板绝缘材料。此外,传统的印制电路板的通孔加工多数采用钻头的机械加工技术,而alivh构造则是采用脉冲振荡的co2激光蚀孔进行导通孔加工,无纺布采用的小径化,实现了多数导通孔加工,而导通孔采用导电胶充填技术,取代了孔化和电镀铜,实现层间的电气互连的目的。不采用电镀铜的方法,导体由铜箔构成,导体厚度均一性高对细导线的形成非常有利。见金相图1
表1所示,表示了alivh的基本规格和特性。如四层板的板厚度为045mm、六层板板厚度为0.70mm。导体所使用的铜箔厚度,内层标准铜箔厚度18(最小12)μm,外层铜箔厚度使用35μm。孔径为200(最小150)μm、焊盘直径为400(最小300)μm或更小些,设计的导体标准宽度为100(最小60)μm、导体标准间距为100(最小70μm.从表2所示,它与fr-4(用玻璃布/环氧树脂制造多层板)从电气性能、机械性能等特性的比较,alivh 的介质常数、密度、热膨胀系数小和玻璃转化温度高。从可靠性试验结果分析(见表3)表示了alivh层间电气互连的可靠性,在高湿氛围放置试验和各种类型的热冲击试验中,alivh的可靠性优良,电阻变化率都在 20%范围以内。
3.设计规格特征:
alivh产品的设计规格的主要特征如下:
① 全层ivh构造,导通孔的设置层没有限制。
② 全层均一规格无异种导通孔或者异种格子配线。
③ 导通孔上焊盘,部品安装盘可以与导通孔共用。
④ 导通孔上导通孔与相邻接层导通孔位置没有限制(对于叠加型)。
4.展开
alivh于96年10月应用于携带电话,使其急速地进入超细微化。随着材料研制开发和制造工艺等的改善和整合,正拓展到携带电话以外的领域,开发了作为细线化的半导体裸芯片安装用的载体即alivh-b并已量产化。alivh-b沿用导通孔上导通孔、导通孔上焊盘构造等的母板用的优点,为安装裸芯片的封装和组件用提供载体即积层板。图5所示是部品搭载状态。表4是两种类型构造的积层板布线工艺特性的比较。而制造工艺方面相同的,特别是开发制作细线图形,导体宽度/导
上一篇:微控制器控制模拟移相器
 热门点击
热门点击
- 断路器的分断能力
- HRW11-10/YH5WS1-17/30型
- 电子光栅尺在自动控制系统中的应用
- 小锥度回转顶尖的设计和应用
- 用ActiveX Automation技术开
- 小型断路器的发展与应用
- 电源通路管理集成电路的优点
- 485集线器的成功应用
- 如何正确操作跌落式熔断器
- 伺服电机原理
 推荐技术资料
推荐技术资料
- 自制经典的1875功放
- 平时我也经常逛一些音响DIY论坛,发现有很多人喜欢LM... [详细]

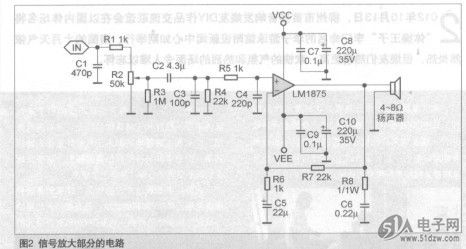
 公网安备44030402000607
公网安备44030402000607





