摘要:介绍了一种新型的常压射频低温冷等离子体放电设备,用该设备进行了清洗光刻胶的工艺实验研究。实验结果表明:在100mm硅片表面涂上9912光刻胶,用等离子体进行清洗的速率可达500nm/min,测量了清洗速率与放电功率、氧气流量和衬底温度之间的变化关系;并对离子注入(b+,5×1015cm-2)后的光刻胶进行了清洗实验,得到清洗速率为300nm/min。清洗后的电镜分析证明,经等离子体清洗后,硅片表面无损伤、无残胶。
关键词:常压;射频;等离子体;光刻胶;清洗 中图分类号:tn405.982;tn305.97 文献标识码:a 文章编号:1003-353x(2004)12-0026-04
1 引言 在微电子工业中光刻胶的清洗是一个十分重要的环节,清洗工序占整个制造工序的30%~35%。传统上都是采用湿化学方法来进行光刻胶的清洗的。它具有不可控制、清洗不彻底、需要反复清洗等缺点,而且会造成环境污染,需要建立专门的回收处理站。随着新材料的使用和微器件特征尺寸的进一步减小,要求有一种更具选择性、更环保、也更能人为控制的清洗技术。自20世纪80年代以来,等离子体干法刻蚀被应用于光刻胶的清洗中[1-3]。这种技术不但可以清洗化学结构更为复杂的光刻胶而且不会产生化学废物,有利于环境保护。
干法清洗主要是利用氧在等离子体中产生的活性氧与光刻胶发生反应生成二氧化碳和水,以达到去除光刻胶的目的。它能对高温烘烤过的胶、显影后的底胶以及铝电极和大剂量离子注入过的胶进行清洗。目前,普遍采用的干法清洗光刻胶工艺都是在真空室里利用低气压氧等离子体来进行清洗。在使用中存在设备及维护费用高、被处理物体的尺度受真空室腔体限制,操作不方便和时间长等缺点。1995年,h. koinuma[4]等人开始在大气压下进行光刻胶清洗的实验研究,清洗速率可达到每分钟几个微米,但是他们所采用的等离子体设备只能对直径为5mm的小面积进行清洗,而且清洗后仍有残胶存在。1997年美国 los alamos[5~9]国家实验室发明了常压射频冷等离子体喷枪设备,并利用该设备产生的更大面积的等离子体对光刻胶进行清洗实验研究。但到目前为止,仍没有看到有关用常压等离子体清洗100mm以上面积的硅片的报道。 中国科学院微电子研究所最近研制出的常压射频电容耦合冷等离子体喷枪设备[10,11],能产生直径为150mm的大面积均匀冷等离子体。利用该设备对100mm硅片进行了干法清洗的工艺实验,当放电输入功率为300w,氩气流量为5l/min,氧气流量为25sccm,衬底温度为118℃时,得到对光刻胶9912 的清洗速率为500nm/min;对离子注入(b+注入,注入剂量为5×1015cm-2)后的光刻胶,当放电功率为350w,氩气流量为5l/min,氧气流量为25sccm,衬底温度为130℃时,得到清洗速率为 300nm/min。 2 设备介绍 如图1所示,常压射频冷等离子体喷枪设备由射频电源、等离子体发生器、进气系统、水冷系统和加热系统等组成。射频电源的频率为 13.56mhz,工作范围为0~600w。等离子体发生器是由射频电极和地电极构成。被引入的气体在电极之间击穿电离后形成冷等离子体并均匀向下喷出,形成直径为150mm的放电区间,如图2所示(放电参数为:氩气流量为5l/min,氧气流量为25sccm,射频输入功率为300w,反射功率为0)。 3 氧原子产生原理 在清洗光刻胶的过程中,清洗速率主要取决于活性氧原子[11~13]。氧原子主要是通过电荷之间的转换和再结合[14]产生的,如方程(1)所示
产生的氧原子运动到硅片表面与光刻胶发生反应。 4 实验及结果分析 用甩胶机在干净的100mm硅片上旋涂,调节转速为3000r/min,然后放入烘箱在100℃下烘10min,光刻胶厚度为1.4 mm。本实验通过测量清洗前后硅片的质量差来计算清洗速率。 图3为清洗速率与功率之间的变化关系。从图中可以看出,输入功率是影响清洗速率的一个重要因素。当输入功率为150w时,清洗速率很小,只有28nm/min,随着输入功率的增加,等
李海江,王守国,赵玲利,叶甜春 | (中国科学院微电子研究所,北京 100010) |
摘要:介绍了一种新型的常压射频低温冷等离子体放电设备,用该设备进行了清洗光刻胶的工艺实验研究。实验结果表明:在100mm硅片表面涂上9912光刻胶,用等离子体进行清洗的速率可达500nm/min,测量了清洗速率与放电功率、氧气流量和衬底温度之间的变化关系;并对离子注入(b+,5×1015cm-2)后的光刻胶进行了清洗实验,得到清洗速率为300nm/min。清洗后的电镜分析证明,经等离子体清洗后,硅片表面无损伤、无残胶。
关键词:常压;射频;等离子体;光刻胶;清洗 中图分类号:tn405.982;tn305.97 文献标识码:a 文章编号:1003-353x(2004)12-0026-04
1 引言 在微电子工业中光刻胶的清洗是一个十分重要的环节,清洗工序占整个制造工序的30%~35%。传统上都是采用湿化学方法来进行光刻胶的清洗的。它具有不可控制、清洗不彻底、需要反复清洗等缺点,而且会造成环境污染,需要建立专门的回收处理站。随着新材料的使用和微器件特征尺寸的进一步减小,要求有一种更具选择性、更环保、也更能人为控制的清洗技术。自20世纪80年代以来,等离子体干法刻蚀被应用于光刻胶的清洗中[1-3]。这种技术不但可以清洗化学结构更为复杂的光刻胶而且不会产生化学废物,有利于环境保护。
干法清洗主要是利用氧在等离子体中产生的活性氧与光刻胶发生反应生成二氧化碳和水,以达到去除光刻胶的目的。它能对高温烘烤过的胶、显影后的底胶以及铝电极和大剂量离子注入过的胶进行清洗。目前,普遍采用的干法清洗光刻胶工艺都是在真空室里利用低气压氧等离子体来进行清洗。在使用中存在设备及维护费用高、被处理物体的尺度受真空室腔体限制,操作不方便和时间长等缺点。1995年,h. koinuma[4]等人开始在大气压下进行光刻胶清洗的实验研究,清洗速率可达到每分钟几个微米,但是他们所采用的等离子体设备只能对直径为5mm的小面积进行清洗,而且清洗后仍有残胶存在。1997年美国 los alamos[5~9]国家实验室发明了常压射频冷等离子体喷枪设备,并利用该设备产生的更大面积的等离子体对光刻胶进行清洗实验研究。但到目前为止,仍没有看到有关用常压等离子体清洗100mm以上面积的硅片的报道。 中国科学院微电子研究所最近研制出的常压射频电容耦合冷等离子体喷枪设备[10,11],能产生直径为150mm的大面积均匀冷等离子体。利用该设备对100mm硅片进行了干法清洗的工艺实验,当放电输入功率为300w,氩气流量为5l/min,氧气流量为25sccm,衬底温度为118℃时,得到对光刻胶9912 的清洗速率为500nm/min;对离子注入(b+注入,注入剂量为5×1015cm-2)后的光刻胶,当放电功率为350w,氩气流量为5l/min,氧气流量为25sccm,衬底温度为130℃时,得到清洗速率为 300nm/min。 2 设备介绍 如图1所示,常压射频冷等离子体喷枪设备由射频电源、等离子体发生器、进气系统、水冷系统和加热系统等组成。射频电源的频率为 13.56mhz,工作范围为0~600w。等离子体发生器是由射频电极和地电极构成。被引入的气体在电极之间击穿电离后形成冷等离子体并均匀向下喷出,形成直径为150mm的放电区间,如图2所示(放电参数为:氩气流量为5l/min,氧气流量为25sccm,射频输入功率为300w,反射功率为0)。 3 氧原子产生原理 在清洗光刻胶的过程中,清洗速率主要取决于活性氧原子[11~13]。氧原子主要是通过电荷之间的转换和再结合[14]产生的,如方程(1)所示
产生的氧原子运动到硅片表面与光刻胶发生反应。 4 实验及结果分析 用甩胶机在干净的100mm硅片上旋涂,调节转速为3000r/min,然后放入烘箱在100℃下烘10min,光刻胶厚度为1.4 mm。本实验通过测量清洗前后硅片的质量差来计算清洗速率。 图3为清洗速率与功率之间的变化关系。从图中可以看出,输入功率是影响清洗速率的一个重要因素。当输入功率为150w时,清洗速率很小,只有28nm/min,随着输入功率的增加,等
 热门点击 热门点击
 推荐技术资料 推荐技术资料
|
| 

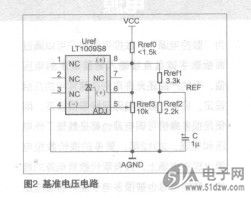
 公网安备44030402000607
公网安备44030402000607





