预清洁工艺
发布时间:2017/10/23 20:55:07 访问次数:710
早先的预清洁是利用Ar物理轰击作用。利用电容耦合器件在基底上加载一个偏压,OPA2330AIDGKT被感应耦合线圈离化的Ar(Ar+)在偏压的作用下加速撞击通孔底部,氧化铜和其他一些残留物会被溅射出来。但是这种方法有一个显著的问题,即从通孔底部溅射出来的铜会沉积到侧壁上,这部分铜和层间电介质材料直接接触,很容易扩散到电介质材料中,造成电路失效[3]。现在比较先进的制程(90nm以下)预清洁系统都是用反应预清洁(reactive predean)。反应预清洁主要是利用等离子体活化的H2与CuO发生反应,同时也可以利用介质气体(如He)轰击晶圆表面,质量较小的He物理轰击作用比Ar弱得多。通过反应预清洁可以避免侧壁的铜污染。
无论是纯物理轰击的预清洁还是反应预清洁都无法避免一些共同的问题。首先等离子环境会造成对器件的损伤(plasma induced damage,PID),另外一个严重的问题是对低介电常数材料的损伤,Ar+的轰击会对电介质造成直接损伤,在反应预清洁中离化的H会带走
低介电材料中的C,这些都会大大增加电介质的介电常数[4],最终导致互连线电容的增加,如图6.22和图6.23所示。随着互连线尺寸的逐渐降低,我们要不断降低连线电容,就必然需要更低霪值更高孔隙率的介电材料,而RPC所造成的损伤就会更严重。针对当前预清洁 系统的这些问题,外置等离子体的预清洁系统被开发出来,这样的系统避免了晶圆和高强度的等离子体的直接接触,降低等离子体对低介电常数和MC)S器件的损伤。
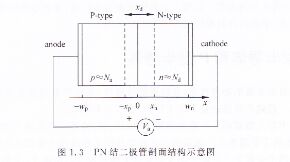
早先的预清洁是利用Ar物理轰击作用。利用电容耦合器件在基底上加载一个偏压,OPA2330AIDGKT被感应耦合线圈离化的Ar(Ar+)在偏压的作用下加速撞击通孔底部,氧化铜和其他一些残留物会被溅射出来。但是这种方法有一个显著的问题,即从通孔底部溅射出来的铜会沉积到侧壁上,这部分铜和层间电介质材料直接接触,很容易扩散到电介质材料中,造成电路失效[3]。现在比较先进的制程(90nm以下)预清洁系统都是用反应预清洁(reactive predean)。反应预清洁主要是利用等离子体活化的H2与CuO发生反应,同时也可以利用介质气体(如He)轰击晶圆表面,质量较小的He物理轰击作用比Ar弱得多。通过反应预清洁可以避免侧壁的铜污染。
无论是纯物理轰击的预清洁还是反应预清洁都无法避免一些共同的问题。首先等离子环境会造成对器件的损伤(plasma induced damage,PID),另外一个严重的问题是对低介电常数材料的损伤,Ar+的轰击会对电介质造成直接损伤,在反应预清洁中离化的H会带走
低介电材料中的C,这些都会大大增加电介质的介电常数[4],最终导致互连线电容的增加,如图6.22和图6.23所示。随着互连线尺寸的逐渐降低,我们要不断降低连线电容,就必然需要更低霪值更高孔隙率的介电材料,而RPC所造成的损伤就会更严重。针对当前预清洁 系统的这些问题,外置等离子体的预清洁系统被开发出来,这样的系统避免了晶圆和高强度的等离子体的直接接触,降低等离子体对低介电常数和MC)S器件的损伤。
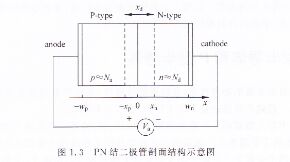
上一篇:由于铜原子的活性较高
上一篇:阻挡层


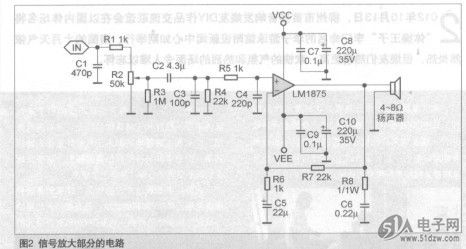
 公网安备44030402000607
公网安备44030402000607





