sMT氮化硅工艺介绍及其发展
发布时间:2017/10/22 11:01:55 访问次数:3079
用等离子增强气相沉积技术制备的氮化硅薄膜,在半导体工业界已经被广泛应用,其沉积工艺也非常成熟。 TC4428AEOA713本节主要着眼于介绍应力记忆技术所采用的高拉应力氮化硅及其性质以及氮化硅性质的演变对应力记忆效应产生的影响。
需要说明的是,由于NH3比N2更易于解离,所以式(53)的反应中,大部分N离子来源于NH3,N2主要起稀释和平衡气压的作用,但也会参与反应。式(54)的反应则不采用NH3,直接用N2提供N离子,反应速度会相应降低。不论是哪种反应制备的氮化硅,其中除了Sl原子和N原子之外,还有含量不等的H原子,主要以S←H,NH的形式存在。H原子的含量及存在方式,对氮化硅薄膜的致密度、折射率、应力大小有极大影响。H离子的来源有两个:⒊H4和NH3,所以即便是式(5趔)的反应也无法制备不含H的氮化硅。人们可以根据器件特性的需要,通过变化工艺参数来调整H原子含量,从而得到理想性能的氮化硅薄膜。反应温度,气体流量,射频电源频率和功率,反应气压等都可以影响氮化硅中H原子含量及其性质。一般来说,(SiH4+NH3)/N2比例越大,高频电源(13.3MHZ)功率越大,反应温度越低,H含量越高,本征应力越低(有时也叫沉积应力)。
用等离子增强气相沉积技术制备的氮化硅薄膜,在半导体工业界已经被广泛应用,其沉积工艺也非常成熟。 TC4428AEOA713本节主要着眼于介绍应力记忆技术所采用的高拉应力氮化硅及其性质以及氮化硅性质的演变对应力记忆效应产生的影响。
需要说明的是,由于NH3比N2更易于解离,所以式(53)的反应中,大部分N离子来源于NH3,N2主要起稀释和平衡气压的作用,但也会参与反应。式(54)的反应则不采用NH3,直接用N2提供N离子,反应速度会相应降低。不论是哪种反应制备的氮化硅,其中除了Sl原子和N原子之外,还有含量不等的H原子,主要以S←H,NH的形式存在。H原子的含量及存在方式,对氮化硅薄膜的致密度、折射率、应力大小有极大影响。H离子的来源有两个:⒊H4和NH3,所以即便是式(5趔)的反应也无法制备不含H的氮化硅。人们可以根据器件特性的需要,通过变化工艺参数来调整H原子含量,从而得到理想性能的氮化硅薄膜。反应温度,气体流量,射频电源频率和功率,反应气压等都可以影响氮化硅中H原子含量及其性质。一般来说,(SiH4+NH3)/N2比例越大,高频电源(13.3MHZ)功率越大,反应温度越低,H含量越高,本征应力越低(有时也叫沉积应力)。


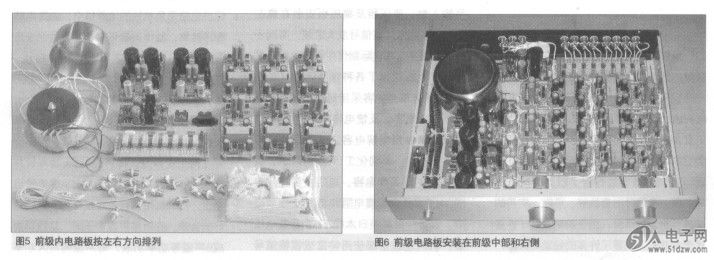
 公网安备44030402000607
公网安备44030402000607





