晶圆级可靠性测试成为器件和工艺开发的关键步骤
发布时间:2007/8/23 0:00:00 访问次数:1091
作者:Dave Rubin和Yuegang Zhao Keithley Instruments Inc.,
摘要 随着器件尺寸的持续减小,以及在器件的制造中不断使用新材料,对晶圆级可靠性测试的要求越来越高。在器件研发过程中这些发展也对可靠性测试和建模也提出了新的要求。为了满足这些挑战需要开发更快、更敏感、更具灵活性的可靠性测试工具。
随着集成电路技术的持续发展,芯片上将集成更多器件,芯片也将采用更快的时钟速度。在这些要求的推进下,器件的几何尺寸将不断缩减,并要求在芯片的制造工艺中并不断采用新材料和新技术。这些改进对于单个器件的寿命来说影响非常大,可能造成局部区域的脆性增加、功率密度提高、器件的复杂性增加以及引入新的失效机制。从前制造器件寿命达100年的工艺在缩减尺寸之后制造的器件可能寿命不到10年――这些对于那些设计寿命为10年左右的产品来说无疑是个不利的消息。同时较小的容错空间意味着寿命问题必须在设计的一开始就给予考虑,并且在器件的开发和制造过程中一直进行监控,这个过程需要持续到最终产品完成。时至今日,器件寿命上一个很小的变化可能带来整个产品的彻底失败。
尽管大部分可靠性测试都是在器件封装级别上完成的,但许多IC制造商现在正在向晶圆级测试(WLT)转移。这种转移一般出于多方面考虑,包括将来把可靠性测试融入到晶圆的制造流程中。同已封装好的失效器件相比,晶圆级可靠性(WLR)测试也节省了大量的时间、产能、金钱以及材料的损耗。其返工时间较短,可以直接从生产线中将失效的晶圆抽出并测试,而不需要先将这部分器件封装之后再测试,封装并测试的流程需要花上两周的时间。由于大部分测试流程相似,保证了可靠性测试向WLT转移的简易性。
在半导体器件中,应力检测是衡量器件运行寿命和损耗失效的常用方法。该测试关注的失效机制位于图1所示典型失效率浴缸曲线的右侧;这就是说,并不关注与器件初用期或制造期相关的失效。
通过应力检测可以方便地做出曲线,并外推来预测器件的运行寿命。由于器件的寿命通常都是用年来度量的,因为需要采用一些手段来加速测试。最有效的方法是让器件处于应力过载状态,然后测量可以衡量性能降低的关键参数,将测得的参数外推得到器件的寿命。在图2中,曲线的右下部分(实测数据)就是在高应力状态下测得的。通过实测数据可以进行线性外推用于预测正常工作条件下器件的寿命(曲线的左上部)。
一般的WLR测试均使用应力测试技术,其中包括热载流子注入(HCI)或沟道热载流子、负偏压温度不稳定性(NBTI)、电迁移、时间相关介电层击穿(TDDB)或电荷击穿(QBD)。这些测试技术在主流CMOS器件的开发和工艺控制中运用得非常普遍(传统HCI和NBTI测试的介绍请参见附文)。
新的尺寸缩减和新材料的使用要求对这些完备的测试方法进行修改,并且升级测试工具以适应新技术。下面给出两个例子,一个是如何克服PMOS器件中与NBTI测试相关的挑战,另一个是在使用高k栅极材料的晶体管中,如何克服与电荷俘获现象相关的挑战。
NBTI测试中的退化缓和
NBTI测试的特别之处在于其性能退化在去掉应力加载之后还可以恢复(图3)。当栅极电压(Vg)引入的应力卸载之后,漏极电流(Id)和阈值电压(Vt)的退化会逐渐恢复并最终返回到起始的情况。恢复的速度对温度的依赖程度很高。在室温下完全恢复的情况也见诸报道。当恢复之后如果再次在栅极引入应力,性能退化将按照上次退化的曲线发展。但在较高温度时,将有一部分退化的性能是无法抵消的,这种情况称为退化锁定。
在并行NBTI测试中,当应力卸载后Id 退化恢复过程的测量是一个极大的挑战。传统的测试方法需要花很长的时间来测试HCI退化,通常并行对器件加载应力,之后将应力源断开,对器件进行顺序测量(图4)。这种方法有两个问题:首先,从断开应力源到开始测量需要一段时间,而在这段时间内一旦应力源消失退化的恢复实际已经开始了;其次,由于顺序测量器件,其测量时间也不同,那么退化恢复的程度也有差异。对于最后一个测量的器件来说,测量时其退化程度可能是第一个被测器件的一小部分。这些缺点要求采用无应力转换的开关、可以完成多器件并行测量的测试方法。另外还要求可以通过几点测试数据估测Vt 的退化情况,而不是像传统方法那样必须使用整条Id-Vg 曲线来测量Vt 退化。
NBTI测试中,退化恢复的另一个常见问题同晶体管工作时是否能达到频繁的开关状态有关。因为只有在晶体管关断的条件下,NBTI退化才能开始恢复。因此,如果使用传统的DC应力和退化手段,如果晶体管一
作者:Dave Rubin和Yuegang Zhao Keithley Instruments Inc.,
摘要 随着器件尺寸的持续减小,以及在器件的制造中不断使用新材料,对晶圆级可靠性测试的要求越来越高。在器件研发过程中这些发展也对可靠性测试和建模也提出了新的要求。为了满足这些挑战需要开发更快、更敏感、更具灵活性的可靠性测试工具。
随着集成电路技术的持续发展,芯片上将集成更多器件,芯片也将采用更快的时钟速度。在这些要求的推进下,器件的几何尺寸将不断缩减,并要求在芯片的制造工艺中并不断采用新材料和新技术。这些改进对于单个器件的寿命来说影响非常大,可能造成局部区域的脆性增加、功率密度提高、器件的复杂性增加以及引入新的失效机制。从前制造器件寿命达100年的工艺在缩减尺寸之后制造的器件可能寿命不到10年――这些对于那些设计寿命为10年左右的产品来说无疑是个不利的消息。同时较小的容错空间意味着寿命问题必须在设计的一开始就给予考虑,并且在器件的开发和制造过程中一直进行监控,这个过程需要持续到最终产品完成。时至今日,器件寿命上一个很小的变化可能带来整个产品的彻底失败。
尽管大部分可靠性测试都是在器件封装级别上完成的,但许多IC制造商现在正在向晶圆级测试(WLT)转移。这种转移一般出于多方面考虑,包括将来把可靠性测试融入到晶圆的制造流程中。同已封装好的失效器件相比,晶圆级可靠性(WLR)测试也节省了大量的时间、产能、金钱以及材料的损耗。其返工时间较短,可以直接从生产线中将失效的晶圆抽出并测试,而不需要先将这部分器件封装之后再测试,封装并测试的流程需要花上两周的时间。由于大部分测试流程相似,保证了可靠性测试向WLT转移的简易性。
在半导体器件中,应力检测是衡量器件运行寿命和损耗失效的常用方法。该测试关注的失效机制位于图1所示典型失效率浴缸曲线的右侧;这就是说,并不关注与器件初用期或制造期相关的失效。
通过应力检测可以方便地做出曲线,并外推来预测器件的运行寿命。由于器件的寿命通常都是用年来度量的,因为需要采用一些手段来加速测试。最有效的方法是让器件处于应力过载状态,然后测量可以衡量性能降低的关键参数,将测得的参数外推得到器件的寿命。在图2中,曲线的右下部分(实测数据)就是在高应力状态下测得的。通过实测数据可以进行线性外推用于预测正常工作条件下器件的寿命(曲线的左上部)。
一般的WLR测试均使用应力测试技术,其中包括热载流子注入(HCI)或沟道热载流子、负偏压温度不稳定性(NBTI)、电迁移、时间相关介电层击穿(TDDB)或电荷击穿(QBD)。这些测试技术在主流CMOS器件的开发和工艺控制中运用得非常普遍(传统HCI和NBTI测试的介绍请参见附文)。
新的尺寸缩减和新材料的使用要求对这些完备的测试方法进行修改,并且升级测试工具以适应新技术。下面给出两个例子,一个是如何克服PMOS器件中与NBTI测试相关的挑战,另一个是在使用高k栅极材料的晶体管中,如何克服与电荷俘获现象相关的挑战。
NBTI测试中的退化缓和
NBTI测试的特别之处在于其性能退化在去掉应力加载之后还可以恢复(图3)。当栅极电压(Vg)引入的应力卸载之后,漏极电流(Id)和阈值电压(Vt)的退化会逐渐恢复并最终返回到起始的情况。恢复的速度对温度的依赖程度很高。在室温下完全恢复的情况也见诸报道。当恢复之后如果再次在栅极引入应力,性能退化将按照上次退化的曲线发展。但在较高温度时,将有一部分退化的性能是无法抵消的,这种情况称为退化锁定。
在并行NBTI测试中,当应力卸载后Id 退化恢复过程的测量是一个极大的挑战。传统的测试方法需要花很长的时间来测试HCI退化,通常并行对器件加载应力,之后将应力源断开,对器件进行顺序测量(图4)。这种方法有两个问题:首先,从断开应力源到开始测量需要一段时间,而在这段时间内一旦应力源消失退化的恢复实际已经开始了;其次,由于顺序测量器件,其测量时间也不同,那么退化恢复的程度也有差异。对于最后一个测量的器件来说,测量时其退化程度可能是第一个被测器件的一小部分。这些缺点要求采用无应力转换的开关、可以完成多器件并行测量的测试方法。另外还要求可以通过几点测试数据估测Vt 的退化情况,而不是像传统方法那样必须使用整条Id-Vg 曲线来测量Vt 退化。
NBTI测试中,退化恢复的另一个常见问题同晶体管工作时是否能达到频繁的开关状态有关。因为只有在晶体管关断的条件下,NBTI退化才能开始恢复。因此,如果使用传统的DC应力和退化手段,如果晶体管一
上一篇:新工艺减少栅泄漏
上一篇:基于JTAG的互连测试技术


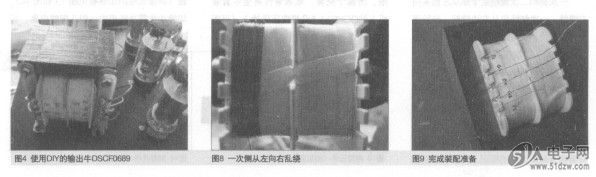
 公网安备44030402000607
公网安备44030402000607





