新型的轻小型化雷达接收机的研制
发布时间:2008/5/28 0:00:00 访问次数:476
摘要:利用多芯片组件和多层基板技术,研制了一种新型轻小型化的雷达接收机。着重分析接口收机中的结构设计、系统设计和避免干扰的措施。介绍了有源混频放大器max2682的功能和应用。测试结果表明,研制的轻小型化接收机可以有效降低雷达的体积和重量,提高稳定性和可靠性。
关键词:新型轻小型化 多芯片组件 多层基板技术 雷达接收机 max2682
随着军事电子技术的飞速发展,对武器装备的多功能与小型化、可靠性要求越来越高。相控阵雷达、多通道接收机、雷达阵列处理技术都迫切需要小型化、可靠性高、一致性好的雷达接收机。
针对结构复杂、体积小、重量重的雷达接收机,本文提出了一种新型的轻小型化雷达接收机,通过采用单片机集成电路、微型封装的表面帖装器件,利用先进的微组装技术和封装工艺组装各种微型化片式元器件和半导体集成电路,重点解决了接收机中的结构设计、系统设计和干扰等技术问题,研制成轻小型化的雷达接收机。
1 多层基板技术
多层基板技术是制作多芯片组件(mcm)的关键技术。基于类型有mcm-l(叠层型多芯片组件)、mcm-c(陶瓷厚膜型多芯片组件)、mcm-d(淀积薄膜型多芯片组件)等。
1.1 陶瓷厚膜型多芯片组件(mcm-c)
mcm-c是在高密度厚膜多层布线或共烧陶瓷多层互连基板上组装多个片式元器件和芯片构成的。其优点是布线层数多,布线密度、封装效率和性能均较高,可以用于高工作频率。mcm-c采用陶瓷多层基板。陶瓷多层基板分为厚膜多层(tfm)基板与共烧陶瓷多层基板两类。
1.2 共烧陶瓷多层基板
共烧陶瓷多层基板可分为高温共烧陶瓷(htcc)多层基板和低温共烧陶瓷(ltcc)多层基板两种。陶瓷多层基板技术的基础是厚膜技术和陶瓷多层技术。陶瓷多层基板包括元器件安装层(顶层)、信号层、电源层、接地层和对外连接层(底层)等几部分,陶瓷介质位于各导体层之间,起电绝缘作用。
顶层含各种焊盘,用以安装相位的电子元器件。为了提高组装密度,可以采用双面安装多层基板,即在基板的顶面和底面都安装电子元器件。多层基板的信号层调协在顶层下方,主要布置元器件之间的互连线,层数视组件规模和布线密度而定。电源层和接地层一般都独立设置,可按组件电性能的要求进行设计。陶瓷基板的以上各层由垂直通孔进行互连。
2 多芯片组件(mcm)
通常,mcu采用多层基板作衬底。基板中可以有信号层、电源层和接地层。互连方式有丝焊、载带自动焊(tab)、倒装焊、倒装tab等。
宽频带mcm的电设计需要选择合适的图形参数,如信号线宽度、信号线厚度、信号线间距、介质厚度和材料性能(如电导率、介电常数)等。这些物理参数一旦确定,利用电磁模型将参数转换成一个等效电路。mcu电模型是由适用于一定频域的电磁转换程序完成,此程序包含maxewell方程在此频域内的全波解。一般情况下,此程序完全可以处理具有非tem波传输的电子封装结构。高频下,由集肤效应在导体中产生的非均匀电流也包括在这个封装模型中。
通常,传输线的性能由以下六个主要参数确定:特性阻抗(zo)、传输延迟(t。)、容性耦合和感性耦合(c12、l12)、交直流电阻(rdc、rac)。其中容性耦合和感性耦合会在系统中一对有终端的耦合传输线中产生耦合噪声。假定整个传输线无损耗,动态传输线上有上升时间tr的干扰电压vin,则有:
nen和fen分别代表静态传输线终端附近和远离终端处的噪声,kb、kr分别为反向和正向耦合系数。l是耦合长度,τ是传输延迟,c11、l11是自身电容和自身电感,c12、l12通过变量kb、kr作用于噪声方程,因为kb、kr正比于耦合噪声,所以变量kb、kr被广泛用于参数优化和设计比较分析中。由于rdc与传
摘要:利用多芯片组件和多层基板技术,研制了一种新型轻小型化的雷达接收机。着重分析接口收机中的结构设计、系统设计和避免干扰的措施。介绍了有源混频放大器max2682的功能和应用。测试结果表明,研制的轻小型化接收机可以有效降低雷达的体积和重量,提高稳定性和可靠性。
关键词:新型轻小型化 多芯片组件 多层基板技术 雷达接收机 max2682
随着军事电子技术的飞速发展,对武器装备的多功能与小型化、可靠性要求越来越高。相控阵雷达、多通道接收机、雷达阵列处理技术都迫切需要小型化、可靠性高、一致性好的雷达接收机。
针对结构复杂、体积小、重量重的雷达接收机,本文提出了一种新型的轻小型化雷达接收机,通过采用单片机集成电路、微型封装的表面帖装器件,利用先进的微组装技术和封装工艺组装各种微型化片式元器件和半导体集成电路,重点解决了接收机中的结构设计、系统设计和干扰等技术问题,研制成轻小型化的雷达接收机。
1 多层基板技术
多层基板技术是制作多芯片组件(mcm)的关键技术。基于类型有mcm-l(叠层型多芯片组件)、mcm-c(陶瓷厚膜型多芯片组件)、mcm-d(淀积薄膜型多芯片组件)等。
1.1 陶瓷厚膜型多芯片组件(mcm-c)
mcm-c是在高密度厚膜多层布线或共烧陶瓷多层互连基板上组装多个片式元器件和芯片构成的。其优点是布线层数多,布线密度、封装效率和性能均较高,可以用于高工作频率。mcm-c采用陶瓷多层基板。陶瓷多层基板分为厚膜多层(tfm)基板与共烧陶瓷多层基板两类。
1.2 共烧陶瓷多层基板
共烧陶瓷多层基板可分为高温共烧陶瓷(htcc)多层基板和低温共烧陶瓷(ltcc)多层基板两种。陶瓷多层基板技术的基础是厚膜技术和陶瓷多层技术。陶瓷多层基板包括元器件安装层(顶层)、信号层、电源层、接地层和对外连接层(底层)等几部分,陶瓷介质位于各导体层之间,起电绝缘作用。
顶层含各种焊盘,用以安装相位的电子元器件。为了提高组装密度,可以采用双面安装多层基板,即在基板的顶面和底面都安装电子元器件。多层基板的信号层调协在顶层下方,主要布置元器件之间的互连线,层数视组件规模和布线密度而定。电源层和接地层一般都独立设置,可按组件电性能的要求进行设计。陶瓷基板的以上各层由垂直通孔进行互连。
2 多芯片组件(mcm)
通常,mcu采用多层基板作衬底。基板中可以有信号层、电源层和接地层。互连方式有丝焊、载带自动焊(tab)、倒装焊、倒装tab等。
宽频带mcm的电设计需要选择合适的图形参数,如信号线宽度、信号线厚度、信号线间距、介质厚度和材料性能(如电导率、介电常数)等。这些物理参数一旦确定,利用电磁模型将参数转换成一个等效电路。mcu电模型是由适用于一定频域的电磁转换程序完成,此程序包含maxewell方程在此频域内的全波解。一般情况下,此程序完全可以处理具有非tem波传输的电子封装结构。高频下,由集肤效应在导体中产生的非均匀电流也包括在这个封装模型中。
通常,传输线的性能由以下六个主要参数确定:特性阻抗(zo)、传输延迟(t。)、容性耦合和感性耦合(c12、l12)、交直流电阻(rdc、rac)。其中容性耦合和感性耦合会在系统中一对有终端的耦合传输线中产生耦合噪声。假定整个传输线无损耗,动态传输线上有上升时间tr的干扰电压vin,则有:
nen和fen分别代表静态传输线终端附近和远离终端处的噪声,kb、kr分别为反向和正向耦合系数。l是耦合长度,τ是传输延迟,c11、l11是自身电容和自身电感,c12、l12通过变量kb、kr作用于噪声方程,因为kb、kr正比于耦合噪声,所以变量kb、kr被广泛用于参数优化和设计比较分析中。由于rdc与传



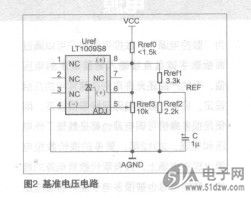
 公网安备44030402000607
公网安备44030402000607





