瞬态液相烧结(TLPS)材料来创建表面贴装多芯片解决方案
发布时间:2021/10/12 13:30:21 访问次数:138
KONNEKT™技术是高密度的封装技术,可以在不使用金属框架的情况下实现组件互连,从而降低电容器的 ESR、ESL和热阻。
这项技术使用创新的瞬态液相烧结(TLPS) 材料来创建表面贴装多芯片解决方案。
C0G KONNEKT电容器也称作采用 KONNEKT 技术的 KC-Link电容器,以基金属电极 (BME)技术制造,无直流偏置和压电效应,电容值也不会随温度变化,误差仅在+-30ppm/°C之间,因此特别适用于需要高效能的应用。

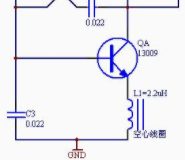
相比此前的硅通孔(TSV)布线相比,这种方式提供了更高的设计自由度,提高了生产效率,有助于缩小尺寸并提高性能。传感器的像素部分与底部逻辑电路部分,使用铜焊盘进行电气连接。
主要特性有:满足TIA/EIA-422-B (RS-422) 和ITU-T V.11建议;TX输出有±15kV ESD保护;热插拔功能;保证有20Mbps数据速率(MAX3030E。
MAX3032E);2Mbps数据速率可控转换速率(MAX3031E,MAX3033E);低功耗(<330uW, VCC = 3.3V 静态);3.3V工作电压;工业标准出脚和热关断。

KONNEKT™技术是高密度的封装技术,可以在不使用金属框架的情况下实现组件互连,从而降低电容器的 ESR、ESL和热阻。
这项技术使用创新的瞬态液相烧结(TLPS) 材料来创建表面贴装多芯片解决方案。
C0G KONNEKT电容器也称作采用 KONNEKT 技术的 KC-Link电容器,以基金属电极 (BME)技术制造,无直流偏置和压电效应,电容值也不会随温度变化,误差仅在+-30ppm/°C之间,因此特别适用于需要高效能的应用。

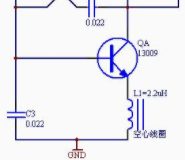
相比此前的硅通孔(TSV)布线相比,这种方式提供了更高的设计自由度,提高了生产效率,有助于缩小尺寸并提高性能。传感器的像素部分与底部逻辑电路部分,使用铜焊盘进行电气连接。
主要特性有:满足TIA/EIA-422-B (RS-422) 和ITU-T V.11建议;TX输出有±15kV ESD保护;热插拔功能;保证有20Mbps数据速率(MAX3030E。
MAX3032E);2Mbps数据速率可控转换速率(MAX3031E,MAX3033E);低功耗(<330uW, VCC = 3.3V 静态);3.3V工作电压;工业标准出脚和热关断。



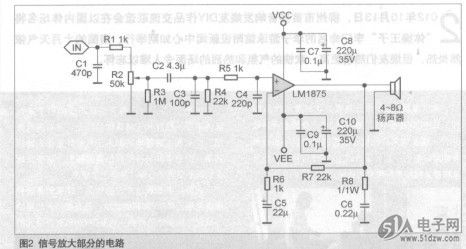
 公网安备44030402000607
公网安备44030402000607





