���ڻ���������ս�Ͳ������أ�����Ħ�����ɶԵ�Ƭ���ɵ�·�ܶȵ������ٶ��Ѿ��Ż���Ȼ�����Ӽܹ��ĽǶ����������ճ�Ʒ����Ķ��������ڲ������������ڲ����µ��칹������Ԫ���Ż�������Ϊ���ĵ�Ӧ�ó����ǣ���ͳ�Ĵ�����-�ڴ�ӿ��ӳ��谭����ЩӦ����������ܲ���������Semiwiki���϶��߶Ը���оƬ��װ��Ʒ�����½�չ�Ѿ��������ţ�Ҳ���ǻ���2.5D���н��ͻ���3D��ͨ�����ˡ�
Ȼ�������ٶ�����˵������������ǣ���Щ��Ʒ�ᱻ��Ѹ�ٵĽ��ܣ��Լ��ͻ�����μ�����������Ƽܹ��Ķ�оƬ���Ͽռ䡣��������л���μ���Ӣ�ض�(INTC.US)�ٰ�ĸ���װ���ֻᣬ�������Ϊ��ҵ��Ը�MCP��Ƶļƻ���������١�
�����ֻ��ϣ������������չ������עĿ�ļ�����Ӣ�ض���װ/���Լ�������(ATTD)���ܲ�Ram Viswanath�ķ��ԣ���˵"���ǿ����˶��ص�3D��2.5D��װ�������������ǿ�����ͻ���������Ʒ�ܹ�ʦ���������������ǰ��δ�еĹ�ģ���ܶ����Ե�MCP��"���dz������ϵķ��ԣ�һЩ��Ա����Ҫ��Ram����ȷ�ϡ���ӹ���ɣ����������İ뵼��IDM���������ͻ�һ��Ѱ��MCP��ƺ�����
���磬����ĸ���ͼ�����˰�CPU��GPU��VR�������ʹ洢���ܹ���װ��һ����ռԭ����Ԫ����װ��������֮һ��С�Ŀռ䣬ԭ��װ�ijߴ��п��ܴܺ�-��ߴ�100mm x100mm��(Ӣ�ض�Xeonϵ�е�Cascade Lake������ģ����һ��76mm x72.5mm��MCP����������"ȫ�̶ȳߴ�"������оƬ��)

���ڱ��صĶ�����˵������ǰ��ʱ��Ӣ�ض������ո��Ĵ�������������ĸо�����ȫ��ͬ�ġ����ﴫ����һ�������ģ�������Ҫ����Ϣ-���˵���������Ӧ�ó������ö�оƬ��װ���ɼ���(Χ��Ӣ�ض�CPU��FPGA)��Ӣ�ض�ATTDҵ���Ż�������֧����Щ���صĿͻ���ơ�
���潫����һЩӢ�ض�MCP����ʷ����2.5D��3D��װ������ϸ�ڣ��Լ�һЩ���ڽ����еĶ�δ����װ�������о�
MCP History
���ֻ�������������Ram V.������Ӣ�ض�MCP�������з��зḻ�ļ��⡣��˵��"Ӣ�ض��ڶ�оƬ��װ����ӵ�д����ľ��顣���磬���������Ƴ�һ���һ����Ƕ��ʽ���ż���������оƬ���װ���ӣ��Ѿ��з���ʮ���ꡣ���ּ���������оƬ����ӿ����ӣ��Ҿ��е�pJ/λ���ģ��Լ�оƬ����ź���ĺ͵ͳɱ������ԡ�"��ͼ���������оƬ��Ե��bump��֮��Ļ�������-һ���ؼ�ָ����(bump���ܶȺ�ƽ��die�ܳ��ڿ����ߵļ��߳���)
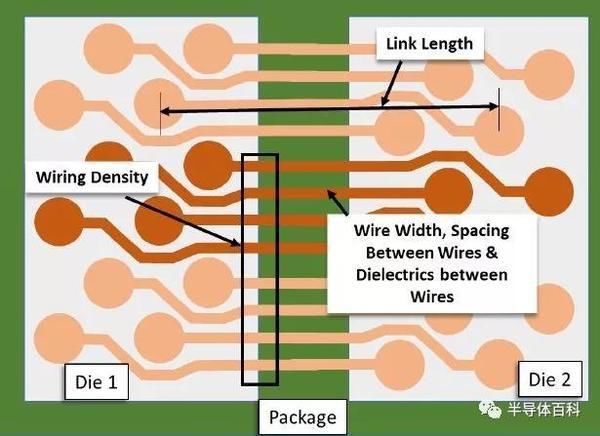
�������������ص��ǽ�����Ƕ����������л���װ��װ�����С��Ž��ߵ�λ�úͽǶ�Ҫ��dz����̡�����Ram����˵����
Ramչʾ�˲���Ƕ��ʽ�Ž����Ĵ���HBM�ڴ��Stratix FPGAģ���ʾ�������˲�Ʒ·��ͼʼ��Ӣ�ض����չ�֮ǰ����Altera FPGAʱ�ļ���SKU������ʱ������FPGAӦ���Ѿ��������-��������Stratix��Ʒ�߶���MCP��Ʒ��������չʾ��(δ��װ��)��������Ĵ����ⲿGPU��Kaby Lake CPUģ���ʾ��������оƬ֮���Ƕ��ʽ�Ž�����
"������Դ�ڲ�ͬ��������оƬ�Ƿ������Եķ�װ��ɿ������⣿"�����ʵ�"������������빩Ӧ�̺��������ijɹ�"��ָ�Ÿ���MCPģ���еIJ�ͬоƬ����˵��"���������̨���磬���������GF����Щ������SKHynix��HBM�ڴ��ջ��������ȫ���Ĺ�Ӧ�̶����к������ƶ���bumpұ����Ͳ��������BEOL���������ԣ�оƬ��Ⱥ������ȣ�������ЩоƬ�Ķ���֤���Ǻϸ�ġ�"
EMIB
Ƕ��ʽ���о������(EMIB)����һС�����MCP�е�������о�����ڱ�Ե֮���ṩ���ɵĻ����ԡ�EMIBĿǰ�������ĸ�������ƽ��--2���źź�2����Դ/��(��Ҫ�������Σ���Ҳ������оƬ֮���P/G����)��

���⣬Ӣ�ض���Si�Ŷӷ����˲�ͬ���ȵ��źźͽӵ����ߵIJ�ͬ�������˵��ź����-��μ���ͼ��

Ӣ�ض��о�ԱRavi Mahajan�ṩ���й�EMIB������������Ϣ����ָ��EMIBƽ��Ľ�����Ƚ��ڹ�ƬRDL��ͷ�װ����֮�䣬ʵ���˻��������������֮���ƽ�⡣������������2um���߿���2um��࣬������1um�߿���1um���Ŭ�������Ƕ�EMIB��Si��������������8mm�ij��������ṩ�㹻����ͼ�������Ӹ����Ͻ���EMIB���Դﵽ~200ƽ�����ס���(���磬����оƬ��Ե֮��ľ���Ϊ25mm������Ϊ8mm)
Ŀǰ���Ž�������ƺ�������Ӣ�ض�ATTD���-����û���ⲿ�����������ATTD��Ƕ��ʽ�Ž���������оƬ��I/O����ƽ��ͼ�Ŀ�����һ��Э��Ŭ��������Ram��ʾ������VDD IO��GND IO�������Ҳ�����˴�������װ��EMIB��Χ��оƬ�ϵ��ܱ�bump���еĵ�ѹ���䡣Ӣ�ض�ATTD���Ը��Ϸ�װ��ƽ������Ⱥͻ�е�����Է���������MPC�����г���ɢ��ˮƽ���ܸܺߣ���������оƬ��EMIB����л�����֮���������ϵ����ͬ�����bump�Ӵ���������е���ܷ���������Ҫ��
�Զ�����ֵ��һ����ǣ���װ��EMIB��Ĵ��ڲ�����Ž�������װ��ԴԪ�����ӵ���������Ĵ�ͳ����(���磬ȥ��ñ)�������ֻ��ϣ��Ա����װ�������������SMTñ��֧�ֵõ���ǿ��-����22nm���սڵ�������Ӣ�ض�CPU��װ�����˵�ѹ���ں͵�ѹ����ơ���װ�ϵĵ�к͵���Ԫ������ѹ�������ʹ�õĽ�ѹת������һ���֡�����Ramָ������Ӣ�ض��������MCP�Ŀͻ�Ҳ���Ի�ô˹���֧�֡�

����EMIB����Ƶ�������ʹ�ù��н���2.5D��װ��Ʒ�кܴ�ͬ��һ���棬���ڽ��ʲ��Խ������������Si���ʲ㸳����оƬ�����Ӹ��������ԡ�(���µ�2.5D��Ʒ�ṩ����ϡ������ع�֮������Ӽ��߹��գ����ṩ����1X�����ֳ��ߴ�Ľ��ʲ���ơ�)�෴�أ�EMIB����רע������оƬ��Ե(����ƽ��)���ӡ������ֻ����ᵽ��������Ž������ɵ���ͳ��װ��������շ�װ������ʹ��100mmx100mm���ʲ�ߴ���500mm��500mm�л���������ϳ�Ϊ���ܡ������л������EMIBʵ���˿ɹ۵ijɱ��Ż�
3D��Foveros��
����Lakefield CPU��Ʒϵ�У�Ӣ�ض��Ƴ��˲��ù�ͨ��3DоƬ�ѵ���װ��Ʒ����ͼ˵����3DоƬ��ջ��

����װ�з����ص��Ǽ���TSV����Ľھ��С-Ŀǰ�Ľھ�Ϊ50um��Ŀ����Ϊ30-35um���⽫��Ҫ����ѹճ��ת��Ϊ���صġ����ճ�ϡ�����-����ͼ��
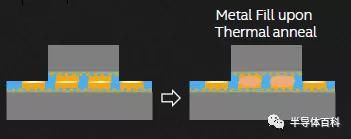
��ѹ�������ѹ�����¶����ں�����ģ���ϵ���¶����ұ�𣬶���Ͻ��ʼ��(��Щ��µ�)��գ�����ģ�߱����ṩ���м�����ȷ���Ƶġ����ݡ��ĺ��̽�������ϲ�������(��ˮ�ģ�����ƽ���)ģ�߱���֮��ķ��»�����Ȼ�����˻������ʹ���������Բ����������ӡ�
��һ���ؼ���3D��װ�з���ע�ص���ѹ��оƬ���-��3D��װ��Ŀ���Ǽ���ѹ����������ĺ�ȡ����ѵ�оƬ�ı����Ӿ���װ��Ϳɿ������⡣����Ravi M.ǿ��˵��������һ����Ȥ���Ӿ����ӣ������ǵ���һ��A4ֽ������оƬ�IJ���������Ҫ��(��ʼ300mm��Բ��ȣ�~775um;A4ֽ�ź�ȣ�~50um)
�ڲ��õĽ����������3DоƬ�����Ϊ����2.5D���˵�һ���ֵ����������ṩ������Intel ATTD��ʾΪ��co-EMIB������ͼ˵����3D�ѵ�оƬ��ѵ�֮��Ƕ��ʽ�Žӵ���ϸ��
Chiplets,KGD��s,and AIB MCP�����ļ��ٲ��ý������ڹ㷺��оƬ�鹩Ӧ���䷽ʽ������SoC�е�ӲIP���ܡ�����������Ӣ�ض�ATTD�Ŷ��Ѿ��������Ҫ��Դ�������������⣬��ȷ������װ/���Բ����Ϳɿ��ԡ�Ȼ����СоƬI/O֮��ĵ������ܽӿڶ�����Ҫ��������ҵ��Χ�ڼ��о������б�������ȷ��оƬ���Ļ������ԡ�
Ӣ�ض��ѷ�����AIB�淶��������DARPA��CHIPS���ƻ��Ļ��������ߣ����ƹ�оƬ������(DARPA���ӣ�AIB����-��Ҫע��)��Щ���˾��ȵ��ǣ�IEEE�ƺ�û�л�������������-�ܿ죬�������ʡ�
�����ֻ��ϣ�Ӣ�ض�ATTD�Ŷӱ�ʾ����һ��оƬ���ӿڹ淶(MDIO)���ڽ����ڲ����Ŀ���ǽ��������ʴ�2Gbps��ߵ�5.4Gbps(�ڽϵ͵ĵ�ѹ�ڷ����Ż�����)��
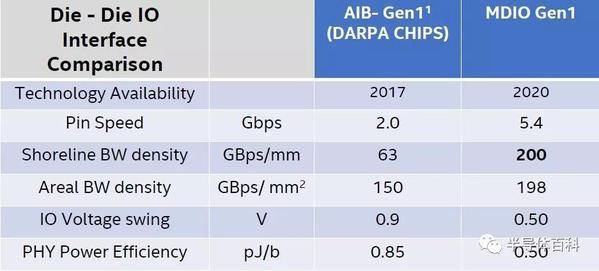
MCP��Ʒ��ƽ��������У������õ�������Ҫһ����ȷ�ı�-������СоƬ��������̫����������DARPA��Andreas Olofsson��������������
����оƬ����ƻ�����һ�����棬�����ֻ��Ͻ����˼�Ҫ���ۡ�MCP�����պ�������Բ��ʽ�ȡ������֪������Ƭ(KGD)СоƬ�IJ��ԺͿɿ���������ATTD�Ŷӱ�ʾ��Ӣ�ض��Ѷ�����ATE�豸���������˳���(�ڲ�)Ͷ�ʡ�ͻ����һ���ض��������ܹ��ھ�Բ��ִ�м����¶�ѭ�����ԣ�����ʶ��/��������ʧЧ�C�Ա������͵���װ��װ��KGD�������ϻ���������������ʧ��СоƬ��IP���Ĺ�Ӧ�̵�ȻҲ��Ҫ�ԵͲ��Գɱ��������ṩ�߿ɿ���оƬ�����⡣
Futures
�������ֻ��ݽ�����Ӣ�ض��о�ԱJohanna Swan����������һЩ���ڽ��еĸ���װ�з���������עĿ�Ļ����ǰѼ������ӱ�ɵ�ͨ�����ӵĹ��ա�������ͼ�����Ĵ��ͨ���̵����߳ߴ���죬����δ��ͨ�ס���ʹ�����ܶ����Ÿ��ơ���ͼ˵���˵�ǰ��װ����-ͨ�����ˣ��Լ�2-4um���߿��ȵ���ZMV�������ӡ�
Ŀǰ���ڻ�����֬�ķ�װ�����ü������-ʵ��ZMV��һ���¼��������о��С�(Johanna��ʾ�������ǰ�ϵ�еĿɹ������Ͽ��ṩ�㹻�ߵ�ͨ���ܶȣ������ϣ����պͳɱ�����Ҫ��ʹ�û�����֬���C�����Ҫ���صĻ�����֬���ա�)���ZMV����ת������������MCP����(����+�ռ�)�����ܶȽ��������-��������ĸĽ�����ʱ���ڴ���MCP��ʵ�ֵ�ϵͳ�����ܽ��Ƿdz�����ӡ����̵ġ�

Summary
���ֻ��������ؼ�Ҫ�㣺
�칹��оƬ(оƬ��/��СоƬ)��װ��Ϊϵͳ�ܹ�ʦ�ṩ��Ļ���������/����/���+���/�ɱ��Ż���
����ù��н���2.5D��װ��ȣ���Ƭ�ӿڴ���Ӣ�ض�EMIB�������ṩ��һ����صijɱ�/�ߴ�/������Ȩ�⡣
Ӣ�ض�ATTD�Ŷ�������ΪѰ�����������г����ز�Ʒ��������Ŀͻ��ṩ�Ƚ���2.5D��3D�ͺϲ�(co-EMIB)����֧�֡�
̹�ʵ�˵�������������ѧʷ�ϣ�����Ӧ���Dz�Ʒ�ܹ�ʦ��������Ȥ��ʱ�ڡ�






 EP3C16U484C8N
EP3C16U484C8N
EP1C6Q240C7N
EP1C6Q240C6N
EP1C6Q240I7N
EP2S90F1020I4N
EP2S90F1020C4N
EP2AGX95EF35I4N
EP2AGX95EF35C6N
EP4CE55F29CI7N
EP4CE55F29C8N
EP4CE55F29CI6N
EP4CE55F23C9N
EP4CE55F29C8LN
EP4CE55F29CI8N
EP4CE55F29C7N
EP4CE55F23C8N
EP4CE55F23C6N
EPM2210F324I3N
EPM2210F256I4N
EPM2210F324I5N
EPM2210F256I5N
EPM2210F324C4N
EPM2210F256C4N
EPM2210F324C3N
EPM2210F256C5N
EPM2210F256A5N
EPM2210F256C3N
EP3C40F780I6N
EP3C40U484A7N
EP3C40F780C8N
EP3C40Q240C8N
EP3C40F484C8N
EP3C40F484C6N
EP3C40F484C7N
EP3C40U484C7N
EP3C40U484C8N
EP3C40F780C7N
EP3C40F324A7N
EP2C5Q208I8N
EP2C5Q208C7N
EP3C120F780C7N
EP3C120F780I7N
EP3C120F484I8N
EP3C120F484I6N
EP3C120F780C8N
EP3C120F484C6N
EP3C120F484C7N
EP3C120F484C8N
EP3C120F780I6N
EP3C120F780I8N
EP3C120F780C6N
EP3C120F484I7N
XC4VSX35-10FFG668C
XC5VLX110-1FFG676I
EPC16UI88N
EP3C55F484I7N
EPM570T144C5N
EP1C6T144C8N
5M240ZT100C5N
EP4CE10E22C8N
EP1C3T144C8N
EP1C3T100C8N
EPM1270T144C5N
EPCS4SI8
EP4CE15F23C8N
EP4CE6F17C8N
EPM7064STC100-10N
EP4CE30F23C8N
EP1C12F324C8
EPCS16SI16N
EPCS16SI8N
EPM3064ATC44-10N
EPM570T100I5N
EPM7128AETC100-10N
EP3C16F484C8N
EPM3128ATC144-10N
EPCS4SI8N
EPM7064LC84-7
EP2C20F484C8
EP4CGX50CF23I7N
EPM7128STC100-15N
EPM7128STI100-10N
EP2C5T144C8N
EP2C70F672I8N
EPM7064STC44-10N
EPM7064SLC44-10N
EP1K50TC144-3N
EPM240T100C5N
EPCS64SI16N
EPM3032ATC44-10N
EPC2LC20N
EPCS1SI8N
EPF6016TC144-3N
EPM3128ATC144-7
EPC1PC8
EPM7256EQC160-12
EPM7256AEQC208-7
EP1SGX40GF1020I6
EP1K30TC144-3N
EPM7032AETC44-10N
��˾���������հ뵼������˾
��˾���ߣ�400-8855-170
��ϵ��ʽ��18926507567 QQ:549400747
��˾��ַ��www.zhjgic.com
��˾��Ӫ�������Ϻʹ洢оƬ�����ž�Ӫ�������ֻ���棬��ӭ����ʱ��ѯ









