��˾�������д������Ƽ�����˾
��ϵ�ˣ�������
��ϵ��ʽ��18923859947QQ:3005367043
��˾��ַ��www.szcblic.com
ר������ԭװ�����ž�Ӫ�������ֻ���棬��ӭ����ʱ��ѯ
��ν��оƬ�ڲ��ĵص�����
��ν���ص�������ָоƬ�ڲ����ء���ƽ����ڵ�·�塰�ء���ƽ�ı仯�����Ե�·�塰�ء�Ϊ�ο���������оƬ�ڲ��ġ��ء���ƽ���ϵ��������������ij�֮Ϊ�ص���ground bounce�����������������һ��״̬���䵽��һ��״̬ʱ���ص�����ᵼ������������˲���ë�̡�
��ô���ص�������β������أ�
��������Ҫ���ף������κη�װ��оƬ�������Ż���ڵ�е��ݵȼ������������ص��������������ϵĵ������ġ�
���ǿ�������ͼ��ֱ�۵Ľ���һ�¡�ͼ�п���Q�IJ�ͬλ�ô���������ġ�0����1������״̬���ٶ����ڵ�·״̬װ��������Q��ͨRL�͵�ƽ�����ص��ݶԵطŵ磬���Ÿ��ص��ݵ�ѹ�½��������۵ĵ������أ��ڽӵػ�·���γ�һ����ĵ�����ӿ�����ŷŵ��������Ȼ��˥������һ�����仯�����ڽӵ����ŵĵ��LG��������оƬ��ĵ�·�塰�ء���оƬ�ڵĵ�֮�䣬���γ�һ���ĵ�ѹ���ͼ��VG�������������ת�������оƬ�ڲ��ο��ص�λƯ�ƾ��ǵص���
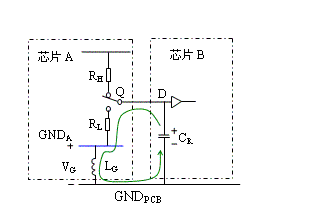
оƬA������仯�������ص������оƬA������������Ӱ��ġ��������������ѹ��оƬ�ڲ��ĵص�ѹ��ֱȽ�ȷ�����룬��˴ӽ������������������źű���������һ����ص�������ͬ��������
���ڣ����ɵ�·�Ĺ�ģԽ��Խ�����ٶȲ�����ߣ��ص�����������Ʋ��þͻ�Ӱ���·�Ĺ��ܣ�����б�Ҫ��������ص��ĸ���о����Ĺ��ɡ�
��оƬ��������˹����ܣ�������û���ѧϰѰ��оƬȱ�ݣ�
оƬ����������ʹ�ñ��������ಢ�Ҳ�ͬ�Ĵ�ͳ�����������Ƚ�оƬ�е�����ȱ�ݣ�������Ҳת��ʹ���Ƚ��Ļ���ѧϰ�ȸ�������������������⡣
�˹����ܣ�AI����һ����֧������ѧϰ�Ѿ��ڼ������������ʹ���˼�ʮ�ꡣʵ���ϣ���20����90������������ڵĻ���ѧϰ��ʽ�ѱ����ھ�Բ���ļ����ͼ�⣬�Բ���оƬ�е�ȱ�ݣ�����ʹ��ģʽƥ�似����Ԥ�����⡣����ѧϰ�������ǹ����豸���ͣ�����ϵͳ������������ȱ�ݵ�һ�������㷨�����ڣ�ҵ������̽����ʼʹ�û��ڸ������ݼ��ģ����Ƚ��Ļ���ѧϰ�㷨��ϵͳ��ͬʱ����Ҳ���ܻ����ѧϰ���ڡ�
�ⲻ��ȡ����ͳ�����������ڶ�������ˡ���ĿǰΪֹ�����Ƚ��Ļ���ѧϰ��ʽ��δ��������Բ���㷺�����Ի�����һЩ��ࡣ������ҵ��Ŭ�������ȱ�ݼ���д��ڵ��Ͼ���ս��
�ڽ���ľ�Բ���У�оƬ������ʹ�ø��ּ���ֶκͼ���ϵͳ������оƬ�е�ȱ�ݡ�����Ƿ���ȱ�ݵĿ�ѧ���������Dz����ṹ�������������ּ��������ڶ�λ�����е����⣬����������ȷ����Բ���IJ�����
���ǣ���ÿ���ڵ㴦���豸�ͽṹ���Խ��ԽС����ijЩ����£��ҵ��ṹԶ����1��������0.1���ף����ֹ�ģ��ȱ��Ҫ���ѵö࣬�ҳɱ��߰�
Ϊ��Ŀ�ĵĹ���ȷʵ���ڣ���������߰���һ���̶ȵĻ���ѧϰ����ĿǰΪֹ�����ڸ��Ƚ��Ļ���ѧϰ��ʽ���������Ѿ����ȶ������ǣ������Ƚ��Ļ���ѧϰ�㷨����������ȱ�ݼ�⣬����ܻ�ı䡣���������Ƿ����㹻���������ݣ��⽫ʹ�����̺Ͱ�װ��˾�ܹ�����ȷ���ҵ�ȱ�ݡ�������ݼ������ʣ�ϵͳ���ܻ�������ɻ�������ȷ�Ľ����
���κ�һ������£�����ѧϰ�е�ȱ�ݼ�⽫�������ڹ����еIJ���Ӧ�ó���Ȼ�������ż����Ľ����������ܻ�����ҵ�еõ����㷺��Ӧ�á�
������ѧϰ��һЩ��������Ĵ𰸡������о���˾Coventor�����Ʒ���ܲ�David Fried˵�����ڸý���������õ�����£������Խ��Խ������⡣�ⲻ���鵤��ҩ���ⲻ�Ƕ�һ�е���ȷ�Ĵ𰸡���
������ˣ�����ҵ���ڲ��ϸĽ��ü�������������������һЩ���³ɹ���
Imec��Nova������һ��ʹ�û���ѧϰ��Ԥ��оƬ�������ܵķ��������⣬GlobalFoundries��Nova���������Ƶļ�����
Imec�����һ���������ѧϰ��CD-SEM��
ASML��SK����ʿʹ�øü�������˹�ѧ�ڽ�У����OPC�����ȡ�
IBM��USC�����һ�������磬���ڸĽ�ȱ�ݼ�⡣
���/������ս
�����300����Բ����ʹ�ø����豸������Բ���Զ����������������̿��Ծ���600��1,000������ಽ���ڲ�ͬ�Σ�оƬ�������ּ����ͼ�鲽�衣
�������루�����ο�������Щ����������Ҫ�����Ե�ȱ�ݻ�Ӱ�쾧Բ���IJ��������߽����ֳ��������պ������ϡ�
��28nm�����ϣ������ͼ��dz������磬��������Ǿ��д�������ƽ�档оƬ�����̿��Բ����ͼ���豸������ס�������16 / 14nm��finFET�ͷdz����ѡ�����оƬ���Ǩ�Ƶ�10nm / 7nm�����ߣ���ṹ��С�����Ѳ��������µ�DRAM��NAND�豸Ҳ����ˡ�
finFET�ʹ洢���������϶���3D�ġ���ˣ��ڼ���ѧ������£����߲���������2D�ṹ�IJ��������һ������Ժ���ķ�ʽ����ά�л�����ǡ�
������Ҫ֪����״��ʲô���ġ�Ȼ������Ҫ�ܹ��������ϳɷ�֮��Ķ�����������֪����������ġ�����ȱ�ݶ������ڸ���֮�£���VLSI Research��ϯִ�й�Dan Hutcheson˵��
ʵ���ϣ�ȱ�ݼ�������ս�ԡ����磬��ν��DZ��ȱ�ݿ��ܻ����豸�г��֡���Щȱ�����豸����ʱ������֣������ǻ����ֳ���ij�ַ�ʽ������տ��ܻ����ϵͳ��Hutcheson˵������ʱ��һ��ȱ��ʵ������һ���ض�λ�õ�����ȱ�ݣ���Ҫ�����ĸ���ͬ�����顣��
ʹ��ս���Ӹ��ӣ�û��һ�ּ����ͼ��߿����ҵ�����ȱ�ݡ����磬��Ҫʮ���ּ���������������Բ���е�finFET��
��������£�оƬ��������Ҫ���и��������ȵĹ��ߣ��Ը��͵ijɱ�ʵ�ָ��ߵ�����������������Ҫ���Dz��ø���������������������Ҫ���ߵĹ��������ʣ���Hutcheson˵��
չ��δ���������ͼ���豸��Ӧ�̽������Ľ����ǵ�ϵͳ��ͬʱ���ڲ���·���У�����/��Ӧ�̼���ʹ�������翪������ѧϰ���������������У�ϵͳ�������ݲ�ʶ��ģʽ����ƥ��ijЩģʽ���˽���Щ���Ժ���Ҫ��
�������ɶ����Ԫ��ͻ����ɡ���Ԫ�����ɾ������ŵĴ洢����Ԫ��ɡ���Ԫ�Ծջ�����ʽ���ӣ������Ϊͻ��������������
������ͨ���������˻��ͺ��������á������������ �C ���룬���غ������

ͼ1��DNN��Ҫ�Ƕ�γ˻��ۼӡ���Դ��Mythic
�ڲ����У�������һ���ֲ�ͬ��ȱ�����͡���ÿ��ȱ�����ͽ��г�������Ϣ���������е�����㡣
Ȼ��ÿ��ȱ�������ƶ�������һ�����ز㣨��1�㣩�еĵ�����Ԫ�в�����Ȩ�ء�����һ�����ز㣨��2�㣩�У�ȱ�ݿ��ܱ�ϸ��Ϊ��ͬ���࣬�����Ե��ͻ���ȡ�����Ҳ������Ȩ�ء�
�ھ�Բ���У�ϵͳ��ȱ�ݡ���ÿһ���У���Ԫ������������Ӧ��ʹ�ü�Ȩ������ϵͳ�������е�һ����Ԫ�ڸвƥ��ģʽʱ��Ӧ��ǿ������ʾ��������С�
����ѧϰ������������罻ý�幫˾�Լ���������ʹ�á������ѧϰ�ܰ�����Ϊ��ʵ���������л�������ȷ��������飬��D2S��ϯִ�й�Aki Fujimura˵�������磬��ҽѧ�����У������������о���Щϸ���ǰ�ϸ����ʹ�����ѧϰ���棬���ǿ��Խ�����С��ȷ����Щ��Ԫ���ǻ��ġ�����һ��ҽѧ�����ӡ������������뵼���������Դ����ĺô�����
IC��ҵ����ʹ�û���ѧϰ���е�·���棬�ȵ���Ͷ�λȱ�ݡ���Ӧ�ó���dz��Ӵ�Imec�Ĺ�̹��պ�ģ�Ϳ����鸺����Philippe Leray˵������������������й�̣�ʴ�̺����в�ͬ�IJ��衣�����Խ������ڻ���ά������
����ѧϰ��һ����սͨ����������Ϊϵͳ�ṩ�㹻�����ݡ�����/���ϵͳ��ѭ��ͬ��ԭ������ҪΪϵͳ�ṩ�㹻�����ݲ���ʹ�������������������һ��������ѵ������ǣ������û���ṩ�㹻�����ݣ�����ܻ�������⡣
���������������������������ܻ������������˵�����������Ѷ�����ѵ��������ݼ���������㹻�������㹻������û��ƫ������ô��Ϳ��Եõ�һ���õĴ𰸡�����һ���ܴ����ս��ֻҪ�ṩһ�ײ���ֻ���ƫ������ѵ����Ϳ��Ժ�������ƭ�Լ�����
������ݲ���֣�����Dz�����Ҫ�ģ����ܵ��¼����Ի�����ԡ������Ա�ʾоƬʵ����û��ȱ�ݡ����Dz���ȷ�IJ��Խ����
������ˣ��ü������ڳ�Ϊ�����ͼ��Ĺؼ����֡�������ѧϰ�����ѧϰ����Ѹ�ٱ����ã��Ľ�����ѵ�Ͳ�������������ԡ����羭����ѵ�����Ը������̱仯�������쳣ֵ�ʹ���ֲ������������̿����ܼ��Ӧ�ò��ϼ�����Ա�ܳ���ԱOfer Adan˵��������ѧϰ����ʹ����ʷ��Ԥ�������Ϣ��������ܡ����ѧϰ��ͼ������ȡ��Ϣ�����Ծ��о�����ƣ���ʱ��Щ��Ϣ�����Զ�����������������������˵��̫�����ˡ����ǣ�û��ħ�����������֪������ģ�ͣ����ǿ��Ի�ñ�DL / ML���õĽ������ˣ�������Ƕ�����ģ�������˽⣬���ǿ���ʹ�������������ѧϰģ�͡�һ�ַ����������ѧϰ�����Ż��ijɱ�������ʹ���������Դ�������Ӧ�ý�����ߡ���
������һ�ַ�ʽ������������������е���/��鹩Ӧ�̶��Ը��ַ�ʽʹ�������ؼ����������Ƿ�Ϊ��Բ���ṩ���κζ��صĺô�����Ҫע�����Ҫ�����ǣ�����ѧϰֻ����һ��֧�ּ�������Ҫ��Ʒ���ɺ����εĶ��Ʋ��ܶԹ������ã���Nanometrics��ƷӪ���ܼ�Kartik Venkataraman˵�������������ǹ�Ӧ��ʹ�û���ѧϰ���������ǵĹ�������ȡ�����Ϣ��������ź�������������Ȼ������Ҫ��ԭ����ѧϰֻ�����������͵�ԭʼ�ź�һ�����á���
����ѧϰ������ʹ�ã����죬����ѧϰ��һЩ����������оƬ������ʹ�á���Щ�������̵ĸ���������ʹ��������ȡ���ڹ�˾��
�ڹ����У�һЩ�����ͼ��ϵͳʹ�û���ѧϰ����������ȱ�ݡ����Ʋ⣬����ѧϰʹ�����Զ�����������������������ʱ��ϵͳ��Ҫ����Ա�ֶ���Ԥ����ȡ�ͼ�����ݡ�
�����������������һ����Ӧ�̵Ĺ��߰���ר����������������������˾��ϵͳ����ͨ�š�ר���DZ�ʾ����Щ�����������������ǵ�ϵͳ���Դ����˵��˵ķ������̣����ü����Դ����з��Ρ�
���գ�оƬ������ϣ��ʹ�����Բ�ͬ��Ӧ�̵Ĺ����ṩ�˵��˵����ܷ��������������Щ�����ڿ������������������ҪͶ�ʺ���Դ��
���⣬ҵ�绹ϣ�����߾��и��Ƚ��Ļ���ѧϰ���ܣ��ر����ھ�Բ��ⷽ�档�����Ź��߱��Խ��Խǿ����ѧϰ�����Խ��Խ��Ҫ����KLA�ļ���֧�ֹ���ʦMark Smith˵��
��Բ����漰������Ҫ�Ĺ����� �C ��������ѧ�����죬��ѧ����Ǿ�Բ�����������ߡ���������������з�������ijЩ���֡������������бȹ�ѧ���õķֱ��ʣ����ٶȽ�����
��һ���������У����ϵͳ��龧Ƭ������������ģ�����ݿ���бȽϡ�Ȼ��ʹ�������磬��ʹ��ģʽʶ��������ȱ�ݲ��Զ������ǽ��з��ࡣ
��20����90������������ּ������ڴ�ͳ��������˾����������ͳ��������������Ҳ���о����Ƚ��Ļ���ѧϰ��ʽ��
��KLA��������ļ�⼼�����ǻ��ڴ�ͳ��ͼ����������������Ҳ�ڽ��л���ѧϰ����KLA��ʷ��˹˵��������ѧϰ������Ӱ��ļ���������ͼ�����������������
ʹ������Щ��������һЩ��ս�������ѧϰ�����Ƚ����㷨�����ڳ�Ϊͷ�����š����������dz�������ݼ���У��ѵ��ģ�ͣ���ʷ��˹˵������Ѱ���µĸ���Ȥȱ�ݣ�DOI��ʱ���Ⲣ�����ǿ��еģ�������Dz��û�Ϸ���������������йؼ�鹤����ι������豸��Ϣ�ĸ�����Ϣ����ô��һЩ����ô�µķ�������Ȼ���ںܶද�������磬����ͨ������Ʋ�����Ϣ�����㷨��һ���֡���
������Ҳ���о�����������磬�������һƪ�����У�ASML��SK����ʿ������һ����߹���ģ��OPC���ȵķ���������ʹ�õ��������ߺ����ѧϰ��ɵġ�
OPCʹ��С��״���ӷֱ��ʸ������ܣ�SRAF����SRAF��������ģ�ϣ���ģ����ģͼ���Ը��ƾ�Ƭ�ϵĿ�ӡˢ�ԡ�
��ÿ���ڵ㣬OPC����ʱ��ͳɱ��������ӡ���ͨ�����Ӵ���CD�ͱ�Ե�������棬���ǽ�ģ���������˴�Լ����֮һ��ͨ����һ����ģ����ʽ�Ӵ�ͳģ��ת��Ϊ���ѧϰģ�ͣ����ǿ��Ի��18����ȷ����������ASML�����ܲ�Yu Cao˵��
Ȼ������һ�������У�IBM���ϼ��ݴ�ѧ��USC������ύ��һƪ���ڻ���ѧϰ�ĵ������������ġ���ͳ�ϣ���Ƭ���ʹ��оƬ��оƬ��оƬ�����ݿ���С����ǣ�ͨ������ѧϰ��IBM��USCͨ��ѵ�����ص�ģ�ʹ���ͼ���ⷴ��������û����ƻ�ƽ�ͼ��İ����½��з��ࡣ����IBM�о���ԱRavi Bonam��˵����ѵ�����ص�ģ�ͽ���Ϊ�������档����������о���Ա�����96.96����ȷ�ʺ�96.87���������ȡ�
���˼�飬����ѧϰҲ���ڼ���ѧ�������ڼ����ͼ������õ��˹㷺��Ӧ�úͿ��ٲ��ã�����CD SEM��OCD������ѧԭλ���������ѧ����������������Applied��Adan˵���������д������ڸ���Ȥ�IJ�����Ϣ��û��ֱ�Ӳ�������Ϣʱ������ʹ����������ѧϰ�������ҵ�����Ȥ�Ķ��������Ӱ���������ĸ��ֲ���֮�������ԡ�����������Ԥ������ܣ���������ʱ����������ܡ���
��������������ս�ԡ����磬ƽ�澧�����Ҫ�嵽���β��������ǣ���finFET�У�����Ҫ12������ͬ��CD����ֵ������դ���߶ȣ�fin�߶ȣ�fin���ȺͲ�ڽǶȡ�
Ϊ�˴���������оƬ��������Ҫ���ּ����������ͣ������ٽ�ߴ�ɨ�����������CD-SEM������ѧCD��OCD���ȡ�
CD-SEM�ǹ����е������������ߣ����������϶��µĽṹ�ߴ������
�������һƪ�����У�Imec������һ�ִ�����ѧϰ��CD-SEM��ʵ���ϣ��ü������Զ�CD-SEM��ȥ�롱���ڸù����У�Imec������������������һ�㣬��Ϊ���ɶԿ����磨GAN����ͨ������ѵ����GAN�������ӵ�SEMͼ���о���Ա�������������ģ��ͼ��
ͬʱ��һ�ֳ�Ϊɢ���ǵ�OCD���Ϳ��Բ���finFET�е�CD��������Ĥ��ȡ�ǿ��֢�ܿ죬��Ҳ��һЩȱ�㡣OCD��һ�ֻ���ģ�͵ļ���������������£���Щ���߲������ʵ���豸���෴�����ǿ��Բ����������ƽ��ṹ�����DZ�ʾ����Ϊ������ʵ���豸��Ӧ�ý���Щ�ṹ��ʵ��װ��֮��IJ���ֵ�������
Ȼ����OCD��ģҲ��Ҫ�ܳ�ʱ�䡣Ȼ������һ�ַ����У�OCD����������һ����ģ�ͼ���������һ�ֻ���ѧϰ��ʽ��������ȡ����ͳ��ǿ��֢���෴������һ������ǿ��֢�IJ��似����
����һ��ʱ�䣬�����Ѿ�����ϸ��OCDģ�������豸�ṹ��Ŀ�꣬�Լ����ǵĹ�ѧϵͳ��������Щ�ط����ǵ�δ��ģ������ڲ��;���ǻ���ѧϰ�����ش�Ӱ��ĵط�������ѧϰ�Ľ��˼������߳��ӵ�ƥ��;��ȡ�ͨ���ʵ��IJο�����������ѧϰ�����Ը��ƽ����ʱ�䣬��KLAģʽ���Ÿ��㷨����Stilian Pandev˵��
������Ƕ����ļ���ϵͳ����OCD�������ռ����ݲ�������������������������ֽ��д��������������
��һ�������У�Imec��Nova��������һƪ����ʹ��OCD���ͻ���ѧϰԤ��оƬ�����ܵ����ġ���OCD���������ϸ����ϲ�������RCWA��������ָ�����������Խṹ�������ּ���Ӧ���ڷ������Խṹ����������ṹ����һ����ս����Imec���з�����ʦSayantan Das˵��
������ѧϰ�㷨���Կ˷���Щ��ս������Ϊһ�ֲ��䷽��������˹˵����������Nova�ĺ���������ʹ��OCD���Ļ���ѧϰ����Ԥ����и�R2ֵ�ĵ������ܡ���ʹ���ܹ���ο�CD���õ���ء���֤�������������ĸ��Dz�ͻ���SEM�ĸ��Dz����������ԡ���OCDģ����ȣ��������˲�����Ԥ����������֮�������ԡ���
ͬʱ������һ�������У�GlobalFoundries��Nova���ʹ�û���ѧϰ��Ԥ��оƬ��ͭ�����ĵ��衣��Щ��˾ʹ�ô�OCD�����͵�������վ���ռ��Ĺ��ס� �����ڸ��ֲ�Ʒ�Ķ��ֽ�������OCD�����ȣ�������ʵ�ʵ��Ӳ���ֵ��Ԥ���������ԡ���FEOL���ţ������Ѿ�չʾ��ʹ�û���ѧϰ�����߲�����Ԥ��Fin CDֵ�ij��������ԣ���GlobalFoundries�ļ�������ʦPadraig Timoney��һƪ������˵������GlobalFoundries��Nova��������Ҳ�������������
��Щ�������ӡ����̣��������з�������ˡ�����Щ������ھ�Բ����˵�Ƿ��㹻�û���٣�
����ǰһ����ȱ�ݼ��Ļ���ѧϰ����������ijЩ����������Ӧ�ó�������ı������Ⲣ����������Ϊ��Щϵͳ�ṩ��������������Coventor��s Fried˵������Щϵͳ���������ܶȺ������������������ԡ���
��Ȼ������ѧϰ����������������ü����Ѵ��ںܳ�ʱ���ˡ����ںܶ�棬��ֻ�DZ����õ�����IJ��֡�









