二氧化硅的干法刻蚀
发布时间:2017/5/28 14:57:08 访问次数:2367
二氧化硅在集成电路工艺中的应用非常广泛,它可以作为隔离MOSFET的场氧化层,可以作为MOSFET的栅氧化层,可以作为金属问的电介质材料,OPA2334AIDGST还可以作为器件的最后保护层。因此,在集成电路I艺中对SK)2的刻蚀是最为频繁的。在ULSI△艺中对二氧化硅的刻蚀通常是在含有氟碳化合物的等离子体中进行的。现在使用比较广泛的反应气体有CHF3、GF6和oF:,其目的都是用来提供碳原子及氟原子与⒊02进行反应。早期刻蚀使用的气体为四氟化碳(CFl)。它有高的刻蚀速率,但对多晶硅的选择比不好。现以CF4为例来说明等离子体产生与刻蚀s02的过程,刻蚀过程反应方程式为F原子与Sl的反应速率相当快,为与SK)2反应速率的10~1000倍。在传统的RIE系统中,CF1大多被分解成CF2,这样可获得不错的⒏02/⒏刻蚀选择比。然而,在一些先进的设备中,如螺旋波等离子体刻蚀机中,因为等离子体的解离程度太高,CF1大多被解离成为F,囚此⒊G/⒏的刻蚀选择比反而不好。
在ULSI工艺中对⒊02的干法刻蚀主要是用于刻蚀接触孔和通孔,这些是很关键的应用,要求在氧化物中刻蚀出具有高深宽比的窗口。对于DRAM应用中的0,18um的图形,深宽比希望能达到6△,对下层的硅和硅化物/多晶硅的选择比要求大约为50△。有一些新的氧化物刻蚀应用,如有新沟槽刻蚀和高深宽比刻蚀要求的双大马士革工艺结构,也有低的深宽比通孔刻蚀,如非关键性的氧化物刻蚀应用。因此,必须认真考虑刻蚀的选择比问题。
为了解决这一问题,在CF1等离子体中通常加人一些附加的气体成分,这些附加的气体成分可以影响s及so2的刻蚀速率、刻蚀的选择比、均匀性和刻蚀后图形边缘的剖面效果。
二氧化硅在集成电路工艺中的应用非常广泛,它可以作为隔离MOSFET的场氧化层,可以作为MOSFET的栅氧化层,可以作为金属问的电介质材料,OPA2334AIDGST还可以作为器件的最后保护层。因此,在集成电路I艺中对SK)2的刻蚀是最为频繁的。在ULSI△艺中对二氧化硅的刻蚀通常是在含有氟碳化合物的等离子体中进行的。现在使用比较广泛的反应气体有CHF3、GF6和oF:,其目的都是用来提供碳原子及氟原子与⒊02进行反应。早期刻蚀使用的气体为四氟化碳(CFl)。它有高的刻蚀速率,但对多晶硅的选择比不好。现以CF4为例来说明等离子体产生与刻蚀s02的过程,刻蚀过程反应方程式为F原子与Sl的反应速率相当快,为与SK)2反应速率的10~1000倍。在传统的RIE系统中,CF1大多被分解成CF2,这样可获得不错的⒏02/⒏刻蚀选择比。然而,在一些先进的设备中,如螺旋波等离子体刻蚀机中,因为等离子体的解离程度太高,CF1大多被解离成为F,囚此⒊G/⒏的刻蚀选择比反而不好。
在ULSI工艺中对⒊02的干法刻蚀主要是用于刻蚀接触孔和通孔,这些是很关键的应用,要求在氧化物中刻蚀出具有高深宽比的窗口。对于DRAM应用中的0,18um的图形,深宽比希望能达到6△,对下层的硅和硅化物/多晶硅的选择比要求大约为50△。有一些新的氧化物刻蚀应用,如有新沟槽刻蚀和高深宽比刻蚀要求的双大马士革工艺结构,也有低的深宽比通孔刻蚀,如非关键性的氧化物刻蚀应用。因此,必须认真考虑刻蚀的选择比问题。
为了解决这一问题,在CF1等离子体中通常加人一些附加的气体成分,这些附加的气体成分可以影响s及so2的刻蚀速率、刻蚀的选择比、均匀性和刻蚀后图形边缘的剖面效果。
 热门点击
热门点击
- 氮化硅薄膜性质与用途
- 直拉法生长单晶硅的主要工艺流程
- 氧化增强扩散
- 边界层厚度主要受气体压力和气流状态(或流速)
- 影响氧化速率的各种因素
- 衬底晶向对氧化速率的影响
- 外延工艺种类
- 二氧化硅的干法刻蚀
- 离子注入机
- PⅤD概述
 推荐技术资料
推荐技术资料
- 自制经典的1875功放
- 平时我也经常逛一些音响DIY论坛,发现有很多人喜欢LM... [详细]

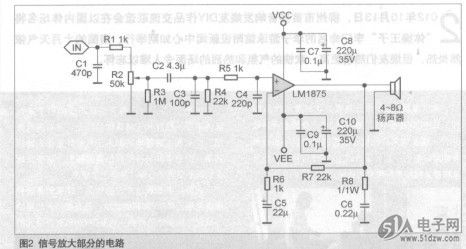
 公网安备44030402000607
公网安备44030402000607





