CBGA英文名:Ceramic-BGA (陶瓷BGA) 采用多层陶瓷的基板,裸片经过倒装技术(FC)*连接到基板引脚后用封盖加玻璃封接。如下图:

TBGA英文名:Tape-BGA (载带BGA) 采用多层载带基板,裸片经过引线键合或倒装技术连接到基板引脚后采用金属盖板封接。如下图:
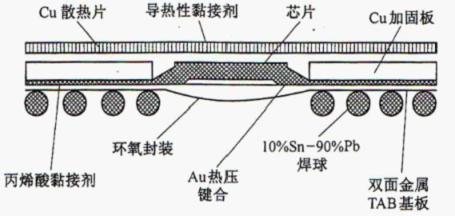
FCBGA英文名:Flip-Chip BGA (倒装芯片BGA) 基板为单层或陶瓷基板,裸片经过倒装技术连接到基板引脚。如下图:
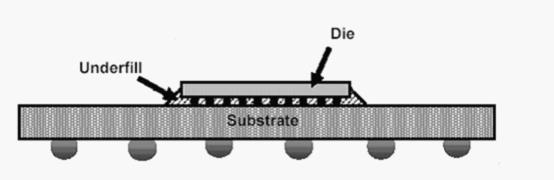
*引线键合(WB)和倒装芯片(FC)技术是在封装过程中芯片互连的常见方法,也就是将芯片焊区与电子封装外壳的I/O引线或基板上的金属焊区相连接。芯片互连常见方法有:引线键合,倒装芯片,载带自动化。
引线键合英文名:Wire Bonding简称WB
该工艺在1957年美国Bell实验室采用,使用细金属线,利用热、压力、超声波能量为使金属引线与基板焊盘紧密焊合,实现芯片与基板间的电气互连和芯片间的信息互通。如下图:
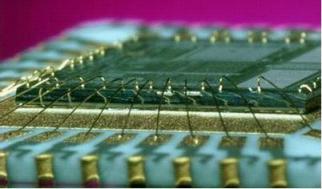
倒装芯片英文名:Flip Chip简称FC
该工艺在20世纪60年代初,由美国IBM公司研制出来,把有接触点或焊球的一面叫做正面,普通芯片封装是把裸片有焊盘或球一面向上贴在电路板上后,打金线引到电路板焊盘上面,而倒装工艺就是把有锡球的一面贴在电路板上。如下图:
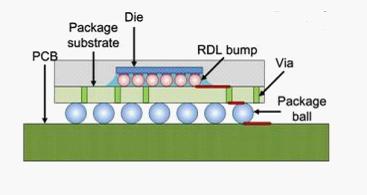
载带自动焊英文名:Tape Automated Bonding简称TAB
该工艺在1965年由美国通用电气(GE)公司研发,是将芯片组装在金属化柔性高分子聚合物载带上的封装技术,将芯片焊区与电子封装体外壳的I/O或基板上的布线焊区用有引线图形金属箔丝连接。如下图: